有源像素传感器(Active Pixel Sensor, APS)是将光能转换为电能的一种传感器件,其与电荷耦合器件(Charge Coupled Device, CCD)相比,具有集成度高、功耗低、结构简单、使用方便等优点,使得其在未来遥感卫星、侦察卫星以及高分辨率对地观测卫星的成像系统具有广泛的应用前景。但是,由于其集成度高、特征尺寸小且工作电压小,使得其对单粒子效应非常敏感。随着后续卫星寿命的延长,急需对APS光电器件的单粒子效应进行准确评价,以满足APS光电器件的工程应用需求。本文以新型CMOS APS (Complementary Metal Oxide Semiconductor Active Pixel Sensor)光电器件为研究对象,结合CMOS APS光电器件的结构特点,分析了重离子对其的辐射影响,分析了CMOS APS光电器件的单粒子效应敏感性,并利用重离子加速器进行了试验验证。
1 APS光电器件的辐射损伤分析CMOS APS是非常敏感的光电器件,具有对空间各种不同辐射粒子敏感的固有特性。晶体管和光电二极管是CMOS APS像素点的基本组成结构,图 1为APS像素点的典型结构,主要包含复位晶体管、源信号跟随晶体管、行选择晶体管和光电二极管。
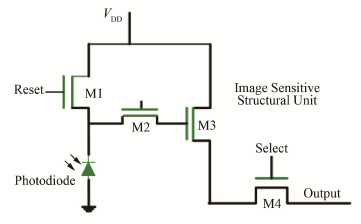
|
图 1 CMOS APS像素点的典型结构 Figure 1 Typical structure of CMOS APS pixel |
CMOS APS像素时序图如图 2所示。光电二极管处于反向偏置,形成的寄生电容对复位晶体管和源信号晶体管进行钳位[1-2]。在复位晶体管外接电压的作用下,反向偏置的光电二极管被充电,电荷的不断累积增大了耗尽层的内建电势,引起耗尽层厚度扩大,容性很低。光电二极管的寄生电容充电结束后,复位晶体管截止。光子穿过光电二极管时,二极管顶层将吸收一些特定波长的光子,而其余的光子都将到达耗尽层。当光子撞击反向偏置的光电二极管的耗尽层时,在耗尽层产生电子-空穴对,电子-空穴对不断被耗尽层的内电场捕获而形成光电流,这个光电流会引起光电二极管放电,由此可知,光电二极管放电量的大小正比于入射光子的密度。光电二极管的输出电流脉冲被行选择晶体管捕获,形成像素点的图像[3]。
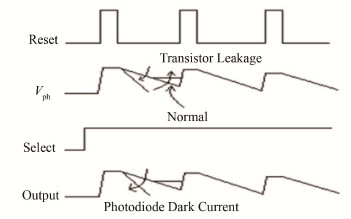
|
图 2 CMOS APS的像素时序图 Figure 2 Timing sequence diagram of CMOS APS pixel |
当空间环境的重离子辐照CMOS APS光电器件时,将影响光电器件的电学特性,如图 3所示。对晶体管来说,重离子能在氧化层和硅底上引起电离,氧化层内的电离引起空穴-电子对增多,导致漏电流增大;硅底的电离能产生更多电子空穴对,电子-空穴对会被敏感节点捕获而引起节点逻辑状态的改变。另外,硅底的位移损伤也会影响光电器件的漏电流和运行速度。对于光电二极管,硅层内电离产生更多的电子空穴对能导致漏电流急剧增大[4-5]。

|
图 3 重离子辐照晶体管和光电二极管(a)晶体管,(b)光电二极管 Figure 3 Heavy ion irradiation on transistor and photodiode (a) Transistor, (b) Photodiode |
空间重离子对CMOS APS光电器件的影响主要表现在暗电流与随机噪声增加、像感器光强响应能力下降、输出不均匀度增大以及器件动态范围下降等[6]。
2.1 重离子辐射增加光电二极管的暗电流空间重离子入射到光电二极管的内部材料时,所形成的陷阱电荷和界面态会使Si/SiO2界面层电势发生变化,降低其阈值电压从而更多的电子进入光电二极管的势肼,导致其暗电流增加。宏观上可观测到CMOS APS光电器件的暗电流及随机噪声随着入射粒子注量的累积而不断增加。
2.2 重离子辐射对光电二极管光强响应的影响在重离子辐照的过程中,空间辐射会产生大量陷阱电荷及界面态,而界面态的大量存在则起到复合机俘获中心作用,使器件表面的电导率降低继而导致方向漏电流上升及电流增益弱化。随着辐射粒子的不断累积,CMOS APS光电器件对入射到其像敏单元上的光的探测灵敏度降低,使光电二极管的光强响应范围减小[7]。
2.3 重离子辐射影响APS光电器件输出不均匀度由于空间重离子辐射所造成的效应可以引起半导体材料产生大量的陷阱电荷及界面态,离子注量的均匀性差异可能在器件材料内产生浓度差异的陷阱电荷及界面态,同时离子注入使得电荷沉积的浓度也存在差异。从CMOS APS光电器件宏观效果可以看出APS光电器件出现局部不均匀“闪烁点”。
2.4 重离子辐射对APS光电器件的电路电子系统的影响空间高能重离子入射到CMOS APS光电器件内部电路时,会影响其正常工作。重离子入射器件内部电路的晶体管时,因能量沉积、电荷收集等过程,造成其发生单粒子瞬态、单粒子翻转等效应,从CMOS APS光电器件宏观表象可以看出,其内部寄存器的逻辑状态发生改变[8]。
综上分析,空间重离子辐射环境对CMOS APS光电器件的辐射影响物理过程如图 4所示。

|
图 4 CMOS APS光电器件的辐射影响物理过程 Figure 4 CMOS APS optoelectronic devices radiation effects physical processes |
该物理过程主要从辐射影响CMOS APS光电器件内部核心元器件的角度出发,对于应用于高分卫星的光电器件,由于辐射会在器件材料内部形成界面态及陷阱电荷。对于光电二极管辐射,会导致其产生瞬时光电流、使其暗电流增大、光强响应能力弱化。对于晶体管辐射,会导致其阈值电压漂移、漏电流增加等物理过程[9-10]。基于重离子辐射对APS光电器件内部核心元器件产生的损伤,CMOS APS光电器件宏观物理性能的改变主要包括暗电流的增加、光强探测效率降低、光强响应范围减小以及输出不均匀性增加产生“白点”等[11]。
3 试验过程 3.1 试验器件特性针对对地观测卫星、侦察卫星用的高分辨率成像APS光电器件的单粒子效应问题,选用典型的高分辨率、低功耗、体积小的Micro MT9T001C12STC CMOS APS光电器件,该器件具有2048×1536个像素点、10 bit分辨率,主要由APS阵列、模拟信号处理、控制寄存器以及模数转换(Analog-to-Digital Converter, ADC)模块组成,如图 5所示。
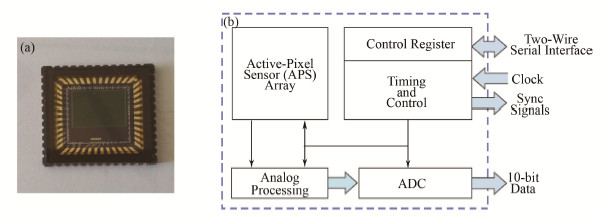
|
图 5 MT9T001C12STC CMOS APS光电器件开盖形貌图(a)和内部结构框图(b) Figure 5 MT9T001C12STC CMOS APS optoelectronic device open cover topography (a) and internal structure (b) |
图 5中,APS阵列实现图像感知,将光信号转换成电信号;而模拟信号处理、控制寄存器以及ADC构成的外围电路,主要实现对光电器件的控制和模数信号的处理。
3.2 测试方法从以上辐射影响分析可知,CMOS APS光电器件发生的单粒子效应主要有单粒子瞬态(Single Event Transient, SET)、单粒子翻转(Single Event Upset, SEU)、单粒子锁定(Single Event Latch, SEL),对于单粒子瞬态,其主要发生在像素阵列,当单个重离子入射到像素单元的硅结构时,产生多余电荷被光电敏感元素收集,从而引起像素点瞬态的电荷脉冲。由于CMOS APS光电器件内部集成了ADC等数字电路,像素阵列的单粒子瞬态经ADC处理后也表现为数据端口的逻辑状态变化,因此,将像素阵列发生的单粒子瞬态效应也定义为APS光电器件发生了单粒子翻转现象。
由此可看出,对于APS光电器件的单粒子效应测试,主要测试两个方面:1)单粒子锁定;2)单粒子翻转。具体实现方法如下:
1) 单粒子锁定
单粒子锁定通过监测器件的工作电流ICC实现。工作电流ICC是模拟量,可以直接从APS光电器件的电源引脚VCC直接引出,从而实现单粒子锁定测试。
2) 单粒子翻转
当APS光电器件遭受重离子辐照时,像素阵列的瞬态变化经内部电路传输后,表现为数据输出端口逻辑状态的改变,同时伴随着APS光电器件图像的白点现象。APS光电器件内部数字电路部分的翻转也变现为寄存器以及数据输出端口的逻辑状态变化。因此,单粒子翻转通过监测器件数据寄存器及输出端口(D0~D9)的逻辑状态和图像白点实现,而数据输出端口的逻辑状态变化通过读取图像帧数据实现。
4 试验及结果分析CMOS APS光电器件重离子单粒子效应试验采用重离子加速器进行。试验在真空环境下进行,真空度优于10-4 Pa。试验选取重离子如表 1所示。
| 表 1 试验选用重离子 Table 1 Heavy ions used in the test |
在重离子单粒子效应试验中,首先对器件进行处理,之后安装在试验移动平台上,通过测试系统进行性能检测,保证器件工作正常,成像清晰。图 6为试验移动平台上安装的待测试样器件。

|
图 6 试验移动平台上安装的待测试样器件 Figure 6 Test the device to be tested installed on the mobile platform |
辐射试验前,首先测试CMOS光电器件的本底暗输出特征参数,以确定所选器件的性能状况,同时为后续试验进行数据对比做准备。
将连接好的光电器件放置在试验真空罐中,获得的暗输出图像,通过读取APS光电器件输出缓存中的数值,再通过Origin程序进行图像处理得到试验本底噪声的三维输出,如图 7所示。通过多次试验求平均值,本底试验统计结果显示所用的APS光电器件具有较好的成像性能。图 7中XY方向代表光电器件像素阵列,Z方向代表像素点沉积的电荷经ADC转换后的数字值,其最小值为0,最大值为15,所有暗输出的平均值为2。
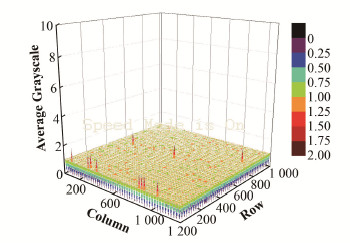
|
图 7 本底试验暗噪声三维输出 Figure 7 Three-dimensional output chart of background test dark noise |
图 7中是本底试验过程中连续2 h内不同时间段内测试的图像输出。可以看出,图像输出波动很小,相对较强图像输出值出现的位置基本不变,分析可知,这是由于所选器件在生产过程中固有的“坏点”所致。
重离子入射到APS光电器件的光敏感区时,电离辐射在器件的材料中产生电子-空穴对,光生电子作为信号电荷传输到输出电路。重离子辐照还会产生陷阱电荷及截面态,一方面辐照会导致电子与空穴结合而消失,另一方面离子会被陷阱电荷及界面态捕获。在反向偏置下,从陷阱电荷及界面态释放出的电子成为自由电子向光电二极管的势阱运动而输出,辐射导致电子-空穴对的浓度随着辐射粒子注量而增大。
Si离子辐照前后APS光电器件图像像素点的三维输出如图 8所示。

|
图 8 Si离子辐照时图像数据三维输出图(a)辐照10 min,(b)辐照15 min Figure 8 Three-dimensional image output during Si ion irradiation (a) Irradiation for 10 min, (b) Irradiation for 15 min |
试验中,当LET低于9.01 MeV·cm2·mg-1时,通过检测寄存器的值发现像素阵列没有出现扰动现象,仅是电荷在像素阵列的不断累积。
随着LET值增大,APS光电器件像素点积累的电荷越来越多,图像逐渐出现零星的“白点”。通过比对试验前后的图像,通过寄存器读取图像阵列的数据矩阵并进行比对分析,得到不同LET值离子辐照时,图像白点数据经ADC转换后逻辑状态变化,如表 2所示。表 2中,总像素数为3145728。
| 表 2 像素阵列逻辑值变化数据 Table 2 Pixel array logic value change data |
实验所用束流的稳定度约为98%、均匀性约为95%,测试所用重离子LET值的误差约为7%,在测试过程中,因测试电路板数据读取速率较低,像素逻辑状态出现0→1→0的二次变化时,系统无法监测,存在约1%的试验误差,可以忽略不计。
5 结语重离子撞击CMOS APS光电器件的光敏像素阵列时,沉积的能量导致势阱中累积大量辐射诱发的电荷,会掩盖信号电荷,使图像质量退化,甚至导致像素阵列出现“白点”。试验发现,当LET低于9.01 MeV·cm2·mg-1时,通过检测寄存器的值发现像素阵列没有出现扰动现象,仅是电荷在像素阵列的不断累积。同时通过试验观察到,当LET值大于42.0 MeV·cm2·mg-1时,逻辑状态变化个数与总像素数比值基本没有变化,在同一个数量级,由此认为SEU饱和截面对应的LET值约为42.0MeV·cm2·mg-1。
| [1] |
Buchner S, McMorrow D. Single-event transients in bipolar linear integrated circuits[J]. IEEE Transactions on Nuclear Science, 2006, 53: 3079-3102. DOI:10.1109/TNS.2006.882497 |
| [2] |
Buchner S, McMorrow D, Poivey C, et al. Comparison of single event transients induced in an operational amplifier (LM124) by pulsed laser light and a broad beam of heavy ions[J]. IEEE Transactions on Nuclear Science, 2004, 51: 2776-2781. DOI:10.1109/TNS.2004.835111 |
| [3] |
孟祥提, 康爱国, 黄强. γ射线辐照对数字型彩色CMOS图像传感器输出特性的影响[J]. 原子能科学技术, 2004, 38(增1): 231-215. MENG Xiangti, KANG Aiguo, HUANG Qiang. Effect of gamma'ray irradiation on output characteristic of color CMOS digital image sensors[J]. Atomic Energy Science and Technology, 2004, 38(Z1): 231-215. DOI:10.3969/j.issn.1000-6931.2004.z1.054 |
| [4] |
周彦平, 王晓明, 常国龙, 等. CMOS图像传感器的辐射实验[J]. 红外与激光工程, 2011, 40(7): 1270-1273. ZHOU Yanping, WANG Xiaoming, CHANG Guolong, et al. Radiation experiment of CMOS image sensor[J]. Infrared and Laser Engineering, 2011, 40(7): 1270-1273. DOI:10.3969/j.issn.1007-2276.2011.07.016 |
| [5] |
El-Sayed E, Chan T Y, Fossum E R, et al. Design and characterization of ionizing radiation-tolerant CMOS APS image sensors up to 30 Mrd(Si) total dose[J]. IEEE Transactions on Nuclear Science, 2001, 48: 1796-1806. DOI:10.1109/23.983133 |
| [6] |
Yang Z L, Wang X H, Su H, et al. Experimental study on heavy ion single-event effects in flash-based FPGAs[J]. Nuclear Science and Techniques, 2016, 27(1): 7. DOI:10.1007/s41365-016-0015-8 |
| [7] |
曹洲, 把得东, 薛玉雄, 等. 图像传感器单粒子效应脉冲激光实验研究[J]. 真空与低温, 2014, 20(3): 132-135. CAO Zhou, BA Dedong, XUE Yuxiong, et al. Experimental research on single event effects of CMOS APS image sensor[J]. Vacuum and Cryogenics, 2014, 20(3): 132-135. DOI:10.3969/j.issn.1006-7086.2014.03.002 |
| [8] |
安恒, 杨生胜, 苗育君, 等. CMOS APS光电器件单粒子效应电荷收集特性仿真分析[J]. 核技术, 2017, 40(7): 070502. AN Heng, YANG Shengsheng, MIAO Yujun, et al. Simulation of characteristic of charge collecting for CMOS APS with single event effects[J]. Nuclear Techniques, 2017, 40(7): 070502. DOI:10.11889/j.0253-3219.2017.hjs.40.070502 |
| [9] |
Goiffon V, Estribeau M, Marcelot O, et al. Radiation effects in pinned photodiode CMOS image sensors:pixel performance degradation due to total ionizing dose[J]. IEEE Transactions on Nuclear Science, 2012, 59(6): 2878-2887. DOI:10.1109/TNS.2012.2222927 |
| [10] |
Dodd P E, Shaneyfelt M R, Schwank J R, et al. Current and future challenges in radiation effects on CMOS electronics[J]. IEEE Transactions on Nuclear Science, 2010, 57(4): 1747-1763. DOI:10.1109/TNS.2010.2042613 |
| [11] |
Hopkinson G, Mohammadzadeh A, Harboe-Sorensen R. Radiation effects on a radiation-tolerant CMOS active pixel sensor[J]. IEEE Transactions on Nuclear Science, 2004, 51(5): 2753-2762. DOI:10.1109/TNS.2004.835108 |


