质子诱发X射线荧光分析(Proton Induced X-ray Emission, PIXE)[1]和卢瑟福背散射分析(Rutherford Backscattering Spectrometry, RBS)[2]都是广泛使用的离子束分析技术。PIXE是一种灵敏度高(10-6量级)、多元素同时定量分析的无损检测技术,应用于生物医学、环境保护、考古学等领域[3]。RBS具有方法简便、可靠,不需要标准样品就能得到定量的分析结果,不必用剥层办法破坏样品宏观结构就能获得深度分布信息等优点,在表面物理、材料科学等领域有着广泛应用[4]。但是,PIXE由于Si(Li)或Si-PIN探测器铍窗的吸收作用,低能特征X射线无法被探测到,所以PIXE方法的元素检测范围通常为Z≥11或12,并且PIXE的分析结果缺乏元素深度分布的信息,而RBS可以对PIXE探测不到的轻元素进行分析并提供元素深度分布信息。另一方面,RBS对重元素的质量分辨本领比较差,PIXE则能提供这些重元素的准确含量信息。所以,当PIXE与RBS两种技术结合使用的时候,可以优势互补,基本可以实现对样品的(近)全元素分析。
四川大学原子核科学技术研究所依托2.5 MeV范德格拉夫静电加速器,搭建了一套PIXE与RBS相结合的离子束分析系统。经过不断改进[5-7],目前该系统已经趋于稳定和完善。本文将介绍该系统的实验装置及其刻度过程。
1 实验装置和方法我们的PIXE-RBS离子束分析系统的真空靶室如图 1所示。
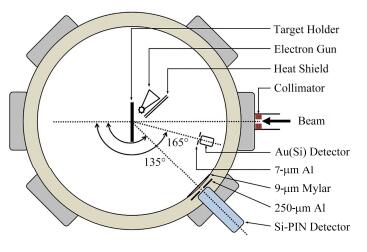
|
图 1 真空靶室装置示意图 Figure 1 Schematic diagram of the in-vacuum chamber. |
整个金属靶室处于与周围金属管道绝缘的状态,靶室周围一共有6个出口,用于与束流管道连通、放置探测器和信号线,以及作为实验过程中的观察窗。由加速器提供的束流垂直于样品表面轰击到靶样上,用于RBS探测的金硅面垒型半导体探测器在真空靶室内,放置于与束流方向成165°处;用于PIXE探测的Si-PIN探测器放置于真空靶室外,探测器与束流成135°,该靶室出口的法兰盘中央是一层约9 μm厚的Mylar膜用于密封真空。入射束流与这两个探测器处于同一水平面。
目前使用的Au(Si)探测器购于中核北京核仪器厂,型号GM-8,灵敏区面积直径为8 mm,当工作偏压为+200 V时,耗尽层深度约为300μm,在使用241Am标准α放射源进行能量刻度时,该Au(Si)探测器在5.486 MeV的分辨率(半高宽)实际测量值为18.55keV。目前使用的Si-PIN电致冷探测器购于美国AMPTEK公司,型号XR-100CR,铍窗厚度7.5μm,灵敏区面积6 mm2,灵敏区厚度500μm,硅死层厚度150 nm,能量分辨率在5.9 keV处为185 eV。实验数据的获取和记录采用基于计算机的ORTEC MCA多道卡。
当待分析样品是陶瓷之类的绝缘样品时,靶室内会使用一个灯丝为LaB6的电子枪向靶喷射电子。因为真空环境下,带正电的质子束入射到绝缘的陶瓷样品时,正电荷会逐渐堆积在样品表面使该点的电势能逐渐增高并放电,将产生很强的轫致辐射本底,这很可能会掩盖住一些有用的能谱信息[8]。引入的电子枪产生的热电子被堆积的质子所吸引[9],可以抵消电荷堆积并降低由此产生的轫致辐射本底。实验中电子枪放置在样品表面侧前方约2 cm处,电流参数约为2 A,并加+450 V偏压吸引电子向绝缘样品运动,偏压和电流值都可以结合束流强度和轫致辐射本底的抑制情况进行调节。由于Au(Si)探测器的光敏特性,为了避免LaB6电子枪的发光对Au(Si)探测器的影响,在Au(Si)探测器前放置了一层厚约7 μm的Al薄膜作为光屏蔽措施,但是背散射质子仍可穿过这层Al膜被Au(Si)探测器所探测到。同时,Au(Si)半导体探测器的性能也受环境温度的影响,温度升高会引起峰位漂移。为了减少电子枪发热而引起探测器工作温度的变化,在电子枪与Au(Si)之间放置有导热性较好的双层厚铜板,铜板可将热量分散到靶室壁上,整个靶室温度几乎不会增加。
Si-PIN探头前放置有一片中心带有直径约为0.5 mm小孔的250 μm厚的Al膜,作为选择性滤膜,即“funny filter”。选择性滤膜的概念在文献[10]对PIXE分析法的介绍中首次提出。在PIXE分析中,可以在探测器前放置Mylar或Al作吸收片,吸收掉低能的轫致辐射本底,而较高能的特征X射线仍可以直接透过这层滤膜被探测到。但这种吸收片的缺点是它也会阻挡低Z元素的低能特征X射线被探测到。如果要对低Z高Z元素同时探测,一种做法是分别使用加与不加吸收片的双探头;另一种做法就是使用加中心带孔的选择性滤膜的单探头。选择性滤膜中心的小孔大小通常只占探测器灵敏区面积的百分之几,虽然只有小部分的低能X射线会穿过小孔而被探测到,但是由于它们具有很高的产生截面,所以相对于高Z元素的特征X射线峰仍有较高的强度。而因小孔提高的轫致辐射对整个分析的负面影响可以忽略[10-12]。
PIXE分析根据元素特征X射线产额确定该元素的含量,其理论公式如下:
| ${Y_{\rm{m}}}(Z) = {Y_{\rm{t}}}(Z)Q{C_Z}HT(Z){\varepsilon _Z}$ | (1) |
式中:Ym(Z)表示样品中原子序数为Z的元素的特征X射线产额实际测量值;Yt(Z)表示元素Z单位离子电荷、单位立体角、单位元素浓度的理论X射线产额;Q表示入射电荷值;CZ表示元素Z的元素含量;T(Z)表示元素Z的特征X射线透过靶与探测器之间的X射线过滤片的透射系数;εZ表示探测器的本征探测效率;H值称为仪器常数或刻度因子。理论上H因子是对应于探测器立体角的一个常数,但实际情况下,由于理论数据库的缺陷、探测器参数(如铍窗厚度、晶体有效面积等)描述的偏差、探测器与样品之间所用滤膜的厚度不准确、尤其是带孔的选择性滤膜的使用,会使H因子偏离常数,而成为随特征X射线能量变化的函数[13]。我们选用了10个纯度为99.99%的纯金属单质厚靶,在正式实验条件下对不同X射线能量处的H因子进行测量,选用的10个纯金属单质为Al、Si、Ti、Fe、Cu、Zn、Ge、Zr、Mo、Ag,它们的特征K壳层X射线能量为1.487-22.163 keV,覆盖了常规待检测样品中所含元素的特征X射线的能量范围。
2 结果与讨论实验中,PIXE和RBS两者信号同时分别采集,每个样品对应着两个谱文件。使用软件SIMNRA (version 6.06, MPI für Plasmaphysik, Garching, Germany)[14]处理RBS谱,使用软件GUPIXWIN (version 2.2.3, University of Guelph, Guelph, Ontario, Canada)[15]处理PIXE谱。单质样品Cu的RBS和PIXE的实验谱及拟合谱分别如图 2、3所示。

|
图 2 Cu的RBS实验谱及其SIMNRA拟合谱 Figure 2 RBS spectrum of Cu and the fit by the SIMNRA code. |

|
图 3 Cu的PIXE实验谱及其GUPIXWIN拟合谱 Figure 3 PIXE spectrum of Cu and the fit by the GUPIXWIN code. |
解RBS和PIXE谱都需要已知入射质子束的能量。束流能量虽然可以由加速器控制室的仪表盘直接读出,但为了使入射能量值更加精确,具体实验中可以根据一块薄金靶的背散射谱拟合来确定入射能量。在每次分析待测样品前,都会在相同实验条件下,先对样品架上的一个铝衬底薄金靶进行背散射测量,然后使用SIMNRA分析处理这个背散射谱,根据金的背散射峰能量,结合背散射运动学关系,即可得到入射束流的能量。
对解PIXE所必须的入射电荷值Q,有直接测量法和间接测量法。对于普通薄膜等束流可以穿透的薄靶,常用靶后接法拉第筒和束流积分器进行直接测量。而对于厚靶样品,我们使用了间接测量法,由RBS分析结果间接得到电荷值。当对背散射谱拟合后,SIMNRA程序可以给出入射离子数和探测器立体角的乘积[14],所以只需要对背散射所用的金硅面垒探测器进行准确的立体角测量,就可以得到入射电荷值。此方法得到电荷值的误差主要来源于对背散射谱拟合的误差,本实验中背散射谱的统计误差小于2%。
为了准确得到Au(Si)的立体角,我们采用了两种方法:第一种是几何测量,Au(Si)探测器前准直孔直径为3 mm,准直孔与靶点间距离为82.75 mm,由立体角公式计算可得Ω=S/d2=1.03×10-3 sr;另一种方法是对Cu薄膜进行背散射测量,间接得到立体角[6]。该薄膜是通过磁控溅射法在约9 μm的Mylar膜上镀约2 μm的铜,该薄膜可以被2 MeV质子穿透,薄膜后接法拉第筒和束流积分器用于精确测量入射电荷值,法拉第筒前加-300 V偏压抑制二次电子逃逸。对该背散射谱拟合后可得粒子束与球面度的积,将法拉第筒收集的电荷值换算成入射质子的数目,即可求得该立体角。这种间接法求立体角的结果同样为1.03×10-3 sr,误差主要来自于背散射谱的统计涨落,约1.5%。
H值的计算同样基于式(1)。GUPIXWIN程序会根据我们编写的探测器参数文件,由它自带的数据库计算出理论产额Yt、透射系数T(Z)和本征探测效率εZ。式(1) 中的Ym为测量的实际产额,电荷值Q由前述方法得到,而标准单质样品的含量CZ为1,所以式(1) 中仅H值未知。在使用GUPIXWIN解单质元素Z的PIXE谱时,先将H值设置为常数1,拟合结果中得到的该元素含量结果为CZ, f,则实际该元素特征X射线能量处对应的H值应为:
| $ H{\rm{ = }}{C_{Z{\rm{, f}}}}/{C_Z} $ | (2) |
根据这种做法,我们得到的H值结果见表 1。
| 表 1 由10个金属单质厚样测得的K壳层X射线的H值及其误差 Table 1 Measured H values and errors for K-shell X-rays by using ten single-element thick pure metal samples. |
将测得的H值绘制成与X射线能量相关的曲线,如图 4所示,可以看到,在能量较低的范围内,H值明显偏离常数。正式处理其它待测样品的PIXE谱时,在GUPIXWIN程序输入H值的界面,允许用户自行编写随能量变化的H值文件。在未使用标准样品刻度H值的能量处,程序会根据H曲线使用线性内插的方法得到该能量处的H值;超过刻度能量覆盖范围的点,会使用最近一个相邻的H值[15]。如果待分析的样品中含有我们没有刻度的某元素,比如K、Ca,那么GUPIXWIN程序只能通过线性内插来得到该元素X射线能量处的H值,这样得到的结果可能会使误差增大。为了解决这个问题,一种理想的做法是对元素周期表中每个元素都分别进行刻度,得到其对应能量处的H值。还有另一种做法是可以将H值进一步拟合成一个不随能量变化的常数[10-11]。

|
图 4 由10个金属单质厚样测得的K壳层X射线随能量变化的H值以及拟合参数后得到的常数H值 Figure 4 Energy dependent H-values calculated from experimental spectra for K-shell X-rays of ten single-element thick pure metal samples, and the H-values recalculated using effective values of three filter parameters. |
前文已经说明,H值偏离常数的主要原因在于原子数据库、探测器参数、滤膜参数三者的不准确,我们处理数据过程中能人为调整的是后两者,所以,使用最小二乘法对探测器参数和各滤膜的参数进行拟合。拟合基于式(3):
| $ {H_{{\rm{opt}}}}{\varepsilon _{{\rm{opt}}}} = {H_{{\rm{nom}}}}{\varepsilon _{{\rm{nom}}}} $ | (3) |
式中:右边是根据给定的探测器参数和滤膜参数得到的本征探测效率εnom和前文得到的随能量变化的Hnom值;使用最小二乘法对各项参数进行拟合,拟合后的新参数对应新的本征探测效率εopt和Hopt值。计算Si-PIN探测器的本征探测效率的公式[16-17]如下:
| $ \varepsilon (E) = T(E){T_{{\rm{col}}}}(E)A(E) $ | (4) |
式中:T(E)、Tcol(E)、A(E)分别表示X射线穿过各吸收片的透射率、穿过准直器的透射率、在探测器灵敏层中的吸收率,它们的表达式参见文献[16-17]。在拟合中,我们将探测器参数固定不变,减少拟合变量,只对隔绝真空的Mylar膜厚度、作为funny filter的Al膜厚度和中心小孔大小这三个参数进行了拟合,拟合结果见表 2。拟合后的常数H值与原H曲线对比见图 4。
| 表 2 拟合前后Mylar膜厚度、选择性滤膜Al片的厚度及中心小孔大小的对比 Table 2 Comparisons between the nominal and optimized values of H, Mylar-filter thickness, Al funny filter thickness and funny filter aperture diameter. |
对比拟合前后的结果,选择性滤膜Al片的有效厚度实际为(255±4) μm,与标称值250 μm差异不大;其中心小孔的尺寸变大,可能是由于在加工直径0.5 mm的小孔时,实际操作过程中钻孔稍大了一些;Mylar膜的有效厚度(22.0±0.2) μm,比我们认为的9 μm大了很多,我们分析可能是由于拟合过程中固定了探测器参数保持不变,那么铍窗厚度或其它探测器参数的不准确性以及原子参数的不准确性都将反映到被拟合的这三个参数的有效值中来,所以引起了Mylar膜有效厚度的较大差异。
为了检验H值刻度结果的准确性,我们使用该PIXE-RBS系统对中国计量科学研究院提供的标准粘土样品W03102a在相同实验条件下进行测量。选择粘土标准样品是因为本系统将来会用于金沙遗址雍锦湾出土陶瓷的成分分析,粘土与陶瓷的成分相似。表 3显示了实验测得的各成分含量与标准物质证书数据的对比。标准粘土样品先在恒温电炉烘箱中300 ℃烘干12 h后放入干燥器中冷却备用,然后压片制样。为了便于对比,表 3中证书数据是去除了约8.81%的烧失量(CO2、结晶水等)后归一化得到的。其它几个由于PIXE不能探测到或者因含量太低接近探测限而无法准确测量的几个元素如Na、Mg、P、S的元素含量未列出。通过表 3数据对比,可见测量数据与证书数据符合得较好,结果比较理想,说明该H值刻度是可靠的。
| 表 3 粘土标准样品W03102a的PIXE-RBS分析结果与证书参考数据(去除烧失量)对比 Table 3 Comparisons between the certified values and the measured values of chemical composition by weight for the clay standard sample No.W03102a by PIXE-RBS. The certified values were modified by not taking into account the loss on ignition. |
本文对基于2.5MeV范德格拉夫静电加速器搭建的PIXE-RBS离子束分析系统及其刻度工作进行了介绍。
通过几何测量和Cu膜背散射测量两种方法,确定了用于RBS的金硅面垒探测器的立体角为1.03×10-3sr。采用了通过背散射谱SIMNRA拟合而间接得到入射电荷值的方法,该方法的误差来自于背散射谱的统计误差,小于2%。为了刻度仪器常数H因子,首先在正式试验条件下测量了10个纯金属单质(Al、Si、Ti、Fe、Cu、Zn、Ge、Zr、Mo、Ag),得到了随能量变化的H值曲线,然后使用最小二乘法对有关参数进行了拟合,得到H值。在保持Si-PIN探测器参数不变的情况下,得到的Mylar膜有效厚度为(22.0±0.2) μm,选择性滤膜Al片的有效厚度为(255±4) μm,中心小孔有效直径为(0.836±0.007) mm。拟合实验参数后新的H值为常数(1.35±0.02)×10-4,并使用标准粘土样品W03102a对刻度H值进行了检验,测量数据与证书参考数据符合得较好。
| [1] | Johansson S A E, Campbell J L, Malmqvist K G. Particle-induced X-ray emission spectrometry (PIXE)[M]. New York: Wiley Press, 1995. |
| [2] | Chu W K, Mayer J W, Nicolet M A. Backscattering spectrometry[M]. New York: Academic Press, 1978. |
| [3] |
杨福家, 赵国庆.
离子束分析[M]. 上海: 复旦大学出版社, 1985.
YANG Fujia, ZHAO Guoqing. Ion beam analysis[M]. Shanghai: Fudan University Press, 1985. |
| [4] |
赵国庆, 任炽刚.
核分析技术[M]. 北京: 原子能出版社, 1989.
ZHAO Guoqing, REN Chigang. Nuclear analysis technology[M]. Beijing: Atomic Energy Press, 1989. |
| [5] | Ye L, Liu M T, Huang W, et al. PIXE/RBS studies on ancient pottery from Jinsha ruins site of Chengdu[J]. Nuclear Physics Review, 2010, 27(4): 493–499. |
| [6] | Wu Q Q, Zhu J J, Liu M T, et al. PIXE-RBS analysis on potteries unearthed from Lijiaba site[J]. Nuclear Instruments and Methods in Physics Research B, 2013, 296: 1–6. DOI: 10.1016/j.nimb.2012.12.004 |
| [7] | Zhou Z, Zhang K, Xia C D, et al. Analysis of elemental composition of porcelains unearthed from Waguantan kiln site by PIXE-RBS[J]. Nuclear Instruments and Methods in Physics Research Section B:Beam Interactions with Materials and Atoms, 2015, 346: 1–7. DOI: 10.1016/j.nimb.2015.01.031 |
| [8] | Dias J F, Bulla A, Yoneama M L. Charging effects in thick insulating samples[J]. Nuclear Instruments and Methods in Physics Research Section B:Beam Interactions with Materials and Atoms, 2002, 189(1-4): 72–76. DOI: 10.1016/S0168-583X(01)00997-1 |
| [9] | Ismail I M, Rihawy M S. Comprehensive method to analyze thick insulating samples using PIXE technique[J]. Nuclear Instruments and Methods in Physics Research Section B:Beam Interactions with Materials and Atoms, 2013, 296: 50–53. DOI: 10.1016/j.nimb.2012.11.016 |
| [10] | Nejedly Z, Campbell J L, Gama S. An Excel utility for the rapid characterization of "funny filters" in PIXE analysis[J]. Nuclear Instruments and Methods in Physics Research B, 2004, 219-220: 136–139. DOI: 10.1016/j.nimb.2004.01.041 |
| [11] | Gama S, Volfinger M, Ramboz C, et al. Accuracy of PIXE analyses using a funny filter[J]. Nuclear Instruments and Methods in Physics Research B, 2001, 181: 150–156. DOI: 10.1016/S0168-583X(01)00350-0 |
| [12] | Shariff A, Bülow K, Elfman M, et al. Calibration of a new chamber using GUPIX software package for PIXE analysis[J]. Nuclear Instruments and Methods in Physics Research B, 2002, 189: 131–137. DOI: 10.1016/S0168-583X(01)01018-7 |
| [13] | Campbell J L, Hopman T L, Maxwell J A, et al. The Guelph PIXE software package Ⅲ:alternative proton database[J]. Nuclear Instruments and Methods in Physics Research B, 2000, 170: 193–204. DOI: 10.1016/S0168-583X(00)00156-7 |
| [14] | Mayer M. SIMNRA user's guide[M]. Report IPP 9/133, Garching, Germany: Max-Planck-Institut für Plasmaphysik, 1997. |
| [15] | Campbell J L, Boyd N I, Grassi N, et al. The Guelph PIXE software package Ⅳ[J]. Nuclear Instruments and Methods in Physics Research B, 2010, 268(20): 3356–3363. DOI: 10.1016/j.nimb.2010.07.012 |
| [16] | Zhao J L, Tian L X, Li X L, et al. Measurements of L shell X-ray yields of thick Ag target by 6-29 keV electron impact[J]. Radiation Physics and Chemistry, 2015, 107: 47–53. DOI: 10.1016/j.radphyschem.2014.09.009 |
| [17] |
谭文静, 安竹, 朱敬军, 等. 10-25 keV电子致厚W, Au靶轫致辐射谱的测量[J].
物理学报, 2016, 65: 87–93.
TAN Wenjing, AN Zhu, ZHU Jingjun, et al. Bremsstrahlung spectra produced by 10-25 keV electron impact on thick W, Au targets[J]. Acta Physica Sinica, 2016, 65: 87–93. DOI: 10.7498/aps.65.113401 |


