2. 西北核技术研究所 西安 710024
2. Northwest Institute of Nuclear Technology, Xi'an 710024, China
砷化镓(GaAs)半导体是一种直接禁带半导体材料,因其具有较高的电子迁移率而广泛应用于光纤通信、航天以及半导体发光器件等领域。由砷化镓制成的超高速强流脉冲辐射探测器对γ射线、X射线、中子以及带电粒子都很灵敏。这种探测器可以用于同步辐射装置、惯性约束聚变、核武器研制等各种辐射场中脉冲粒子流的测量,以及应用于亚纳秒技术的各个领域。在这些环境中,由于受到粒子辐照损伤器件参数很容易变坏。因此,研究砷化镓的粒子辐照效应对砷化镓抗辐照器件的应用具有指导意义。
粒子辐照会在GaAs单晶内产生移位原子或空位而形成缺陷,这些缺陷会俘获电子或载流子,对材料的宏观性能产生影响。光致发光(Photoluminescence, PL)谱也称荧光光谱,是一种研究半导体材料发光性能的有效测试方法。过去数十年,国内外利用PL谱的研究主要集中在中子辐照对掺硅GaAs发光性能的影响[1-4]以及高能质子辐照GaAs太阳电池后对其光电性能的影响[5-6],但对于低能质子及重离子注入未掺杂GaAs则鲜有报道。此外,拉曼散射谱也被应用于研究GaAs辐照效应对其晶体结构的影响,Peercy[7]最早报道了重离子辐照后拉曼谱中声子峰出现明显变化,随后Tiong[8]采用空间局域模型给出了砷离子注入后产生的微晶尺寸,并对声子峰随辐照剂量增大的变化给出了解释。Holtz等[9]又通过拉曼光谱研究了砷化镓辐照后的损伤随深度分布的变化情况。
本文的工作是利用质子、氪离子辐照未掺杂半绝缘砷化镓(SI-GaAs)。通过PL光谱和拉曼散射谱的表征方法,研究了辐照损伤对其发光性能和晶体结构的影响。尝试通过计算移位损伤(Displacement per atom, dpa)将两种离子辐照相结合,得到随移位损伤增大发光性能和晶体结构的变化趋势,重点研究了这种变化的机理及辐照产生缺陷的演化过程。
1 实验介绍样品采用垂直梯度凝固法(Vertical gradient freeze, VGF)生长的SI-GaAs单晶晶片,表面为(100)晶面,其电阻率约为1×108Ω·cm,电子迁移率约为5.3×103 cm2·V-1·s-1。样品表面尺寸为1 cm×0.8 cm,厚度约为700 μm。
质子和氪离子(Krq+)辐照是在中国科学院近代物理研究所320 kV高电荷态离子源平台上进行的,质子辐照能量为250 keV,注量为1×1012-3×1014cm-2,流强约为50 nA。选用的Kr离子束的电荷态为17+,能量为4.5 MeV,注量为3×1011-3×1014 cm-2,流强约为1 μA。整个辐照过程中靶室真空度约为5×10-4 Pa。
PL谱的测试采用中国科学院苏州纳米技术与纳米仿生研究所变温测试系统的光致发光谱仪,激发光波长选为532nm,发射光谱波长范围为750-1000 nm,分辨率为0.5 nm,测量温度是在液氦4 K下进行的。拉曼光谱测试仪器为Labram HR800型激光共聚焦拉曼光谱仪,实验配置为背向散射,激发波长为532 nm,测量范围100-500 cm-1,光谱分辨率约为1 cm-1,测试在室温条件下完成。另外本文中所用的PL光谱和拉曼光谱这两种测试手段对应光子能量均为2.33 eV,光子穿透深度dopt=1/2α,此能量下的GaAs吸收系数α约为7.456×104cm-1[10],因此估算出测试深度约为65 nm。
2 实验结果 2.1 光致发光谱图 1是不同注量质子和Kr离子辐照后的SI-GaAs及原生样品的PL谱。从图 1中可以看出,有3个明显的发光锋。从左到右依次是位于820 nm (1.5121 eV)附近对应自由激子(Free exciton, FE)以及各种束缚激子(Bound exciton, BE)跃迁的激发峰;位于830 nm (1.4939 eV)和832 nm (1.4903 eV)的激发峰对应导带到碳杂质受主CAs的跃迁C(B-A)以及施主能级到CAs的跃迁形成的施主-受主对(Donor-acceptor pair, DAP),其中碳杂质为砷化镓基片生长过程中引入的一种本征杂质原子;位于850nm (1.4588 eV)的发光峰为CAs峰的声子伴线(Phonon replica, PR)[2, 11]。CAs峰及其声子伴线是砷化镓中的本征缺陷峰,其强度随质子辐照剂量的增大明显衰减(图 1(A-E)),当1×1012cm-2Kr离子辐照后发光峰完全消失(图 1(F)),我们将在分析讨论部分详细说明。需要注意的是913 nm (1.358 eV)处还有一小峰,这对应着导带到复合缺陷IGa-VAs跃迁的发光峰[4],有人认为该处的发光峰与铜(Cu)受主有关[12]。我们将该峰放大后如图 2所示,可以很明显地看到这是辐照后产生的峰,原生样品在该处并没有发光峰。因此,此峰与材料制备时的Cu掺杂无关。
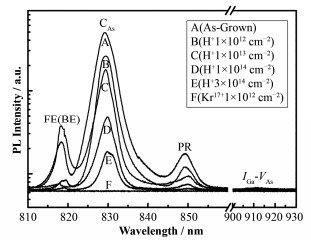
|
图 1 250 keV质子和4.5 MeV Kr17+辐照后的半绝缘GaAs PL谱 Figure 1 PL spectrum for SI-GaAs irradiated by 250-keV proton and 4.5-MeV Kr17+ ions. |

|
图 2 PL谱中位于913 nm处缺陷峰 Figure 2 913-nm defect peak in PL spectrum. |
拉曼散射谱是用于研究晶体结构变化的主要测试手段。砷化镓材料的拉曼谱中主要有两个峰,分别是位于292 cm-1的光学支格波纵(Longitudinal optical, LO)声子峰和269 cm-1光学支格波横(Transverse optical, TO)声子峰,且TO峰在(100)方向背散射模式下是禁戒的。在对SI-GaAs进行质子辐照和Kr离子辐照后拉曼谱分别如图 3(a)、(b)所示,原生谱中LO峰和TO峰的峰位并没有在292cm-1和269 cm-1处,而是位于295 cm-1和271cm-1,这是由于VGF法生长的样品残余应力较小从而造成声子峰峰位偏大[13]。对于质子辐照,随着辐照剂量的增大,LO声子峰的峰位和峰宽基本没有变化,禁戒的TO声子峰很弱。对于Kr离子辐照,随着辐照注量的增大,LO声子峰的峰位向低频方向移动,强度衰减,出现了很明显的非对称性展宽,TO声子峰开始明显增强,这是由局部晶格失序扰乱了选择定则造成的。当注量达到1×1013cm-2时,还可以看到声子峰向低频方向延伸到200 cm-1处以及中心在180 cm-1处出现了由许多无序峰组成的宽带。
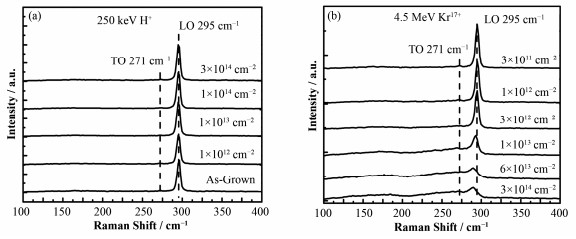
|
图 3 半绝缘GaAs的拉曼光谱(a)质子辐照,(b) Kr17+辐照 Figure 3 First-order Raman spectra of SI-GaAs. (a) Proton irradiation, (b) Kr17+ ions irradiation |
对于带电粒子辐射诱导的损伤效应,主要通过电子能损和核能损两种机制对材料造成损伤。当入射粒子能量较低时,核能损是主要的损伤机制,入射离子与材料内的晶格原子碰撞,使其产生移位,形成移位损伤缺陷,这些缺陷会在半导体禁带中产生新的载流子俘获中心,从而对半导体的光电性能产生影响。dpa是材料中每个原子被撞出移位的次数。因此可以通过计算移位损伤剂量表征辐照后砷化镓内产生的损伤。移位损伤剂量的计算方法如下:
| $\text{dpa}=\frac{\Phi (N_{\text{Ga}}^{\text{vac}}+N_{\text{As}}^{\text{vac}}+{{N}^{\text{nov}}}){{M}_{\text{mol}}}}{\rho {{N}_{\text{A}}}}$ | (1) |
式中:NGavac为每个入射粒子在单位射程上产生的Ga空位的平均浓度;NAsvac为每个入射粒子在单位射程上产生的As空位的平均浓度;Nnov为每个入射粒子在单位射程上产生的级联空位的平均浓度。这三项可以由SRIM程序模拟给出[14]。Ф为入射粒子注量;ρ为靶物质密度(5.3 g·cm-3);NA为阿伏伽德罗常数(6.02×1023 mol-1);Mmol为GaAs摩尔质量数(145g·mol-1)。
图 4和5是用SRIM-2013程序分别模拟计算的在GaAs中注入剂量为3×1014cm-2质子和Kr离子后,材料的移位损伤剂量以及入射离子的沉积随深度的分布关系。其中质子和Kr离子的最大射程约为1980 nm和1820 nm,两种离子在材料中的射程相近且都远大于PL光谱和拉曼光谱的分析深度(约65 nm),移位损伤随入射深度有明显变化且主要集中在射程末端,分别为7.51×10-3 dpa和1.95 dpa,此时对应的质子和Kr离子原子百分含量分别为0.89%和0.35%。因此在同等注入剂量下重离子辐照损伤比质子大三个量级左右。考虑本工作选择的两种光谱测试方式的测试深度为65 nm左右,为与实际情况相符,选择了两种离子在测试深度处的移位损伤剂量,分别为1.2×10-4 dpa和5.1×10-1 dpa,此时Kr离子的辐照损伤也比质子大至少三个量级。
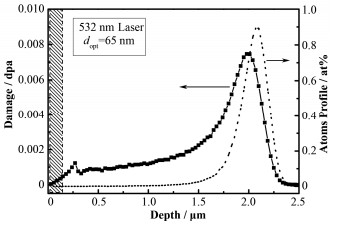
|
图 4 SRIM-2013模拟250 keV H+离子辐照半绝缘GaAs后移位损伤与H+含量随深度的分布 Figure 4 Displacement damage dose and H+ atoms profile with ions depth for SI-GaAs by implantation with 250-keV H+ from SRIM-2013. |
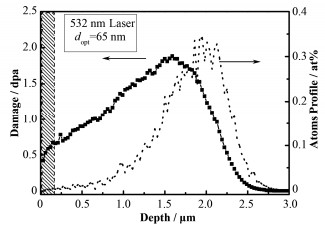
|
图 5 SRIM-2013模拟4.5 MeV Kr17+离子辐照半绝缘GaAs后移位损伤与Kr17+含量随深度的分布 Figure 5 Displacement damage dose and Kr17+ atoms profile with ions depth for SI-GaAs by implantation with 4.5-MeV Kr17+ from SRIM-2013. |
为更好地研究辐照损伤对GaAs材料发光性能的影响,做出了前述PL谱中CAs缺陷峰及IGa-VAs复合缺陷峰随损伤剂量的变化关系,如图 6所示。当损伤剂量很低时,材料内的辐照损伤主要以点缺陷(Frenkle pairs)为主,这些缺陷与GaAs内的杂质原子相互作用产生复合缺陷俘获激子发光。随着损伤增大,复合缺陷会增多,相应复合缺陷发光峰(IGa-VAs)也会增大,使得位于近导带附近的CAs本征缺陷峰呈现衰减趋势。随着损伤继续增大,除了产生点缺陷,还能形成多空位等复杂缺陷。这些缺陷会在中间带隙引入许多新的深能级陷阱[15],从而俘获激子发光,造成自由激子数目的减少,致使CAs峰强度减弱的同时复合缺陷峰也会衰减。当损伤剂量达到2×10-3dpa时,即用注入剂量为1×1012cm-2Kr离子辐照后,所有发光峰完全衰减到零。此时GaAs内的缺陷非常多,在禁带中产生了很多深能级中心以及非辐射复合中心,从而完全复合了激子,使得导带附近的缺陷发光中心不能通过激子的跃迁而发光。此外,大量缺陷也会相互聚集形成更复杂的缺陷团,使晶格空间的完整性遭到破坏,发光中心不能通过激子跃迁发光。晶体空间完整性被破坏也在图 3(b)的Kr离子辐照的拉曼谱中得到了验证。
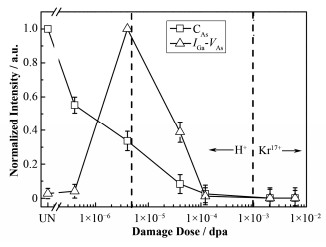
|
图 6 发光峰归一化强度随损伤剂量的变化关系 Figure 6 Normalized PL peak intensity as a function of implantation damage dose by 250-keV H+ and 4.5-MeV Kr17+ ions. |
拉曼光谱中的LO声子峰的峰位和半高宽的变化情况如图 7所示。当损伤剂量非常小时,辐照产生的移位损伤非常小且不足以破坏晶体空间完整性,因而其峰位和半高宽基本无变化。Kr离子辐照使得损伤剂量增大到超过0.01 dpa时,峰位和半高宽开始出现明显的变化,并在0.1 dpa时趋于饱和。晶体内应力增大造成峰位向低频方向移动,晶体空间完整性被严重破坏,使得峰出现明显的非对称性展宽,辐照区域产生微晶结构(μ-GaAs)和非晶结构(α-GaAs)的混合体。从整体来看,GaAs晶体开始向非晶态转化[16],如图 3(b),从Kr离子辐照拉曼谱中可以看到,晶体无序度变大使得被禁戒的TO峰强度增加,晶体向非晶态转变从而形成了许多无序峰组成的宽峰带。Peercy等[7]用400 keV的Xe离子辐照GaAs观察到了声子峰的半高宽在注入剂量超过5×1012cm-2开始有明显变化,我们计算出该注量下所对应损伤剂量约为0.013 dpa,Braunstein等[17]采用1 MeV的Si离子注入后LO峰峰位和半高宽发生明显变化时所对应的损伤剂量约为0.015 dpa,都超过了0.01 dpa对应的损伤阈值。因此,对于低能离子注入,只有当损伤剂量超过0.01 dpa时,GaAs晶体才会发生明显畸变。

|
图 7 LO峰随损伤剂量的变化关系(a)峰位变化,(b)半高宽变化 Figure 7 LO peak position and FWHM as a function of implantation damage dose. |
Menzel等[18]通过比较碳化硅辐照后的拉曼谱结果和卢瑟福背散射谱结果,给出了通过拉曼谱得到无序度的计算方法。为进一步分析晶体结构随辐照损伤演化的机理,我们给出了Kr离子辐照GaAs后无序度随损伤剂量的变化关系,如图 8所示。

|
图 8 Kr17+辐照后无序度随损伤剂量的变化关系 Figure 8 Total disorder as a function of implantation damage dose by Kr17+ions. |
无序度的计算公式为:
| ${{f}_{\text{d}}}=1-\frac{{{A}_{\text{LO}}}}{A_{\text{LO}}^{\text{cryst}}}$ | (2) |
式中:ALO代表辐照后LO声子峰的面积;ALOcryst代表原生晶体的LO声子峰的面积。
Jagielski等[19]提出的多级损伤累积(Multi-step damage accumulation, MSDA)模型与我们的实验结果符合较好。采用两级损伤累积,拟合公式为:
| $\left\{ \begin{align} & {{f}_{\text{d},1}}=f_{\text{d},1}^{\text{sat}}\left[ 1-\exp (-{{\sigma }_{1}}D) \right]\text{ }(0<D<{{D}_{1}}) \\ & {{f}_{\text{d},2}}=f_{\text{d},2}^{\text{sat}}+(f_{\text{d},2}^{\text{sat}}-f_{\text{d},1}^{\text{sat}}) \\ & \ \ \ \ \ \ \ \ \ \ \left[ 1-\exp (-{{\sigma }_{2}}(D-{{D}_{1}})) \right]\text{ }(D>{{D}_{1}})\text{ } \\ \end{align} \right.$ | (3) |
式中:ƒd, 1sat和ƒd, 2sat分别为第一级和第二级累积损伤过程的无序度饱和值;σ1和σ2分别为第一级和第二级损伤截面;D是损伤剂量(dpa);D1是第一级向第二级转化的临界损伤剂量(dpa)。
拟合参数如表 1所示。第一级损伤累积过程发生在损伤剂量小于0.01 dpa时,在低损伤剂量下辐照产生的缺陷以点缺陷对为主且主要分布在晶格间隙处,对晶体结构没有太大影响,这与图 7所示LO峰的峰位和半高宽在损伤剂量小于0.01 dpa时基本不变的结果一致。由于点缺陷对的间隙原子在室温下很可能迁移至晶格的表面层,使得损伤层中的空位浓度增加形成空位富集区,从而造成晶体无序度的升高。这与Vetrano等[20]通过透射电镜(Transmission electron microscope, TEM)观察到的结果一致。我们通过PL谱的测试结果(图 6)从侧面证实了空位发生聚集的过程。在这一阶段,随着空位浓度升高,相应的间隙原子与空位的复合几率也会增大,空位浓度达到稳定,因此当辐照剂量接近0.01dpa时,无序度会饱和,饱和值为0.19。第二级损伤累积过程发生在辐照剂量大于0.01 dpa时,高浓度的空位缺陷聚集增大了晶体内应力[19],同时会形成更复杂的缺陷团簇,进而破坏了晶格的完整性,使得晶体发生畸变,无序度增大。图 7所示LO峰的峰位和半高宽的变化也证实了辐照损伤剂量大于0.01 dpa时会出现晶体畸变。二级损伤在辐照剂量超过0.1 dpa时达到饱和,此时LO峰的峰位和半高宽也趋于稳定,晶体畸变过程达到平衡。Braunstein等[17]指出在高剂量离子辐照下会发生动力学退火效应使GaAs内的缺陷出现自修复行为,因而无序度能够达到稳定。值得注意的是此时饱和无序度为0.71,说明GaAs晶体没有完全转化为非晶态,可能存在着第三级甚至更多的损伤累积过程,需要更高辐照剂量的结果加以证明。
| 表 1 MSDA模型拟合无序度的参数 Table 1 Fitted parameters of the total disorder data (deduced from Raman spectroscopy) by using the MSDA model. |
本文研究了质子和Kr离子注入GaAs的光致发光谱以及拉曼散射谱。通过计算dpa量化了不同离子的辐照效应,表明质子和Kr离子辐照后的明显差异主要是由于重离子移位损伤比质子至少大三个量级造成的。当损伤剂量非常低时,产生的缺陷以点缺陷为主,其对晶体的结构影响不大,但这些点缺陷会与材料内的杂质相互作用形成缺陷能级俘获激子发光,从而减弱半导体的本征发光峰。当损伤剂量很高时,移位原子非常多,产生级联效应,大量点缺陷聚集增大了晶体的内应力且形成复杂的缺陷团簇,破坏了晶体结构,出现局域非晶化。最后采用MSDA模型拟合Kr离子辐照后无序度的变化情况,得到辐照缺陷随损伤剂量增大的演化过程,很好地对应了GaAs光学性能和结构的变化趋势。
| [1] |
Khanna S M, Rejeb C, Jorio A, et al. Electron and neutron radiation-induced order effect in gallium arsenide[J].
IEEE Transactions on Nuclear Science, 1993, 40 (6) : 1350 –1359.
DOI: 10.1109/23.273532 ( 0) 0)
|
| [2] |
Jorio A, Rejeb C, Parenteau M, et al. Radiation induced carrier enhancement and intrinsic defect transformation in n-GaAs[J].
Journal of Applied Physics, 1993, 74 (4) : 2310 –2317.
DOI: 10.1063/1.354716 ( 0) 0)
|
| [3] |
Jorio A, Parenteau M, Aubin M, et al. A mobility study of the radiation induced order effect in gallium arsenide[J].
IEEE Transactions on Nuclear Science, 1994, 41 (6) : 1937 –1944.
DOI: 10.1109/23.340527 ( 0) 0)
|
| [4] |
刘健, 王佩璇. 中子辐照GaAs快速退火行为的低温光荧光研究[J].
发光学报, 1998, 19 (1) : 50 –55.
DOI: 10.3321/j.issn:1000-7032.1998.01.010 LIU Jian, WANG Peixuan. Photoluminescence of defects in neutron-irradiated SI-GaAs[J]. Chinese Journal of Luminescence, 1998, 19 (1) : 50 –55. DOI: 10.3321/j.issn:1000-7032.1998.01.010 (  0) 0)
|
| [5] |
Anspaugh B E. Proton and electron damage coefficients for GaAs/Ge solar cells[C]. Photovoltaic Specialists Conference, Conference Record of the Twenty-Second IEEE, 1991:1593-1598. DOI:10.1109/PVSC.1991.169472
( 0) 0)
|
| [6] |
赵慧杰, 何世禹, 肖志彬, 等. 50-170 keV质子照射对GaAs/Ge太阳能电池光谱响应的影响[J].
核技术, 2008, 31 (1) : 31 –34.
ZHAO Huijie, HE Shiyu, XIAO Zhibin, et al. 50-170keV proton irradiation on spectral response in GaAs/Ge space solar cell[J]. Nuclear Techniques, 2008, 31 (1) : 31 –34. (  0) 0)
|
| [7] |
Peercy P S. Raman scattering of ion-implanted GaAs[J].
Applied Physics Letters, 1971, 18 (12) : 574 –576.
DOI: 10.1063/1.1653546 ( 0) 0)
|
| [8] |
Tiong K K, Amirtharaj P M, Pollak F H, et al. Effects of As+ ion implantation on the Raman spectra of GaAs:"Spatial correlation" interpretation[J].
Applied Physics Letters, 1984, 44 (1) : 122 –124.
DOI: 10.1063/1.94541 ( 0) 0)
|
| [9] |
Holtz M, Zallen R, Brafman O, et al. Raman-scattering depth profile of the structure of ion-implanted GaAs[J].
Physical Review B, 1988, 37 (9) : 4609 –4617.
DOI: 10.1103/PhysRevB.37.4609 ( 0) 0)
|
| [10] |
Aspnes D E, Studna A A. Dielectric functions and optical parameters of Si, Ge, GaP, GaAs, GaSb, InP, InAs and InSb from 1.5 to 6.0 eV[J].
Physical Review B, 1983, 27 (2) : 985 –1009.
DOI: 10.1103/PhysRevB.27.985 ( 0) 0)
|
| [11] |
Satoh M, Kuriyama K, Makita Y. Photoluminescence study of the annealing behavior of transmuted impurities in neutron-transmutation-doped semi-insulating GaAs[J].
Journal of Applied Physics, 1989, 65 (6) : 2248 –2253.
DOI: 10.1063/1.342837 ( 0) 0)
|
| [12] |
Xin S H, Schaff W J, Wood C E C, et al. Capped versus capless heat treatment of molecular beam epitaxial GaAs[J].
Applied Physics Letters, 1982, 41 (8) : 742 –744.
DOI: 10.1063/1.93662 ( 0) 0)
|
| [13] |
Bünger T, Behr D, Flade T, et al. Development of a vertical gradient freeze process for low EPD GaAs substrates[J].
Materials Science and Engineering B, 2001, 80 (1) : 5 –9.
DOI: 10.1016/S0921-5107(00)00573-0 ( 0) 0)
|
| [14] |
Ziegler J F, Biersack J P.
Treatise on Heavy-ion science[M]. New York: Springer-Verlag, 1985 : 99 -129.
( 0) 0)
|
| [15] |
赵慧杰, 何世禹, 孙彦铮, 等. 100 keV质子辐照对空间GaAs/Ge太阳电池光电效应的影响[J].
物理学报, 2009, 58 (1) : 404 –410.
DOI: 10.3321/j.issn:1000-3290.2009.01.062 ZHAO Huijie, HE Shiyu, SUN Yanzheng, et al. Effect of 100 keV proton irradiation on photoemission of GaAs/Ge space solar cells[J]. Acta Physica Sinica, 2009, 58 (1) : 404 –410. DOI: 10.3321/j.issn:1000-3290.2009.01.062 (  0) 0)
|
| [16] |
Zallen R, Holtz M, Geissberger A E, et al. Raman-scattering studies of implantation-amorphized gallium arsenide:comparison to sputtered and evaporated a-GaAs films[J].
Journal of Non-Crystalline Solids, 1989, 114 : 795 –797.
DOI: 10.1016/0022-3093(89)90723-0 ( 0) 0)
|
| [17] |
Braunstein G, Tuschel D, Chen S, et al. Raman scattering study of lattice disorder in 1-MeV Si-implanted GaAs[J].
Journal of Applied Physics, 1989, 66 (8) : 3515 –3522.
DOI: 10.1063/1.344108 ( 0) 0)
|
| [18] |
Menzel R, Gärtner K, Wesch W, et al. Damage production in semiconductor materials by a focused Ga+ ion beam[J].
Journal of Applied Physics, 2000, 88 (10) : 5658 –5661.
DOI: 10.1063/1.1319168 ( 0) 0)
|
| [19] |
Jagielski J, Thomé L. Damage accumulation in ion-irradiated ceramics[J].
Vacuum, 2007, 81 (10) : 1352 –1356.
DOI: 10.1016/j.vacuum.2007.01.059 ( 0) 0)
|
| [20] |
Vetrano J S, Bench M W, Robertson I M, et al. In situ studies of ion irradiation effects in an electron microscope[J].
Metallurgical Transactions A, 1989, 20 (12) : 2673 –2680.
DOI: 10.1007/BF02670160 ( 0) 0)
|


