2. 郑州大学 材料科学与工程学院 河南 郑州 450001
2. School of Materials Science and Engineering, Zhengzhou University, Zhengzhou 450001, China
玻璃广泛应用于现代建筑中, 保护我们免受恶劣外部环境的侵害.太阳辐射谱是连续谱, 按不同的波长可分为紫外、可见、红外3个区域, 其能量分布为:紫外波段(< 0.40 μm)约占总能量的7%, 可见光波段(0.40~0.76 μm)约占50%, 红外波段(>0.76 μm)约占43%, 红外波段的能量对采光毫无贡献, 在炎热的夏季反而会增加室内的温度.阳光控制功能镀膜玻璃的主要特点就是对可见光波段具有一定的透过率, 对红外波段具有较高的反射率, 从而保证玻璃既有一定的透光性, 又能够阻碍对采光毫无贡献的红外波段的能量, 降低室内的温度, 从而降低空调等的能耗.
TiN是一种过渡金属氮化物, 具有高硬度、高熔点、高耐蚀性、热稳定性和金黄色等优良性能.所以其薄膜被广泛用作切削工具、强化相、扩散阻挡层、太阳能吸收器、红外反射镜、门电极和装饰涂料[1-9]等.最近的研究表明, TiN薄膜是通过离子键、金属键和共价键结合而成的, 其中氮的p轨道能量低于费米能级, 这导致材料中自由电子的运动类似于金属键的d电子轨道上的运动, 增加了TiN的导电性, 因此TiN薄膜具有类似于金、银等贵金属薄膜的光学性能, 在可见光区半透明, 且在红外区高反射.
国内外的研究者们对TiN薄膜应用于镀膜玻璃进行了广泛的研究.TiN薄膜的结构、光电性能主要依赖于薄膜制备方法及沉积工艺[10].TiN薄膜的制备方法主要有化学气相沉积[1, 4]、射频磁控溅射[10]、脉冲磁控溅射[11]、高能脉冲磁控溅射[8-9]、直流反应磁控溅射[7, 12]等.直流磁控溅射方法具有沉积速度快、工艺容易控制、容易得到符合化学计量比的TiN等优点, 因而被广泛应用于科研和生产中.研究者们使用直流磁控溅射技术对制备TiN薄膜的工艺, 如沉积时间、氮气流量、氩气流量、氮氩比、溅射功率等进行了广泛的研究, 但对于压强在直流磁控溅射中的作用以及压强对TiN薄膜性能的研究却较少.本文使用磁控溅射方法在玻璃衬底上制备了不同压强下的系列TiN薄膜, 研究了压强对其性能的影响.
1 实验 1.1 薄膜的制备本实验采用常熟市虞华真空设备科技有限公司的CS-300多靶磁控溅射镀膜机制备TiN薄膜.靶材采用纯度为99.99%的长方体(180 mm×80 mm×4 mm)金属钛靶.工作气体和反应气体分别为99.999%的高纯氩气和高纯氮气, 沉积工艺如表 1所示.以石英玻璃为衬底材料, 沉积前对玻璃衬底依次用丙酮、无水乙醇和去离子水在超声设备中各超声清洗10 min, 并用吹风机烘干.镀膜前使用氩气进行预溅射, 去掉靶材上的氧化物等杂质.
|
|
表 1 不同反应压强下制备TiN薄膜的工艺参数 Table 1 Processing parameters of TiN thin films prepared under different reaction pressures |
采用UV-3100型紫外-可见光分光光度仪检测样品的光学性能, 波长范围:300~2 500 nm; 使用美国Woollam公司生产的Vase反射式椭圆偏振光谱仪测试薄膜的折射率、消光系数、厚度以及粗糙度, 测试参数如下:入射角70°, 波长范围240~1 100 nm, 扫描步长10 nm, 使用PhilipX′pert D/MAX-2400型X射线衍射仪(XRD)表征薄膜的相结构, 采用广州半导体材料研究所研制的SDY-4型四探针测试仪测量了薄膜的方块电阻.并根据Drude理论, 用公式RIR=(1+0.005 3RS)-2计算薄膜的中远红外反射率[4].
2 结果及分析 2.1 压强对薄膜相结构的影响图 1给出了不同反应压强下制备的TiN薄膜的XRD图.可以看出在衍射角2θ为36.5°、42.4°、61.6°时分别出现TiN的衍射峰, 分别对应TiN的(111)、(200)、(220)晶面, 表明制备的薄膜为立方相的TiN薄膜.(111)具有较高的强度, 因而制备的TiN薄膜具有明显的择优取向.随着反应压强的降低, 薄膜中出现了Ti的衍射峰, 这可能是因为:一方面随着反应室内压强的减小, N2的离化率降低, 导致气氛中Ti离子的数量增多, 其中一部分Ti离子与N生成TiN, 而来不及反应的Ti离子沉积到衬底上, 从而形成Ti; 另一方面, 反应压强降低使得腔室内的气体分子数减少, 导致Ti离子在飞向衬底的过程中, 与其他离子碰撞的几率降低, Ti离子有可能直接到达衬底, 从而在衬底上形成Ti.

|
图 1 不同压强制备的TiN薄膜XRD图 Figure 1 XRD patterns of TiN thin films prepared under different reaction pressures |
使用椭偏光谱仪测量薄膜的厚度.椭圆偏振光谱测量技术依据其测量形式的不同, 可分为反射椭偏测量、透射椭偏测量和散射椭偏测量[13]; 其中反射式椭偏光谱测量应用较广, 是进行薄膜和表面分析的重要工具, 其基本原理如图 2所示[14].用一束椭圆偏振光作探针, 以一定的入射角射到样品上, 由于样品对入射光中p偏振光波和s偏振光波的反射、透射系数不同, 导致反射光的偏振态(振幅和相位)发生改变,
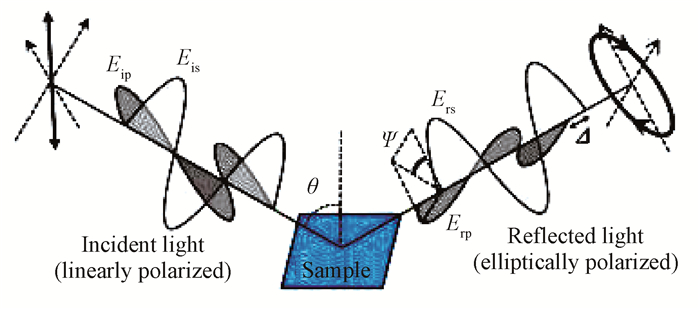
|
图 2 椭圆偏振法测量薄膜材料光学性能的原理示意图 Figure 2 Schematic diagram of optical properties of thin films measured by ellipsometry |
本文使用美国Woollam公司生产的Vase反射式椭圆偏振光谱仪测量薄膜的厚度.测定Ψ和Δ后, 通过系统自带的软件确定模型来拟合薄膜的厚度.拟合分析采用两层光学模型, 底层为玻璃衬底, 把TiN薄膜看作由TiN薄膜体层和表面粗糙层构成.因此, 由下向上依次为薄膜层df和粗糙层ds.其中TiN薄膜体层使用洛伦兹模型.根据椭偏参数Ψ、Δ来求解膜厚和光学常数的椭偏方程为一超越方程, 方程的个数多于待求参数(膜厚、光学常数等)的个数, 所以不能求解析解, 而只能进行数值求解.我们可以根据这个模型计算得到TiN薄膜的ds和df, 采用上述模型, 并进行拟合后的图像如图 3所示, 从图 3中可以看出, 实验曲线与拟合曲线复合得很好.

|
图 3 不同压强下制备的TiN薄膜的椭偏测试曲线和拟合曲线 Figure 3 Experimental curves and fitting curves by ellipsometry of TiN films prepared under different pressures |
由图 3拟合得到的薄膜厚度列于表 2, 可以看出随着压强的增大, 薄膜厚度减小.在溅射过程中, 薄膜的厚度与沉积速率成正比, 而沉积速率与粒子从阴极逸出的速率成正比, 可表示为[15]V=c·j·η, 式中:V是沉积速率; c是溅射装置特性常数; j是离子流; η为溅射系数.
|
|
表 2 不同压强下氮化钛薄膜的厚度和方块电阻 Table 2 Thickness and sheet resistance of TiN films prepared under different pressures |
从表 2可以看出, 随着反应压强的增加, 薄膜的厚度逐渐变小, 这表明单位时间内薄膜的沉积速率下降.这是因为在真空室内电极间的气体分子数与反应压强和靶材与基底间距的乘积成正比, 当靶材与基底间距固定, 即c是定值.反应压强增加使得腔室内的气体分子数增加, 导致Ti离子在飞向衬底的过程中, 与其他离子碰撞的频率增大, 即平均自由程大幅减小, 从而使得Ti离子与其他离子碰撞而散射的几率增大, 能量损失增大, 这就降低了到达衬底的离子流j, 而η与溅射功率和靶材本身的性质有关, 与压强无关.因而, 随压强的增大, c与η不变, 而j变小, 所以薄膜的沉积速率降低, 从而导致薄膜厚度随压强逐渐减少.
2.3 压强对薄膜透射率的影响图 4是不同反应压强下TiN薄膜的透射谱.在温度、功率和时间等其他条件固定不变的情况下, 薄膜的透光率受厚度影响很大.一般情况下, 薄膜越厚, 吸收可见能量越多, 因而透光性越差; 反之, 薄膜越薄, 吸收可见光能量越少, 因而透光性越好.从图中可以看出, 随压强的增大, 薄膜的透射谱发生红移, 透射率逐渐升高, 当压强是1 Pa时, 可见光透射率可以达到75%, 公安部行业标准《汽车车窗玻璃遮阳膜》GA/T744-2013规定, 汽车前风窗玻璃可见光透射比在72%~90%之间, 而目前市场上多数前风窗玻璃贴膜的可见光透射比在50%~75%之间.可见, 本文所制备的薄膜完全可以满足汽车前风窗玻璃贴膜的要求.图 5给出了不同压强下TiN薄膜的消光系数K, 消光系数是一个衡量光在介质中传播时消减程度的物理量, 与介质的吸收系数密切相关.从图 5中可以看出, 在可见光区波段, 随压强增大, 薄膜的消光系数先减小后增大, 即对可见光的吸收先减弱后增强, 这与图 4薄膜在可见光区内的透射率规律相吻合.
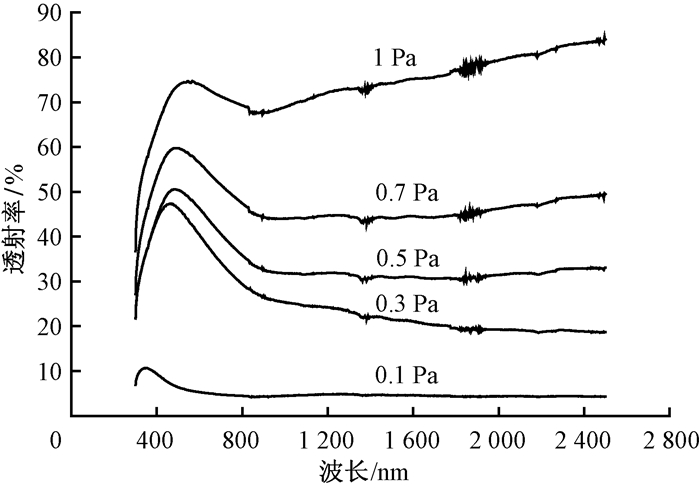
|
图 4 不同压强下TiN薄膜的透射谱 Figure 4 Transmission spectrum of TiN films prepared under different pressure |
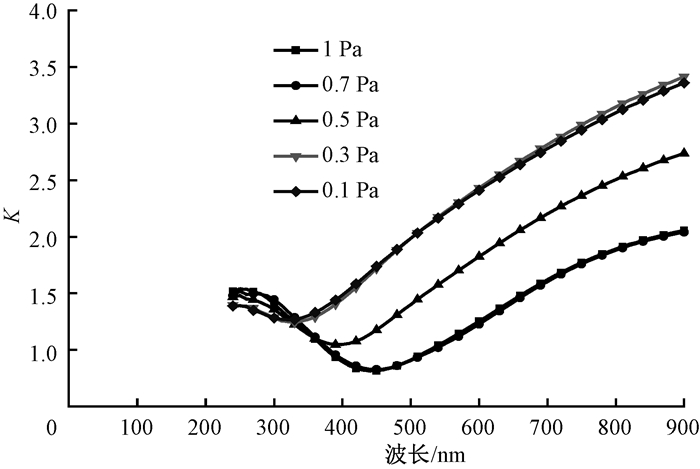
|
图 5 不同压强下TiN薄膜的消光系数 Figure 5 Extinction coefficient of TiN films prepared under different pressure |
图 6为不同反应压强下TiN薄膜的反射谱, 随着反应压强的增加, 薄膜的反射率逐渐降低.反应压强为0.1 Pa时制备的薄膜在近红外区的反射率峰值为78.3%, 当反应气压升到1 Pa时, 峰值降为15.9%.在可见光区内反射曲线有一个极小值, 这和文献[16]报道的结果一致, 此处的极小值一般称为等离子体波长[4], 可以看出随着反应压强的增大, 反射谱的等离子体波长发生红移, 薄膜的反射在等离子体波长处最低, 之后随波长增大, 反射急剧增大, 一直达到峰值, 这与文献报道的结果是一致的.
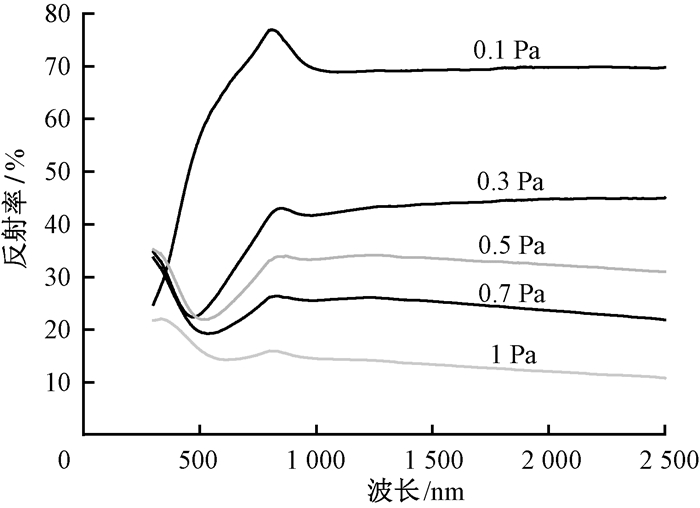
|
图 6 不同压强下氮化钛薄膜的反射谱 Figure 6 Reflection spectrum of TiN films prepared under different pressure |
TiN薄膜的反射率与薄膜的结晶情况及表面粗糙度有关, 表面越光滑, 对入射光的反射越强烈.图 7给出了椭偏模拟的表面粗糙度ds与压强变化的关系, 可见, 随压强的增大, 薄膜表面粗糙度增大.当气压较低时, Ti离子的平均自由程较长, 与其他离子碰撞的几率较小, 到达玻璃衬底时还残留有较大的能量, 因而可以在薄膜表面迁移, 所以生成的薄膜较光滑, 结晶度较好, 因而反射率较大; 反应压强增大时, Ti离子与其他离子碰撞的几率增大, 因而到达衬底时能量较小, 导致生成的薄膜表面粗糙, 结晶度较差, 所以反射率会降低.另一方面, 从图 1中的XRD结果可以看出, 随反应压强的降低, 薄膜中出现了少量的Ti, 这也是压强降低导致反射率增大的原因.
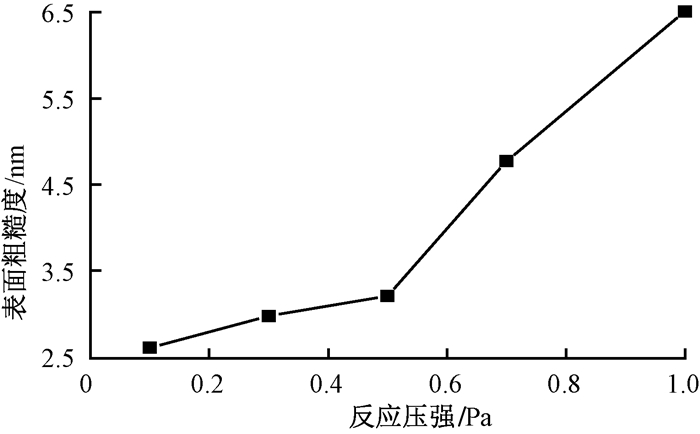
|
图 7 椭偏拟合的TiN薄膜表面粗糙度 Figure 7 Surface roughness of TiN thin film fitted by ellipsometry |
图 6是使用紫外-可见光分光光度仪测试的薄膜在紫外到红外波段的反射谱, 从中也可以看出薄膜在红外波段的反射情况.另外根据Drude理论, 可以用公式RIR=(1+0.005 3Rs)-2来计算薄膜的中远红外反射率[4].Rs表示薄膜的方块电阻, 使用四探针法测量的薄膜方块电阻见表 2.RIR代表薄膜中远红外的反射率, 是薄膜整个红外波段反射率的平均值.图 8给出了TiN薄膜在中远红外波段的反射率, 随着反应压强的增大, 薄膜在红外波段的反射率逐渐减小.磁控溅射制备的薄膜中存在大量的自由电子, 而它们的运动特别类似于金属中电子的运动, 此时的TiN薄膜具有良好的导电性.薄膜电阻率计算公式为[15]ρ=Rs· d, 其中:Rs是薄膜的方块电阻; d是薄膜的厚度.根据表 2所测的数据计算薄膜的电阻率, 结果如图 9所示.可以看出随着反应气体压强的降低, 薄膜的电阻率减小, 反应压强为1 Pa时, 薄膜的电阻率为5.7×10-4 Ω·cm, 反应压强减小到0.1 Pa时, 薄膜的电阻率为1.5×10-4 Ω·cm, 因而随着反应压强的减小, 薄膜的金属性变强, 从而导致薄膜在中远红外波段的反射率增大(图 8).
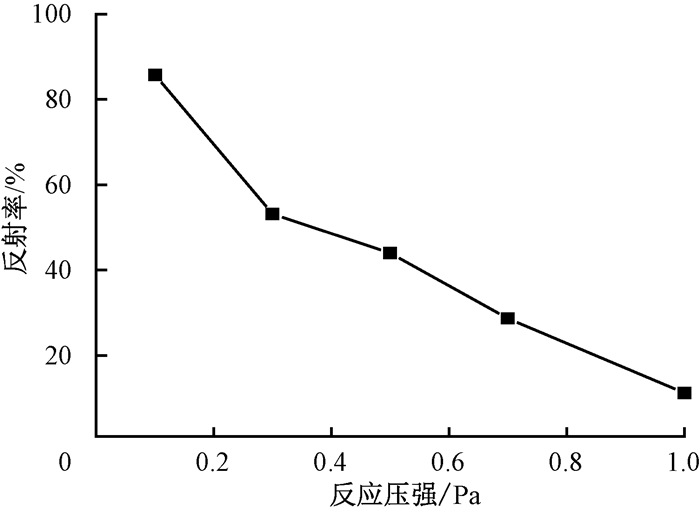
|
图 8 不同压强制备的TiN薄膜红外波段的反射率 Figure 8 Infrared reflectivity of TiN films prepared under different pressure |

|
图 9 不同压强制备的TiN薄膜的电阻率 Figure 9 Sheet resistivity of TiN thin films prepared under different pressure |
本文使用磁控溅射方法制备了不同压强下的TiN薄膜, 并研究了反应压强对TiN薄膜光学性能的影响规律.随着反应压强的升高, TiN薄膜的厚度减小, 方块电阻增大, 中远红外区的反射率降低, 在可见光区的透射率增大, 透射率峰值可达75%.
| [1] |
ZHAO G L, ZHANG T B, ZHANG T, et al. Electrical and optical properties of titanium nitride coatings prepared by atmospheric pressure chemical vapor deposition[J]. J Non-cryst Solids, 2008, 354(12/13): 1272-1275. (  0) 0) |
| [2] |
OLIVEIRA J C, FERNANDES F, SERRA R, et al. On the role of the energetic species in TiN thin film growth by reactive deep oscillation magnetron sputtering in Ar/N2[J]. Thin solid films, 2018, 645: 253-264. DOI:10.1016/j.tsf.2017.10.052 (  0) 0) |
| [3] |
POPOVIC M, NOVAKOVIC M, MITRIC M, et al. Structural, optical, and electrical properties of argon implanted TiN thin films[J]. Int J Refract Met Hard Mater, 2015, 48: 318-323. DOI:10.1016/j.ijrmhm.2014.09.026 (  0) 0) |
| [4] |
LIN X X, ZHAO G L, WU L Q, et al. TiNx thin films for energy-saving application prepared by atmospheric pressure chemical vapor deposition[J]. Journal of alloys and compounds, 2010, 502(1): 195-198. DOI:10.1016/j.jallcom.2010.04.142 (  0) 0) |
| [5] |
SOLIS-POMAR F, NAPOLES O, VAZQUEZ R O, et al. Preparation and characterization of nanostructured titanium nitride thin films at room temperature[J]. Ceramics international, 2016, 42(6): 7571-7575. DOI:10.1016/j.ceramint.2016.01.164 (  0) 0) |
| [6] |
TRIPURA S S, RAMASESHAN R, FEBY J, et al. Investigation of temperature dependent dielectric constant of a sputtered TiN thin film by spectroscopic ellipsometry[J]. Journal of applied physics, 2014, 115(3): 033516. DOI:10.1063/1.4862485 (  0) 0) |
| [7] |
NISHAT A, JUNQING L, YUN K J, et al. Study on structural, morphological and electrical properties of sputtered titanium nitride films under different argon gas flow[J]. Materials chemistry and physics, 2012, 134(2/3): 839-844. (  0) 0) |
| [8] |
LUNDIN D, SARAKINOS K. An introduction to thin film processing using high-power impulse magnetron sputtering discharge[J]. Journal of materials research, 2012, 27(5): 780-792. DOI:10.1557/jmr.2012.8 (  0) 0) |
| [9] |
SAMUELSSON M, LUNDIN D, JENSEN J, et al. On the film density using high power impulse magnetron sputtering[J]. Surf Coat Tech, 2010, 205(2): 591-596. DOI:10.1016/j.surfcoat.2010.07.041 (  0) 0) |
| [10] |
VASU K, GHANASHYAM K M, PADMANABHAN K A. Substrate-temperature dependent structure and composition variations in RF magnetron sputtered titanium nitride thin films[J]. Appl Surf Sci, 2011, 257(7): 3069-3074. DOI:10.1016/j.apsusc.2010.10.118 (  0) 0) |
| [11] |
JITHIN M A, KOLLA L G, NAGA V R V, et al. Pulsed DC magnetron sputtered titanium nitride thin films for localized heating applications in MEMS devices[J]. Sensor Actuat A-Phys, 2018, 272: 199-205. DOI:10.1016/j.sna.2017.12.066 (  0) 0) |
| [12] |
KAVITHA A, KANNAN R, GUNASEKHAR K R, et al. Effect of nitrogen content on physical and chemistry properties of TiN thin films prepared by DC magnetron sputtering with supported discharge[J]. Journal of electron mater, 2017, 46(10): 5773-5780. DOI:10.1007/s11664-017-5608-4 (  0) 0) |
| [13] |
王卫.光学薄膜的椭圆偏振模型分析与数据处理研究[D].南京: 南京理工大学, 2006. http://www.wanfangdata.com.cn/details/detail.do?_type=degree&id=Y1001317
(  0) 0) |
| [14] |
FUMIYOSHI H, HIROKO T, SHIN-ICHI O. Dielectric and optical constants of λ-Ti3O5 films measured by spectroscopic ellipsometry[J]. Mater Lett, 2016, 188: 8-12. (  0) 0) |
| [15] |
朱秀榕.氮化钛薄膜的制备及其光、电性能的研究[D].江西: 南昌大学, 2008. http://cdmd.cnki.com.cn/Article/CDMD-11902-2009242882.htm
(  0) 0) |
| [16] |
LOUSA A, ESTEVE J, PMEJIA J, et al. Influence of deposition pressure on the structural mechanical and decorative properties of TiN thin films deposited by cathodic arc evaporation[J]. Vacuum, 2007, 81(11/12): 1507-1510. (  0) 0) |
 2018, Vol. 50
2018, Vol. 50

