2. 陕西省计量科学研究院, 西安 710065;
3. 西北核技术研究所, 西安 710024;
4. 西安交通大学机械制造系统工程国家重点实验室, 微纳制造与测试技术国际合作联合实验室, 苏州纳米科技协同创新中心, 西安 710049
2. Shaanxi Institute of Metrology Science, Xi'an 710065, China;
3. Northwest Institute of Nuclear Technology, Xi'an 710024, China;
4. State Key Laboratory for Manufacturing Systems Engineering, International Joint Laboratory for Micro/Nano Manufacturing and Measurement Technologies, Collaborative Innovation Center of Suzhou Nano Science and Technology, Xi'an Jiaotong University, Xi'an 710049, China
传感器技术作为代表当今科学技术发展水平的重要标志,与计算机技术、通信技术一起构成了现代信息产业的三大支柱[1]。在众多信号测量中,对压力信号进行可靠、稳定、准确地测量具有十分广泛的需求和重要的意义。目前在诸如常温、低频压力信号等一般工况下工作的压力传感器已得到充分发展并较容易获得。
随着科学技术与现代工业的发展,广泛存在高温、高频等极端条件下的压力测量需求,特别是在航空航天、军工、石油化工和汽车电子等领域,对于火箭、导弹及卫星等耐热腔体、发动机腔体以及火炮炮管等条件下的压力测量,经常要面对超过200℃的高温环境与超过1000℃的瞬时高温冲击,常规非耐高温传感器的性能会严重恶化甚至失效[2],远不能满足压力测量要求。目前,基于电阻效应原理的高温压力传感器主要有基于SOI (Silicon on Insulator,硅隔离)、SOS (Silicon on Sapphire,硅-兰宝石) 和溅射膜技术3种,但是由于基于SOS和溅射膜技术的高温压力传感器,其弹性元件通常由金属材料制成,传感器的稳定性会随使用时间而大大下降,原因在于金属材料所具有的蠕变特性,以及弹性元件和敏感元件各具不同的热膨胀系数。而对于如爆炸实验技术研究等领域需要捕捉在起爆、爆炸和冲击等快速反应过程的高频动态压力信息,动态压力信号的上升时间仅为毫秒至纳秒级,还需考虑基波、一次谐波和高次谐波等对测试结果的影响[3],这就要求传感器具有优良的动态响应特性,而且这些信号频谱十分复杂,有时甚至会激发传感器发生谐振,造成信号输出的极大误差。
以美国Kulite和Endevco以及瑞士Kistler公司为代表的国外公司已经研发出了性能优良的耐高温高频响压力传感器。如Kulite的XTL-76A-312(M) 系列中采用SOI技术和无引线封装技术研制的小型IS®压力传感器[4],该传感器外径为10.9 mm,最大量程为21MPa,最高使用温度为204℃,固有频率可达1.6MHz。又如,Endevco公司型号为Model 8540-500的压阻式传感器的外径仅为9.52mm,其最高使用温度为260℃,最大量程为3.5MPa,固有频率典型值为900kHz[4]。国内压阻式动态压力传感器研究始于20世纪80年代,经过30多年发展,目前较成熟的产品如CYG401,其最大量程可达100MPa,激波标定固有频率为400~800kHz,上升时间0.2~0.5μs,精度为0.2% ~0.5%FS,可耐1000℃以上瞬态高温,持续时间达100~200ms[5]。昆山双桥传感器测控技术有限公司研发的高温高频传感器量程为0~60MPa,温度上限为200℃,固有频率为0~800kHz,上升时间达0.2μs[6]。
由于耐高温动态压力传感器的应用场合大多和航空航天、军工等国防领域相关,国外相关文献和技术资料对国内不公开。因而,自主研发耐高温动态压力传感器具有十分重大的科研价值和国防意义。针对以上应用需求,本文对倒杯式耐高温动态压力传感器进行研究,压力传感器的芯片采用SOI与MEMS (Micro Electro-Mechanical Systems,微机械电子系统) 工艺进行设计制造,其量程为25MPa,并对该传感器性能进行实验与不确定度分析。
1 SOI倒杯式耐高温压阻力敏芯片单晶硅的机械力学性能十分优良,并具有显著的压阻效应,其弹性模量为130~167GPa,断裂强度约为3GPa,没有滞后和蠕变,本征固有频率可达MHz以上,非常适合制作高频响力敏元件。利用 (100) 晶面SOI硅材料的优良力学和电学特性[7-8],采用MEMS技术制作了尺寸为5mm×5mm×0.4mm的倒杯式耐高温压阻力敏芯片[9],可实现25MPa压力的测量,版图结构如图 1所示,有效薄膜变形区域直径为2mm,力敏芯片外侧为固支边界。压敏电阻条R1、R2、R3、R4的有效长度均沿着[011]或[011]晶向,充分利用最大的压阻系数来提高传感器的灵敏度。为了近一步提高传感器的敏感度,4个压敏电阻条R1~R4设计为三折结构,并置于有效膜边缘的中心位置,有效利用纵向应力和横向应力的最大差值。根据压阻效应,具有相同初始阻值的4个压敏电阻条组成如图 2所示的惠斯通全桥检测电路,当压阻力敏芯片用恒定的电流或电压供电时,惠斯通全桥输出的毫伏信号与被测压力p成比例关系。

|
| 图 1 力敏芯片版图结构示意图 Fig.1 Schematic of pressure sensitive chip |
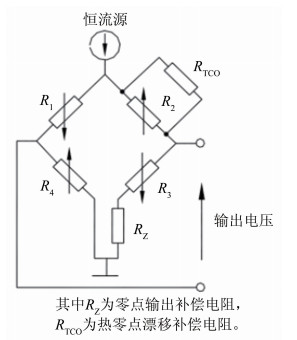
|
| 图 2 惠斯通全桥测量电路 Fig.2 Wheatstone full bridge detection circuit |
根据单晶硅压阻效应的基本原理可知,当被测压力p作用在传感器力敏芯片上时,就会产生相应的应力应变,基于压阻效应,4个压敏电阻条的阻值变化率可由下列公式计算得到[10-11]:
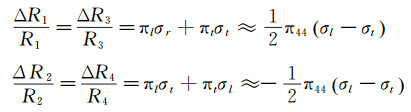 (1)
(1)
式中:πl、πt分别代表纵向和横向压阻系数;π44为剪切压阻系数;σl、σt分别代表力敏芯片上压敏电阻条处的纵向和横向压力,它们与压力p成比例。当电桥采用值为i的恒流源进行激励时,则电桥的输出电压为:
 (2)
(2)
式中:R为4个压敏电阻条的初始阻值。
SOI倒杯式耐高温压阻力敏芯片的主要制作工艺流程[12-15]如图 3所示。

|
| 图 3 力敏芯片主要制作流程 Fig.3 Production process of pressure sensitive chip |
力敏芯片的主要制作流程简述如下:
(1) 力敏芯片的原始材料是采用SIMOX (Separation by Implantation of Oxygen,氧离子注入隔离) 技术制成的n型 (100) 双面抛光单晶SOI硅材料,其顶部为200nm厚的Si层以及400nm厚的埋层SiO2层,为满足压敏效应的要求,顶层Si经外延至3~5μm厚度,如图 3(a)和(b)所示。
(2) 为抑制离子注入产生的沟道效应并提高离子注入的均匀性,用热氧化工艺制作50nm厚氧化硅。由于p型硅的压阻系数高,且其压阻系数的温度系数低,因而为制造p型压敏电阻,需从B2O3恒定源向顶部Si层注入并扩散B,得到顶层硅硼离子浓度为2×1020/cm3,然后在氮气、1100℃温度下进行退火处理30min,目的是消除一些晶格缺陷并改善顶层硅的导电能力,如图 3(c)所示。
(3) 利用RIE (Reactive Ion Etching,等离子刻蚀) 工艺制造出4个力敏电阻条。4个压阻力敏电阻条均采用三折结构,电阻条宽度为12.5mm,有效总长为750mm,方块电阻为20Ω/□。压敏电阻条制造为浮雕型,并通过埋层SiO2层与硅基底隔离,从而使该传感器芯片在250℃以上可靠工作,且不会有漏电流产生而恶化传感器的稳定性,如图 3(d)所示。
(4) 在1100℃、O2环境下氧化30min,在顶部Si层上形成SiO2层,再采用LPCVD (Low Pressure Chemical Vapor Deposition,低压气相沉积) 技术在SiO2上形成Si3N4层,目的是减小因热膨胀系数差异而产生的热应力失配。SiO2层和Si3N4层也作为刻蚀阻挡层,如图 3(e)所示。
(5) 光刻形成引线孔后,为使力敏芯片可以在温度超过250℃的环境下正常工作,采用溅射技术依次制作Ti-Pt-Au多金属引线层,经光刻和刻蚀工艺,形成梁式引线将4个压敏电阻条连接成半开环惠斯通全桥。在550℃下的真空环境中保持30min进行欧姆连接和金属化的热处理,以形成良好的欧姆接触,如图 3(f)和(g)所示。
(6) 最后,根据力敏芯片的设计量程,对整个晶圆进行减薄、抛光,如图 3(h)所示,再划片形成单个力敏芯片,图 4为压阻力敏芯片的SEM照片。
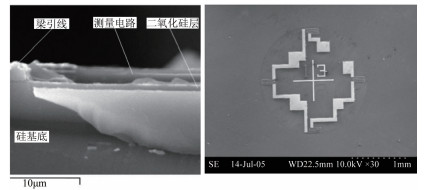
|
| 图 4 力敏芯片的截面和表面形貌 Fig.4 Cross section and surface topography of the pressure sensitive chip |
图 5为耐高温动态压阻式压力传感器的机械封装结构示意图。SOI倒杯式耐高温压阻力敏芯片6通过静电键合工艺封装到玻璃环5上,再通过如玻璃粉烧结等高温封装工艺装配到齐平式基座3上[16]。该种机械封装结构使被测介质与力敏芯片6直接接触,减少管腔效应的影响,从而提高传感器的动态特性,保证传感器的固有频率接近于力敏芯片6的本征固有频率。金丝7通过热压焊工艺将力敏芯片6的焊盘与聚乙烯转接板4进行焊接,之后从转接板4上引出高温电缆线8,并用锁线帽将其固定。传感器实物照片如图 6所示。
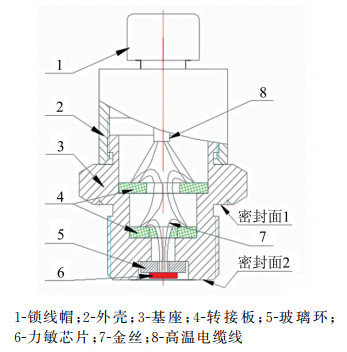
|
| 图 5 传感器结构示意图 Fig.5 Mechanical schematic of the sensor structure |

|
| 图 6 传感器实物 (不含外壳) Fig.6 Sensor photo (without shell) |
对所研制的耐高温动态压阻式压力传感器进行静态标定实验,得到传感器的静态性能指标。首先,将传感器安装到一根引压管上,安装有传感器的引压管一端通过测试口伸入到无锡锦华试验设备有限公司生产的GDJ-225型高低温实验箱内腔中,为传感器提供250℃高温环境,引压管的另一端安装到陕西创威科技有限公司的CW-600T型活塞压力计上,测量范围为1~60MPa,准确度等级为0.02级。根据JJG 860-2015《压力传感器 (静态) 检验规程》进行校准,由KEITHLEY 2612A精密源表给传感器提供5mA的恒定电流,由Fluke45数字万用表记录传感器的输出电压信号,如表 1所示,经最小二乘拟合得到如图 7所示的静态性能[1]输入输出曲线。
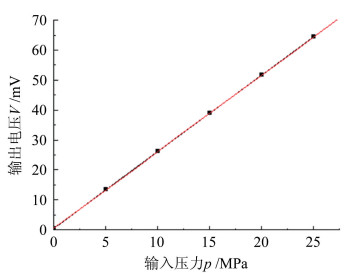
|
| 图 7 静态性能输入输出曲线 Fig.7 Input-output fitting curve of static performance |
| 压力/MPa | 输出信号/mV | |||||||
| 第1次 | 第2次 | 第3次 | 平均值 | |||||
| 正行程 | 反行程 | 正行程 | 反行程 | 正行程 | 反行程 | 正行程 | 反行程 | |
| 0 | 0.58 | 0.59 | 0.59 | 0.58 | 0.59 | 0.58 | 0.587 | 0.583 |
| 5 | 13.45 | 13.43 | 13.44 | 13.44 | 13.43 | 13.45 | 13.440 | 13.440 |
| 10 | 26.17 | 26.15 | 26.16 | 26.15 | 26.15 | 26.15 | 26.160 | 26.150 |
| 15 | 38.92 | 38.92 | 38.93 | 38.93 | 38.92 | 38.92 | 38.923 | 38.923 |
| 20 | 51.67 | 51.65 | 51.67 | 51.65 | 51.66 | 51.67 | 51.667 | 51.657 |
| 25 | 64.45 | 64.46 | 64.45 | 64.47 | 64.46 | 64.46 | 64.453 | 64.463 |
计算得到传感器在高温下的线性误差δL=0.081%FS (Full Scale,满量程),重复性误差δR=0.03%FS,迟滞误差δH=0.03%FS,基本误差δ=±0.114%FS。
根据JJF 1059.1-2012《测量不确定度评定与表示》,对所研制的耐高温动态压力传感器进行不确定分析[17-18]:
(1) 测量重复性引入的不确定度分量u1
按规程要求,测量点不少于6个,每个测量点均有6个读数,根据贝塞尔公式计算出平均值的标准差,则测量重复性引入的不确定度分量u1由公式 (3) 进行计算。
 (3)
(3)
式中:Vi为不同压力点的电压输出值,V为电压输出平均值,n为测量次数。
经计算求得在压力为20MPa时,引入的最大不确定分量u(V1) 为0.004014mV,且属于A类不确定度,可信度为90%,其自由度ν1=50。
(2) 活塞式压力计引入的不确定度分量u2
活塞式压力计的测量范围为1~60MPa,扩展不确定度U=0.02%,k=2,则由活塞式压力计引入的不确定度u2为:
 (4)
(4)
(3) 标准和被检测参考位置高度差引入的不确定度分量u3
在检测之前,已经调整了标准活塞压力计和压力传感器之间的相互位置,使二者的压力参考平面基本位于同一水平面上,假设参考位置高度差测量误差为2cm,其引起的误差为ρgh,属于均匀分布,取包含因子
 (5)
(5)
其中,检定时传压介质为葵二酸二异辛酯,其密度为913kg/m3。
(4) 数字多用表示值误差引入的不确定度分量u4
数字多用表 (直流电压档200mV) 最大允许误差为±0.002%FS,按均匀分布处理,则u4为:
 (6)
(6)
(5) 供电电源稳定度引入的不确定度分量u5
精密源表在10mA内的稳定度为6μA,实际给传感器供电为5mA,传感器内阻约为1.2kΩ,按均匀分布处理,则u5为:
 (7)
(7)
(6) 环境偏离参考温度引入的不确定度分量u6
数字多用表、稳压电源均在 (20±1)℃范围内进行了温度补偿和修正,因此,环境温度影响可忽略。由环境偏离参考温度引入的不确定度u6为:
 (8)
(8)
以上u2~u6都属于B类不确定度,可信度均为100%,故其自由度均为∞。
各不确定度分量彼此独立,其合成标准不确定度uc为:
 (9)
(9)
合成标准不确定度的自由度ν为:
 (10)
(10)
根据置信概率P=95%,查t分布表得t0.95(50)=2.01。
k取2.01,得到扩展不确定度U:
 (11)
(11)
不确定度报告:传感器在重复性相对最差的检定点20MPa处,得到扩展不确定度U=0.01794mV,是由合成标准不确定度uc=0.008925mV及包含因子2.01确定,对应的置信概率P=95%,自由度为50。
3.2 零点漂移、热零点漂移和热灵敏度漂移零点漂移是指在规定的温度和时间内,在标准电源供电条件下,传感器零点输出的变化情况,零点漂移D的计算公式为:
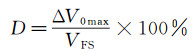 (12)
(12)
采用恒流源5mA供电,对传感器在高温250℃条件下的零点漂移特性进行测量,测量时间间隔为30min,共测量3个小时,零点输出分布曲线如图 8所示。
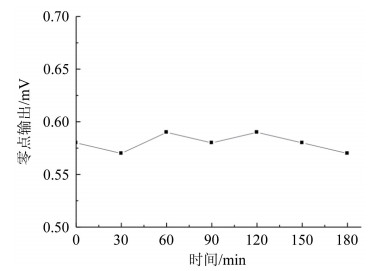
|
| 图 8 零点漂移曲线 Fig.8 Zero drift curve |
由于力敏电阻条的掺杂浓度不一致,导致力敏电阻条的温度系数也不一致,因此传感器的零点输出与温度密切相关。当温度在传感器许用使用温度范围内变化时,传感器的零点输出也发生变化,这种现象称为热零点漂移。热零点漂移k0是衡量压力传感器质量的一个重要的性能指标,其计算公式为:
 (13)
(13)
式中:VFS(T1) 为室温下的满量程输时出电压;V0(T2) 为温度T2下的零点输出电压;V0(T1) 为室温T1下的零点输出电压。
对25MPa的耐高温动态压力传感器进行热零点漂移的试验,在恒流源5mA供电下,记录经过补偿的传感器在室温T1=22℃时的零点和满量程输出分别为:V0(T1)=-1.1516mV,VFS(T1)=61.682mV,根据表 1中的数据可知传感器在温度T2=250℃时的零点和满量程输出分别为:V0(T2)=0.585mV,VFS(T2) =63.8733mV,再根据式 (13) 计算得:k0=0.012%FS/℃。
压力灵敏度S和满量程输出VFS都随着温度的变化而变化。这是因为压力灵敏度与压阻系数成正比,压阻系数随着温度变化而变化。此外,力敏电阻条与表面SiO2、钝化层Si3N4热膨胀系数的差别等造成热应力以及封装产生的热应力,也会产生附加的压阻效应。因此,热灵敏度漂移ks也是衡量压力传感器稳定性的一个重要指标,计算公式如下:
 (14)
(14)
因此,根据式 (14) 计算得出热灵敏度漂移ks=0.016%FS/℃。
3.3 动态性能为了获得传感器的动态性能,首要问题是要有频带能充分覆盖被校压力传感器模态的动态激励信号发生器,将被校传感器系统的主要模态激发出来。在阶跃压力发生器中,激波管能产生一个前沿非常陡的阶跃压力,其上升沿小于0.1μs、平台保持时间大于5ms,是压力传感器动态校准的理想激励信号。用激波管标定压力传感器的动态性能是目前最常用的方法。它具有3大特点:(1) 压力幅度范围宽,便于改变压力值;(2) 频率范围广 (2kHz~2.5MHz);(3) 便于分析研究和数据处理。此外,激波管结构简单,使用方法可靠。因此,采用激波管方式对耐高温动态压力传感器进行了动态性能分析[1]。被测传感器安装在激波管低压腔端面的法兰盘上,用真空硅脂填满传感器端面与法兰盘的缝隙,以免影响激波波形的质量。激波管的破膜冲击压力为2~5MPa,传感器输出信号经IWATSU DA-2B型高增益放大器放大后,由TDS5054型数字示波器记录得到如图 9所示的动态响应曲线,从图中计算出传感器的响应时间约为800ns,响应频率约为555.6kHz。

|
| 图 9 动态响应曲线 Fig.9 Dynamic response curves |
本文采用MEMS技术制作出了耐高温动态压力传感器,其敏感元件为SOI倒杯式耐高温压阻力敏芯片,在机械封装结构上采用了齐平式设计,避免了管腔效应对传感器动态性能的衰减。实验分析了传感器在250℃高温下的静态特性和频响特性。根据实验数据得到传感器的静态基本误差为±0.114%FS,不确定度为0.01794mV,热零点漂移和热灵敏度漂移分别为0.012%FS/℃和0.016%FS/℃,传感器的动态响应频率为555.6kHz,响应时间约为800ns,实验结果表明所研制的耐高温动态压力传感器能够满足航天航空、石油化工和军工等领域的动态压力测量需求。
| [1] | 李科杰. 新编传感器技术手册[M]. 北京: 国防工业出版社, 2002: 1-5, 56-96, 1046-1062. Li K J. New sensor technology manual[M]. Beijing:National Defense Industry Press, 2002:1-5, 56-96, 1046-1062. |
| [2] | 何洪涛, 王伟忠, 杜少博, 等. 一种新型MEMS压阻式SiC高温压力传感器[J]. 微纳电子技术, 2015, 52(4): 233–239. He H T, Wang W Z, Du S B, et al. A novel MEMS piezoresistivity Sic high temperature pressure sensor[J]. Microelectronics & Electron Technology, 2015, 52(4): 233–239. |
| [3] | 郭宏, 王冰, 庄家局, 等. 压阻式高频动态高压传感器设计与冲击波超压测量[J]. 仪表技术与传感器, 2008, 9: 1–2. Guo H, Wang B, Zhuang J J, et al. Silicon piezoresistive high frequency dynamic high pressure sensor and measurement of shock wave superpressure[J]. Instrumentation Technology and Sensor, 2008, 9: 1–2. DOI:10.3969/j.issn.1002-1841.2008.01.001 |
| [4] | 赵立波, 赵玉龙, 李建波, 等. 倒杯式耐高温高频响压阻式压力传感器[J]. 西安交通大学学报, 2010, 44(7): 50–54. Zhao L B, Zhao Y L, Li J B, et al. Inverted-cup high-temperature and high-frequency piezoresistive pressure sensor[J]. Journal of Xi'an Jiaotong University, 2010, 44(7): 50–54. DOI:10.7652/xjtuxb201007012 |
| [5] | 周峰, 孙晋玲, 郭鹏. 单晶硅动态压力传感器的研究[C]. 中国空气动力学会测控专业委员会六届四次空气动力测控技术交流会, 2013. Zhou F, Sun J L, Guo P. Research of monocrystalline silicon dynamic pressure sensor[C]. China Aerodynamics Society of the Fourth Professional Committee of the Fourth Aerodynamic Monitoring And Control Technology Exchange, 2013. |
| [6] | 王文襄, 王晋林, 李水霞, 等. 几种高温高频压力传感器的研制与开发[J]. 测试技术学报, 2002, 16(zl): 413–416. Wang W X, Wang J L, Li S X, et al. Research and development of several high temperature and high frequency pressure sensors[J]. Journal of Test and Measurement Technology, 2002, 16(zl): 413–416. |
| [7] | Julian B. SIMOX (Separation by Implantation Oxygen), encyclopedia of physical science and technology[M]. Encyclopedia of Physical Science and Technology, 2001, 14:805-813. |
| [8] | Michel B, Bernard A, Andre-Jacques Auberton-Hervé. Smart-cut:a new silicon on insulator material technology based on hydrogen implantation and wafer bonding[J]. Jounal of Applied Physics, 1997, 36: 1636–1641. |
| [9] | Zhao Y L, Zhao L B, Jiang Z D. High temperature and frequency pressure sensor based on silicon-on-insulator layers[J]. Measurement Science and Technology, 2006, 17: 519–523. DOI:10.1088/0957-0233/17/3/S11 |
| [10] | Nisanth A, Suja K J, Komaragiri R. Performance analysis of a silicon piezoresistive pressure sensor based on diaphragm geometry and piezoresistor dimensions[C]. International Conference on Circuit, Power and Computing Technologies, IEEE, 2015:55-67. |
| [11] | Bao M H. Micro mechanical transducers:pressure sensors, accelerometers and gyroscopes[M]. Amsterdam: Elsevier, 2000. |
| [12] | Zhao Y L, Zhao L B, Jiang Z D. A novel high temperature pressure sensor on the basis of SOI layers[J]. Sensors and Actuators A:Physical, 2003, 108: 108–111. DOI:10.1016/j.sna.2003.07.011 |
| [13] | Niu Z, Zhao Y, Tian B. Design optimization of high pressure and high temperature piezoresistive pressure sensor for high sensitivity[J]. Review of Scientific Instruments, 2014, 85(1): 015001. DOI:10.1063/1.4856455 |
| [14] | Hao X, Jiang Y, Takao H, et al. An annular mechanical temperature compensation structure for gas-sealed capacitive pressure sensor[J]. Sensors, 2012, 12(6): 8026–38. |
| [15] | Kumar S S, Pant B D. Effect of piezoresistor configuration on output characteristics of piezoresistive pressure sensor:an experimental study[J]. Microsystem Technologies, 2016, 22(4): 709–719. DOI:10.1007/s00542-015-2451-5 |
| [16] | Integrate Circuit Edit Committee of China. Integrate circuit package[M]. Beijing: National Defence Industry Press, 1993: 193-269. |
| [17] | 中国计量测试学会压力专业委员会. 压力测量不确定度评定[M]. 北京: 中国计量出版社, 2006: 166-210. China Society of Metrology and Measurement Pressure Professional Committee. Pressure measurement uncertainty[M]. Beijing: China Metrology Publishing House, 2006: 166-210. |
| [18] | 张有康, 甘蓉. 压力传感器测量中不确定度的评定[J]. 中国测试技术, 2005, 31(6): 25–26. Zhang Y K, Gan R. Evaluation of strain gauge measurement uncertainty of pressure transducer[J]. China Measurement Technology, 2005, 31(6): 25–26. |



