2. 西安交通大学机械制造系统工程国家重点实验室, 西安 710054
2. State Key Laboratory for Manufacturing Systems Engineering, Xi'an Jiaotong University, Xi'an 710054, China
流量是工业检测重要参数之一,在制造业、物理化学、生命科学及国防安全中均是需要重点检测的物理量[1-3]。流量传感器的发展具有悠久的历史。自20世纪50年代以来,随着微机械电子系统 (MEMS) 的兴起和发展,使得流量传感器的研究方向朝着小型化、高精度和智能化的方向发展[4-6]。
国内外学者针对基于MEMS技术的流量传感器展开了广泛研究,最常见的是基于传热学原理的热式微型流量传感器[7-8]。MEMS热式流量传感器具有较宽的测量范围,较高的灵敏度,低的流量测量下限,以及较好的工艺可控性等。热式流量传感器经过近40年发展,已经占据了流量测量的主流市场。然而,热式流量传感器也有着其固有缺点,如衬底热传导导致的测量误差、功耗较大、容易发生零漂以及响应时间过长等。此外,当流体处于运动状态时,传感器热导率可能增加,从而带来较大的测量误差。
非热式流量传感器可以较好地克服以上缺点,具有零点漂移小、功耗低、检测电路简单、测量方式多样和响应时间短等优点。非热式流量传感器逐渐成为近年来的研究热点,现有典型的非热式流量传感器结构有悬臂梁式、曲梁式和平膜式等。直梁结构的代表是由Ozaki等制作的压差式流量传感器[9]。该传感器用于测试水流流量,其量程为0.2~1m/s,灵敏度31.45mV/(ms-1)2,非线性0.8254%FS。曲梁结构的代表是由Yu-Hsiang Wang等制作的流量传感器[10]。该传感器用于气流测试,但灵敏度和精度较低。其主要优点是可以实现气流二维流向的辨别,量程为15~30m/s,灵敏度0.1048mV/(ms-1)2,非线性1.3521%FS。平膜结构的代表是由Richter等在压力传感器膜片中央刻蚀一个小孔制作而成的一种压差式流量传感器[11]。该传感器水流测试灵敏度为40.4mV/(ms-1)2,其文中并未报道测量下限。以上各类传感器灵敏度和精度均有提升空间,且无法同时实现气流测试和水流测试。
本文采用MEMS技术,提出一种具有梁膜结构的压差式流量传感器,以解决现有非热式流量传感器灵敏度低、测量精度差等问题。
1 传感器结构设计及工作原理目前常见的MEMS压差式流量传感器敏感单元结构主要有悬臂梁式、平膜式和曲梁式等。这些结构都是利用压阻效应,在梁或膜的应力集中部位制作压敏电阻,以达到对流量信号的测量目的。综合考虑测量精度、灵敏度及加工精度等方面的因素,本传感器弹性单元采用梁膜结合的四梁传感器结构,由中央膜片、敏感梁和硅支撑体3部分组成,其结构如图 1所示。传感器芯片整体尺寸为2.5mm×2.5mm×0.25mm。
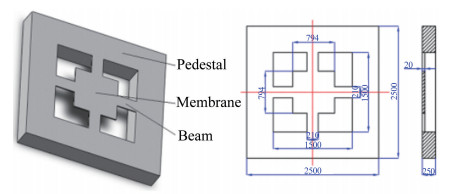
|
| 图 1 传感器芯片结构 (单位:mm) Fig.1 Structure of the sensor chip (unit: mm) |
中央膜片直接受到运动流体的冲击作用,应力通过中央膜片传递到敏感梁上,在敏感梁根部产生应力集中,在此布置压敏电阻可提高传感器的灵敏度。硅支撑体主要用于封装过程中与传感器壳体键合。在4个敏感梁靠近硅支撑体一端各设计有1个压敏电阻,4个压敏电阻组成惠斯通全桥电路,如图 2所示。
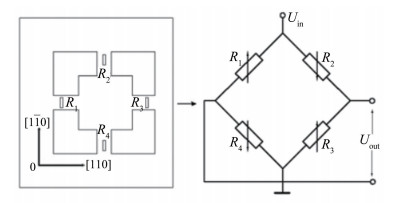
|
| 图 2 压敏电阻位置及惠斯通电桥 Fig.2 Wheatstone bridge |
当传感器受到一定速度的流体冲击作用时,在中央膜片的上下表面会产生压力差Δp,在Δp的作用下敏感梁发生变形,使得压敏电阻阻值发生变化,从而惠斯通电桥输出一个电压U0。
当流体作用于传感器时,所产生的压力差Δp可表示为[12]:
 (1)
(1)
式中:Δp为中央膜片上下表面的压力差;CD为与传感器结构相关的系数,当传感器结构确定之后,其值为一常量;ρ为流体密度;V为流体速度。
在Δp的作用下惠斯通电桥输出电压U0可表示为[13]:
 (2)
(2)
式中:U为惠斯通电桥输入电压;K0为材料的应变系数;E为材料弹性模量;l、b、h分别为敏感梁的长、宽、厚;ACH为流体通道面积;AM为中央膜片面积。以上参数均为常量。
式 (2) 表明,惠斯通电桥输出电压与流体速度的平方成正比关系。通过标定试验,可以得到惠斯通电桥输出电压与流体速度的关系式,从而将流量信号转换为电信号,实现流量的测量。
2 传感器芯片微加工与封装 2.1 传感器芯片的微加工本传感器需要采用离子注入、光刻、ICP刻蚀、金属引线溅射等工艺来完成敏感电阻、敏感梁及中央膜片的制作,每个工艺流程都需要制作不同的掩模版来完成[14-16]。因此,针对性地设计了用于形成敏感电阻的电阻版 (M1),用于形成电阻与导线连接的欧姆接触版 (M2),用于形成金属引线及焊盘的引线版 (M3),用于实现硅片减薄形成薄膜结构的背腔版 (M4),用于释放敏感梁形成梁膜结构的正面穿透版 (M5)。此外,由于传感器应用环境要求,还设计了保护传感器芯片的氧化膜版 (M6),以增加传感器芯片密封性。传感器芯片的微加工工艺流程如图 3所示。
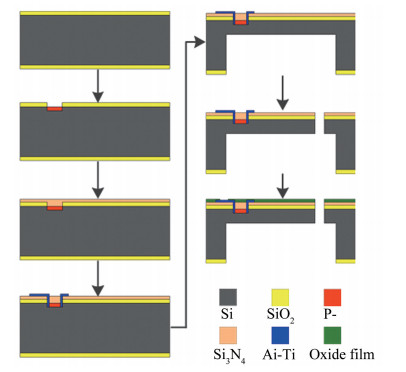
|
| 图 3 芯片微加工工艺流程 Fig.3 Process flow of the sensor chip |
(1) 选用厚度为250μm的n型双面抛光4寸 (100) 晶面硅片加工传感器芯片,电阻率为10Ω·cm,使用HF溶液清洗硅片去除氧化层。
(2) 对n型硅片采用双面高温氧化法来获得SiO2电绝缘层,同时,表面微加工时硅的牺牲层掩膜也可以使用该SiO2层。
(3) 光刻硅片正面,形成压敏电阻条形状,然后将暴露出的氧化层采用湿法腐蚀及反应离子刻蚀去除,并进行硼离子扩散,从而获得p型掺杂的压敏电阻,其中注入能量80keV,注入剂量3×1014cm-2。
(4) 光刻引线孔,将引线孔上的SiO2刻蚀掉,为了降低金属引线与电阻之间的接触电阻,通过Pt合金化来形成引线孔。Pt覆盖层为100nm,p型硅与PtSi合金的接触电阻为0.02Ω。
(5) 光刻引线,通过溅射分别生成厚150、300和1500Å的Ti-Pt-Au膜;通过光刻技术得到光致抗蚀剂掩膜,采用Ti作为与电阻条接触金属,为采用Pt作为中间的阻挡层扩散金属,采用Au作为外界金属层,从而实现金丝与电阻条间的电气连接。然后通过湿法腐蚀金属层,获得电极引线;光刻电极工艺后,进行金属化处理[17]。
(6) 背腔刻蚀。利用背腔版M4对硅片背面进行ICP刻蚀[18],刻蚀深度230μm,形成厚20μm的膜片。
(7) 正面穿透刻蚀。采用正面穿透版M5在硅片正面进行光刻,得到梁膜结构的外形,剩余硅膜采用ICP继续刻蚀,释放敏感结构。
(8) 涂覆氧化层,采用氧化绝缘层版M6对传感器芯片表面除焊盘以外的位置涂覆一层绝缘氧化层,增强传感器的绝缘性能,为其能够进行液体测量打下基础。
加工完成的传感器芯片如图 4所示, 整体芯片尺寸为2.5mm×2.5mm×0.25mm。
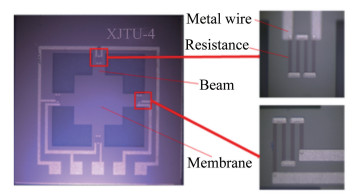
|
| 图 4 传感器芯片显微照片 Fig.4 Fabricated sensor chip |
由于MEMS传感器芯片的特殊性,如不采用必要的封装保护则不能应用于实际中。所设计传感器具有可动结构,需要与流体相互作用产生运动,才能完成流量测量。对于MEMS梁膜结构流量传感器的封装,主要有以下要求:(1) 保护传感器芯片可动结构不受破坏,高可靠性,高稳定性;(2) 增强传感器密封性,适应液体环境测量要求;(3) 使传感器免受安装带来的应力影响;(4) 提供可靠的引线方式和电气连接;(5) 尽量减小因封装过程而引入的传感器系统误差,减小温度变化引起的热应力对传感器性能影响;(6) 安装简易、成本低廉,封装制造能与标准的微电子制造工艺兼容。
针对以上要求,本文采用PCB转接板结合不锈钢壳体的封装方式,对传感器进行了实验性封装。不锈钢壳体主要对传感器芯片和PCB板提供载体,并保护传感器芯片。传感器芯片、PCB转接板与壳体相互粘接成为一体结构,并在表面涂覆一层硅胶,以增加传感器密封性。图 5为所采用的封装方案示意图,图 6为封装完成的传感器。
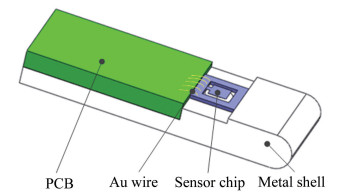
|
| 图 5 封装方案示意图 Fig.5 Schematic diagram of the package |

|
| 图 6 封装完成的传感器 Fig.6 The packaged sensor |
设计的MEMS梁膜结构压差式流量传感器性能测试试验主要包括气体 (压缩空气) 流速测试和液体 (水) 流速测试。
3.1 气流测试气流测试中,流动气体采用压缩空气源提供,标准流量计采用SY-M100L-CRWE便携式标准表法标定装置。气流测试框图如图 7所示。

|
| 图 7 气流试验图 Fig.7 Airflow test |
气流试验是在温度20℃,相对湿度50%RH的环境下进行,采用±5V恒压源供电,测量范围0~30m/s。试验时,气流速度的输入由0m/s开始,每增加3m/s测采集一次,每次稳定时间设定为30s,直至达到试验量程;之后,进行反行程卸载测试,测试流速间隔及稳定时间与加载过程相同。循环测量3次,测试结果如图 8所示。

|
| 图 8 气流测试结果 Fig.8 Result of airflow test |
拟合后的曲线方程为:
 (3)
(3)
式中:U为输出电压;v为流体速度。
3.2 水流测试水流测试采用水槽标定装置完成试验,其试验图如图 9所示。

|
| 图 9 水流试验图 Fig.9 Water flow test |
水流试验是在水温10℃环境下进行的,采用±5V恒压源供电,测量范围为0~3m/s。试验时,水流速度的输入由0m/s开始,每增加0.3m/s测量一次,每一次稳定时间30s,直到达到试验量程;之后,进行反行程卸载测试,测试流速间隔与稳定时间与加载过程相同。每个传感器加载卸载循环过程进行3次,测试结果如图 10所示。

|
| 图 10 水流测试结果 Fig.10 Result of water flow test |
拟合后的曲线方程为:
 (4)
(4)
通过分析传感器标定测试结果,得到其各项静态性能如表 1所示。
| Air flow test | Water flow test | |
| Environment | air | water |
| Temperature/℃ | 20 | 10 |
| Supply voltage/V | ±5 | ±5 |
| ZERO voltage/mV | 52.5 | 51.28 |
| Range/(m·s-1) | 1.2~30 | 0.11~3 |
| Sensitivity/(mV·(ms-1)-2) | 0.3508 | 41.5241 |
| Nonlinearity/%FS | 0.0915 | 0.2094 |
| Hysteresis/%FS | 0.2536 | 0.2081 |
| Repeatability/%FS | 0.5231 | 0.8843 |
| Basic accuracy/%FS | 0.5885 | 0.9323 |
从测试结果可以看出,所设计传感器能够完成气流和水流流量的测试工作。其中气流测试灵敏度为0.3508mV/(ms-1)2,测试基本精度为0.5885%FS;水流测试灵敏度为41.5241mV/(ms-1)2,测试基本精度为0.9323%FS。结果表明,所设计传感器具有足够的灵敏度与基本精度从而完成流量信号的测量工作。
性能指标中量程存在测量下限的原因主要有2点:(1) 当流速较低时,流体粘度对传感器影响较大,使得测量精度降低;(2) 当流速小于1m/s时,流速越小,则其平方值会更小,使得传感器无输出电压。存在测量下限是压差式流量传感器目前所无法克服的一个缺点。本文所设计传感器气流测试下限为1.2m/s,水流测试下限为0.11m/s,相比较现有压差式流量传感器,具有更低的测量下限。
4 结论(1) MEMS流量传感器采用可与IC加工工艺集成的加工技术,其低成本、微型化以及可批量生产的潜力可使MEMS传感器在未来智能检测领域中得到大量应用。
(2) MEMS压差式流量传感器测量过程中电极与流体无接触,且测量过程中无能量输入到被测流体中,对流体温度几乎无影响,尤其适用对温度敏感的流量测量领域。
(3) 所设计传感器敏感单元采用新型梁膜结构,提高了传感器的测量灵敏度,且加工工艺简单。
(4) 通过性能测试试验可以看出,MEMS梁膜结构传感器具有较高的灵敏度和精度,较低的测量下限,且可同时用于气体和液体环境流量信号的测量。
| [1] | Schena E, Massaroni C, Saccomandi P, et al. Flow measurement in mechanical ventilation:a review[J]. Medical Engineering & Physics, 2015, 37(3): 257–264. |
| [2] | 蔡武昌. 从FLOMEKO 2010看流量测量技术和仪表的发展[J]. 石油化工自动化, 2011(05): 1–4. Cai W C. View of flow measurement technology and instrument development from FLOMEKO 2010[J]. Automation in Petro-chemical Industry, 2011(05): 1–4. DOI:10.3969/j.issn.1007-7324.2011.05.001 |
| [3] | Worsfold P J, Clough R, Lohan M C, et al. Flow injection analysis as a tool for enhancing oceanographic nutrient measurements-a review[J]. Analytica Chimica Acta, 2013, 803: 15–40. DOI:10.1016/j.aca.2013.06.015 |
| [4] | Nguyen N T. Micromachined flow sensors-a review[J]. Flow Measurement and Instrumentation, 1997, 8(1): 7–16. DOI:10.1016/S0955-5986(97)00019-8 |
| [5] | Zhou L X. A review of measurements and numerical studies for the effect of wall roughness on the gas-particle flow behavior[C]. 8th International Symposium on Measurement Techniques for Multiphase Flows, 2014:115-120. |
| [6] | 彭杰纲, 周兆英, 叶雄英. 基于MEMS技术的微型流量传感器的研究进展[J]. 力学进展, 2005(03): 361–376. Peng J G, Zhou Z Y, Ye X Y. Progresses on micromachined flow sensors based on mems technology[J]. Advances in Mechanics, 2005(03): 361–376. DOI:10.3321/j.issn:1000-0992.2005.03.007 |
| [7] | Kuo J T W, Yu L, Meng E. Micromachined thermal flow sensors-a review[J]. Micromachines, 2012, 3(3): 550–573. |
| [8] | Nawi M N M, Abd M A, Arshad M R, et al. Review of MEMS flow sensors based on artificial hair cell sensor[J]. Microsystem Technologies-Micro-and Nanosystems-Information Storage and Processing Systems, 2011, 17(9): 1417–1426. |
| [9] | Ozaki Y, Ohyama T, Yasuda T, et al. Air flow sensor modeled on wind receptor hairs of insects[J]. Proceedings of the IEEE Micro Electro Mechanical Systems (MEMS), 2000: 531–536. |
| [10] | Ma R H, Chou P C, Wang Y H, et al. A microcantilever-based gas flow sensor for flow rate and direction detection[J]. Micro-system Technologies Micro and Nano systems Information Storage and Processing Systems, 2009, 15(8): 1201–1205. |
| [11] | Richter M, Wackerle M, Woias P, et al. A novel flow sensor with high time resolution based on differential pressure principle[C]. MEMS 99:Twelfth IEEE International Conference on Micro Electro Mechanical Systems, Technical Digest, New York, 1999:118-123. |
| [12] | Chen P, Zhao Y L, Tian B A, et al. Design and fluid-structure interaction analysis of a micromachined cantilever-based differential pressure flow sensor[J]. Micro & Nano Letters, 2014, 9(10): 650–654. |
| [13] | Chen P, Zhao Y L, Li Y Y. Design, simulation and fabrication of a micromachined cantilever-based flow sensor[C]. 8th IEEE International Conference on Nano/Micro Engineered and Molecular Systems (NEMS), 2013:681-684. |
| [14] | Fitzpatrick JAJ, Inouye Y, Manley S, et al. From "there's plenty of room at the bottom" to seeing what is actually there[J]. Chemphyschem, 2014, 15(4): 547–549. DOI:10.1002/cphc.201400097 |
| [15] | Stylios G K. There is plenty of room at the bottom, RP Feynman[J]. International Journal of Clothing Science and Technology, 2013, 25(5): 336–337. |
| [16] | SD S. MEMS materials and processes handbook[M]. New York: Springer, 2011. |
| [17] | Erdmann A, Liang R G, Sezginer A, et al. Advances in lithography:introduction to the feature[J]. Applied Optics, 2014, 53(34): L1–L2. |
| [18] | Mendaros R G, Marcelo M T. ICP-RIE platinum (Pt) sputter etching[C]. 2014 IEEE 21st International Symposium on the Physical and Failure Analysis of Integrated Circuits, 2014:114-117. |



