文章信息
- 刘峰峰, 李玉雄, 隋展鹏, 蔡勇, 张永红, 蒋春萍
- LIU Feng-feng, LI Yu-xiong, SUI Zhan-peng, CAI Yong, ZHANG Yong-hong, JIANG Chun-ping
- 非晶AlBN介质薄膜的制备及相关特性研究
- Preparation and relevant properties of amorphous AlBN dielectric films
- 材料工程, 2020, 48(6): 112-117
- Journal of Materials Engineering, 2020, 48(6): 112-117.
- http://dx.doi.org/10.11868/j.issn.1001-4381.2019.000323
-
文章历史
- 收稿日期: 2019-04-08
- 修订日期: 2019-10-08
2. 中国科学院苏州纳米技术与纳米仿生研究所 纳米器件与应用重点实验室, 江苏 苏州 215123;
3. 中国科学院 苏州纳米技术与纳米仿生研究所 纳米真空互联实验站, 江苏 苏州 215123
2. Key Lab of Nanodevices and Applications, Suzhou Institute of Nano-tech and Nano-bionics, Chinese Academy of Sciences, Suzhou 215123, Jiangsu, China;
3. Vacuum Interconnected Nanotech Workstation, Suzhou Institute of Nano-tech and Nano-bionics, Chinese Academy of Sciences, Suzhou 215123, Jiangsu, China
氮化物半导体(GaN,AlN,InN及其合金)作为第三代宽禁带半导体,具有直接带隙且禁带宽度大,电子饱和速率高,导热性能好等特点,广泛应用于高频高功率电子器件、发光器件,以及光探测器等。自1993年第一支GaN HEMT晶体管诞生,经过20多年的研究,以GaN/AlGaN MIS-HEMT为代表的GaN器件取得了巨大的发展,器件性能已经远远超越了传统的Si器件,但是器件的特性指标距离材料的理论值仍有很大的距离,其中面临的一个挑战就是界面态问题。界面态效应会导致栅极漏电、电流崩塌、阈值回滞等相关问题,这势必影响到GaN基器件的稳定性和可靠性。因此,为了获得稳定的器件性能,以推动GaN电力电子器件的实用化和产业化,急需大幅降低器件的界面态。为了降低界面态,人们尝试了许多生长方法来制备各种介质材料,例如ZrO2[1],HfO2[2],Al2O3[3],TiO2[4],LaHfOx[5]和Si3N4[6-7]等,但基本上所有的材料与GaN/AlGaN的界面态密度都在1011 cm-2以上,与实用化Si器件的界面态密度(1010cm-2)相比还是高了一个数量级,不能满足器件的实际应用需求。因此,探索新型绝缘介质成为当务之急。
本工作采用脉冲激光沉积(PLD)技术在GaN衬底上生长新型非晶铝硼氮(AlBN)介质薄膜,研究不同厚度AlBN介质薄膜的结晶情况和化学组成的情况。此外,还制备相关的金属-介质-金属(MIM)结构并研究了不同厚度的AlBN介质薄膜的电学特性。
1 实验材料与方法实验装置主要由一台脉冲准分子激光器和一套真空腔室组成。脉冲准分子激光器以KrF为工作气体,激光波长为248 nm,脉冲宽度为25 ns,激光能量密度约为14 J/cm2。为获得更高的真空度,真空系统由一个进样室和一个生长室构成,进样室和生长室的极限真空度分别为5×10-5 Pa和5×10-8 Pa。本实验选用蓝宝石上生长的(002)取向的GaN作为衬底,纯度99.9%的AlBN混合陶瓷(AlN与BN的摩尔比为4:1)作为靶材。
生长前将衬底依次放在丙酮、乙醇中超声清洗,去除表面附着的有机物,然后用超纯水反复冲洗数次,用氮气吹干后,将其固定在托盘上并放入送样室,然后传入生长室。生长室的本底真空度降至5×10-6 Pa以下时,通入氮气,调节气压为0.2 Pa开始生长。激光的重复频率设定为2 Hz,激光能量设定为420 mJ,衬底温度为室温,靶到衬底的距离固定在6 cm。为了提高薄膜的均匀性,在沉积时靶材与衬底均以一定速率自转。两种不同厚度的AlBN介质薄膜的生长时间分别为3 min和20 min。
样品生长完成后,分别采用X射线衍射(XRD,Bruker AXS,D8 Advance Cukα1线,λ=0.15406 nm)和透射电子显微镜(TEM,FEI Tecnai G2 F20 S-Twin)对其结构特性进行表征;并采用X射线光电子能谱(XPS,PHI 5000 VersaprobeⅡ)表征薄膜的化学组成;利用导电原子力显微镜(CAFM,Bruker Dimension ICON)表征薄膜表面形貌及相应的表面电流分布情况(CAFM采用曲率半径约为30 nm的Pt-Ir针尖,扫描时施加的偏压为-10 V)。最后,制备MIM结构,使用KEITHLEY 4200-SCS参数分析仪进行电流-电压(I-V)测试。
2 结果与分析 2.1 结构与成分表征通过XRD测试对用脉冲激光沉积方法生长的AlBN薄膜样品进行物相定性分析,如图 1所示。除34.8°附近的GaN衬底(002)晶面对应的衍射峰以外,没有看到其他明显的结晶峰,这说明所制备的AlBN薄膜极有可能是非晶[8]。但是由于六方GaN和六方AlBN的(002)晶面对应的衍射峰很接近,在很强的GaN(002)峰的影响下,XRD测试未能观察到AlBN峰位并不能确定AlBN介质薄膜的晶体结构。因此对生长的AlBN介质薄膜的样品进行了透射电镜表征。

|
图 1 AlBN薄膜的XRD图 Fig. 1 XRD pattern of AlBN film |
图 2为GaN衬底上沉积3 min和20 min AlBN薄膜的高分辨透射电镜像,虚线标出薄膜和GaN衬底以及聚焦离子束(FIB)切样时蒸镀的碳(C)之间的界面,界面平直分明。如图 2所示,生长3 min的AlBN薄膜厚度为3 nm,生长时间为20 min,薄膜厚度为18 nm。不同厚度的AlBN薄膜中原子均呈现无规则排列,为单一的无定形态,插图中的傅里叶变换(fast Fourier transform,FFT)衍射图像均为弥散环状的特征。结合XRD分析的结果,表明在该实验条件下获得AlBN介质薄膜为非晶。
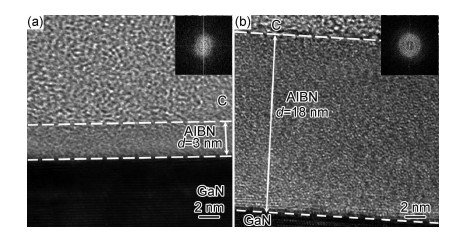
|
图 2 不同生长时间AlBN介质薄膜的高分辨TEM图及相应的FFT图 (a)3 min;(b)20 min Fig. 2 High resolution TEM images and the corresponding FFT patterns of AlBN dielectric films with different growth time (a)3 min; (b)20 min |
由于生长的非晶AlBN介质薄膜基本上没有晶粒间隙、晶体缺陷(见图 2),其绝缘性能主要由致密度和成分决定。(Al+B):N比例将直接影响薄膜的介电性能,因为缺N将会促进Al—Al,Al—B,B—B等金属键键合,从而打开薄膜带结构中的导电通路或中间间隙状态[9]。所以使用XPS(单色Al Kα X射线源,1486.7 eV)对生长的非晶AlBN介质薄膜进行成分研究。为了更好地排除污染物的干扰,通过Ar+溅射清洁AlBN膜表面。使用CasaXPS软件对数据进行处理分析,为了消除仪器及其他因素导致的元素结合能的偏差,样品峰位以结合能为284.8 eV的C1s特征峰作为校正标准。图 3(a)显示了AlBN薄膜的XPS全谱图,可以观测到从低能端到高能端分别出现了Al2p,B1s和N1s特征峰,图 3(b)~(d)分别为Al2p,N1s和B1s的精细扫描高斯拟合的图谱。由图可知AlBN薄膜中Al2p峰由结合能为73.76 eV和74.99 eV的两个峰组成,分别对应Al—N(73.6 eV)和Al—O(74.43 eV)[10-11]。N1s峰由结合能为396.80 eV和398.57 eV的两个峰组成,分别对应N—Al(396.86 eV)和N—B(390.3 eV)[10, 12]。图 4(d)中,B1s峰位于190.59 eV结合能处,与报道中BN中B1s与N1s的结合能基本一致[11]。采用相对灵敏度因子的方法,定量分析样品中各组成元素的相对百分含量,计算结果列于表 1中。结果表明,生长的非晶AlBN介质薄膜中,硼的原子分数约为6.7%,(Al+B):N比例接近1:1,B含量较低,薄膜性质更偏向非晶AlN。

|
图 3 Ar+清洗2 min后AlBN薄膜的XPS谱 (a)全谱;(b)Al2p;(c)N1s;(d)B1s Fig. 3 XPS spectra for the AlBN film after cleaning using Ar+ sputtering for 2 min (a)survey; (b)Al2p;(c)N1s;(d)B1s |
| Sample | Peak | Position of peak maximum/eV | Sensitivity factor | Atom fraction/ % | (Al+ B):N |
| AlBN | Al2p | 74.17 | 17.221 | 39.19 | 23:24 |
| N1s | 396.57 | 28.832 | 47.96 | ||
| B1s | 190.17 | 9.817 | 6.74 | ||
| O1s | 531.77 | 42.499 | 4.86 | ||
| C1s | 284.80 | 18.080 | 1.25 |
随着当前晶体管尺寸不断缩小,要求栅极介质层具有更小的表面粗糙度和漏电流密度[13],因此采用CAFM技术研究了新型AlBN薄膜的形貌及漏电情况。
图 4为两种不同厚度的AlBN介质薄膜的表面形貌和电流分布。图 4(a-1),(b-1)分别为3 nm和18 nm薄膜在(1 μm×1 μm)范围内的形貌图,薄膜表面粗糙度Rq分别为0.209,0.116 nm,两种厚度的薄膜表面均平整光滑。样品表面均存在较为明显的原子台阶,这是由于底层GaN本身的形貌引起的。图 4(a-2),(b-2)分别对应3 nm和18 nm AlBN薄膜在-10 V偏置电压下的电流分布。从图 4(a-1)中可观察到薄膜表面存在一个明显的凹陷。当薄膜上施加偏压时,材料中的缺陷将在电应力的作用下聚集形成导电通道,导致电子能够通过导电通道穿过介电薄膜形成漏电流。正如图 4(a-2)所示,薄膜对应位置处出现漏电点。厚度为3 nm的AlBN介质薄膜整体漏电较大,但是并没有发现这些漏电点与原子台阶形貌有直接关系。相比而言,厚度为18 nm的AlBN薄膜表面更为均匀平整,没有发现能够引起漏电流的凹陷(如图 4(b-1)所示),基本没有漏电流(如图 4(b-2)所示)。厚度为3 nm的薄膜,处于薄膜生长初期。等离子体羽辉经过反应的碰撞之后以一定的动能到达衬底,在非故意加热的衬底表面,粒子迅速形核,孤立的核心随着生长时间的推移逐渐长大、合并,形成核心细小、连续的薄膜[14]。但该阶段的薄膜不够致密,存在很多小间隙、小空位等,从而产生密集的“针孔”漏电点。在厚度为18 nm的薄膜中,在形核成膜阶段之后,随着生长的进行,等离子体优先填充超薄膜中的间隙、空位,薄膜的厚度增加的同时,致密度也在逐渐增加,缺陷密度降低,从而出现较低漏电流[9, 15]。在图 4(c)中,进一步比较了两个样品的CAFM单点I-V特性。厚度为3 nm的薄膜在±3 V左右“开启”,漏电流迅速增大,而18 nm膜施加±10 V电压仍没有出现明显漏电流。厚度为18 nm的AlBN薄膜比3 nm的漏电更小,击穿电压更高。

|
图 4 3 nm(a)和18 nm(b)AlBN薄膜的形貌图(1)及在-10 V下电流分布图(2)和AlBN薄膜的CAFM I-V曲线(c) Fig. 4 Morphologies (1), current distribution at -10 V (2) and CAFM I-V curves of AlBN thin films (c) of 3 nm (a) and 18 nm (b) AlBN films |
由于CAFM是针对局域区域的形貌和电学性质的测试,并不能很好地反映整个膜层的电学特性,因此,制备简单的MIM结构,进行电学测试,进一步研究了生长的AlBN介质薄膜的大面积均匀性。具体的MIM结构制备流程为:先在GaN衬底上采用PLD技术先沉积一层金属Pt作为底电极,接着在同一腔室生长AlBN介质薄膜,最后在薄膜表面采用电子束蒸发沉积一层Ni/Au金属(圆形电极直径150 μm)作为顶电极。图 5是两种厚度薄膜的I-V特性曲线。随着电压的升高,厚度为3 nm的薄膜漏电流密度迅速增大,在-2 V时达到-2 A/cm2,超过-2 V时,薄膜击穿;厚度为18 nm薄膜的漏电流密度在-2 V时约为-2×10-4 A/cm2,击穿电压约为-5.2 V,电击穿场强约为2.8×106 V/cm。非晶AlBN薄膜的击穿场强与文献中报道的磁控溅射生长的纤锌矿AlBN(3×106 V/cm)基本相当[16]。18 nm薄膜MIM结构I-V测试在-5.2 V时被击穿,而在CAFM单点测试时施加±10 V电压没有出现明显漏电流,这可能是由于非晶介质膜层在大面积的电极区域内存在较多的缺陷造成的[17]。缺陷的产生可能是由衬底形貌缺陷、粗糙度和灰尘颗粒等因素诱导引起的。
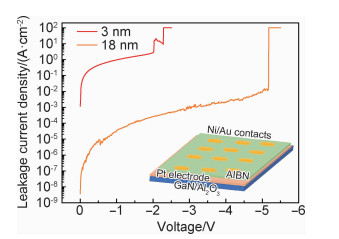
|
图 5 AlBN薄膜I-V曲线 Fig. 5 I-V curves of AlBN thin films |
(1) AlBN介质薄膜呈非晶态,AlBN介质薄膜中B元素含量约为6.7%,薄膜表面致密平滑,与GaN界面清晰。
(2) 相较于厚度为3 nm的薄膜样品,18 nm的薄膜样品表面更为平整,施加±10 V电压时,基本无漏电流产生。
(3) 对于两种厚度的薄膜均制备了相关的MIM结构,测试其I-V特性时,样品均出现了较大的漏电流,这可能是由于较大的电极面积区域下AlBN介质薄膜不是很均匀造成的。因此,进一步调整生长工艺参数,生长出大面积、高均匀性的非晶AlBN介质薄膜是非常有必要的。
| [1] |
YE G, WANG H, ARULKUMARAN S, et al. Atomic layer deposition of ZrO2 as gate dielectrics for AlGaN/GaN metal-insulator-semiconductor high electron mobility transistors on silicon[J]. Applied Physics Letters, 2013, 103(14): 142109. |
| [2] |
LIU C, CHOR E F, TAN L S. Enhanced device performance of AlGaN/GaN HEMTs using HfO2 high-k dielectric for surface passivation and gate oxide[J]. Semiconductor Science and Technology, 2007, 22(5): 522-527. |
| [3] |
SHI Y Y, ZHOU Q, CHEN W J, et al. 7.6 V threshold voltage high performance normally-off Al2O3/GaN MOSFET achieved by interface charge engineering[J]. IEEE Electron Device Letters, 2016, 37(2): 165-168. |
| [4] |
LIN Y S, LU C C. Improved AlGaN/GaN metal-oxide-semiconductor high-electron mobility transistors with TiO gate dielectric annealed in nitrogen[J]. IEEE Transactions on Electron Devices, 2018, 65(2): 783-787. |
| [5] |
LIN Y C, HUANG Y X, HUANG G N, et al. Enhancement-mode GaN MIS-HEMTs with LaHfOx gate insulator for power application[J]. IEEE Electron Device Letters, 2017, 38(8): 1101-1104. |
| [6] |
ZHANG Z, YU G, ZHANG X, et al. Studies on high-voltage GaN-on-Si MIS-HEMTs using LPCVD Si3N4 as gate dielectric and passivation layer[J]. IEEE Transactions on Electron Devices, 2016, 63(2): 731-738. |
| [7] |
ZHENG X, LI H, GUIDRY M, et al. Analysis of MOCVD SiNx passivated N-polar GaN MIS-HEMTs on sapphire with high fmax·VDS, Q[J]. IEEE Electron Device Letters, 2018, 39(3): 409-412. |
| [8] |
方泽波, 谭永胜, 朱燕艳, 等. 非晶Er2O3高k栅介质薄膜的制备及结构特性研究[J]. 无机材料学报, 2008, 23(2): 357-360. FANG Z B, TAN Y S, ZHU Y Y, et al. Structure characteristics of amorphous Er2O3films grown on Si(001) by reactive evaporation[J]. Journal of Inorganic Materials, 2008, 23(2): 357-360. |
| [9] |
GLAVIN N R, MURATORE C, JESPERSEN M L, et al. Amorphous boron nitride: a universal, ultrathin dielectric for 2D nanoelectronics[J]. Advanced Functional Materials, 2016, 26(16): 2640-2647. |
| [10] |
ALEVLI M, OZGIT C, DONMEZ I, et al. Structural properties of AlN films deposited by plasma-enhanced atomic layer deposition at different growth temperatures[J]. Physica Status Solidi, 2012, 209(2): 266-271. |
| [11] |
许莹, 王娟, 窦玉博. Al-N共掺杂型ZnO薄膜的制备及其性能研究[J]. 材料工程, 2010(11): 11-16. XU Y, WANG J, DOU Y B. Study of Al-N co-doped-type ZnO films and their properties[J]. Journal of Materials Engineering, 2010(11): 11-16. |
| [12] |
GUIMON C, GONBEAU D, PFISTERGUILLOUZO G, et al. XPS study of BN thin-films deposited by CVD on SiC plane substrates[J]. Surface and Interface Analysis, 1990, 16(1/12): 440-445. |
| [13] |
MULLER D A, SORSCH T, MOCCIA S, et al. The electronic structure at the atomic scale of ultrathin gate oxides[J]. Nature, 1999, 399(6738): 758-761. |
| [14] |
EASON R. Pulsed laser deposition of thin films: applications-led growth of functional materials[M]. New Jersey: Wiley-Interscience, 2007.
|
| [15] |
GARCIA H, DUENAS S, CASTAN H, et al. Influence of interlayer trapping and detrapping mechanisms on the electrical characterization of hafnium oxide/silicon nitride stacks on silicon[J]. Journal of Applied Physics, 2008, 104(9): 094107-094107. |
| [16] |
LILJEHOLM L, OLSSON J. Electrical characterization of wurtzite (Al, B)N thin films[J]. Vacuum, 2011, 86(4): 466-470. |
| [17] |
BAKALOVA S, SIMEONOV S, KAFEDJIISKA E, et al. Electrical properties of MIS capacitors with AlN films synthesized by pulsed laser deposition[J]. Plasma Processes & Polymers, 2006, 3(2): 205-208. |
 2020, Vol. 48
2020, Vol. 48


