文章信息
- 王思聪, 季凌飞, 吴燕, 张永哲, 闫胤洲
- WANG Si-cong, JI Ling-fei, WU Yan, ZHANG Yong-zhe, YAN Yin-zhou
- SiC发光特性及其调控研究进展
- Progress in Research on Luminescence Properties and Modification of SiC
- 材料工程, 2017, 45(2): 102-111
- Journal of Materials Engineering, 2017, 45(2): 102-111.
- http://dx.doi.org/10.11868/j.issn.1001-4381.2015.001179
-
文章历史
- 收稿日期: 2015-09-25
- 修订日期: 2016-10-25
2. 北京工业大学 材料科学与工程学院, 北京 100124
2. College of Materials Science and Engineering, Beijing University of Technology, Beijing 100124, China
SiC作为第三代半导体具有稳定的化学性质和独特的物理性质,包括低密度,高硬度,抗辐射能力强,禁带宽度大,热导率和临界击穿电场高等特点[1],由于近年来半导体器件和集成电路日趋小型化,并且逐渐向高温、强辐射等极端环境中(如航空航天、核能以及相关通讯领域)的应用上拓展,使得SiC半导体受到广泛关注。由于SiC的宽带隙特性(6H-SiC和4H-SiC的禁带宽度分别为3.08eV和3.26eV),使其成为最早实现蓝光发光的电致发光材料之一;SiC半导体的独特发光性质吸引了许多研究者的目光,对其进行发光机理以及改进方法的探索,如在生物医学以及量子通信等前沿领域。目前SiC体单晶的制备技术已日趋完善,但是由于SiC是间接带隙半导体,在室温下发光效率较低,如何提高SiC材料的注入效率是提高SiC-LED发光效率的关键,如何改善发光特性以提高SiC的发光效率乃至对其发光光谱的调制已成为目前的研究热点。本文将介绍与SiC半导体材料相关的发光机理与应用方式,讨论改善、调控SiC发光特性的方法与技术。
1 SiC基本性质及发光应用前景传统的硅材料应用于集成电路中工作温度低于200℃,而SiC器件可以在500℃温度条件下持续工作超过7000h[2]。同时,相比之下SiC半导体具有宽禁带(2.38~3.26eV)、高热导率(4.9W/(cm·K))和高临界击穿电场(2.5MV/cm)等特点,有助于提高器件的功率密度和集成度。如图 1[3, 4]所示对SiC,Si及GaN材料的基本性能参数及对极端特性影响进行对比,SiC已成为高温、大功率和高速器件的首选材料。
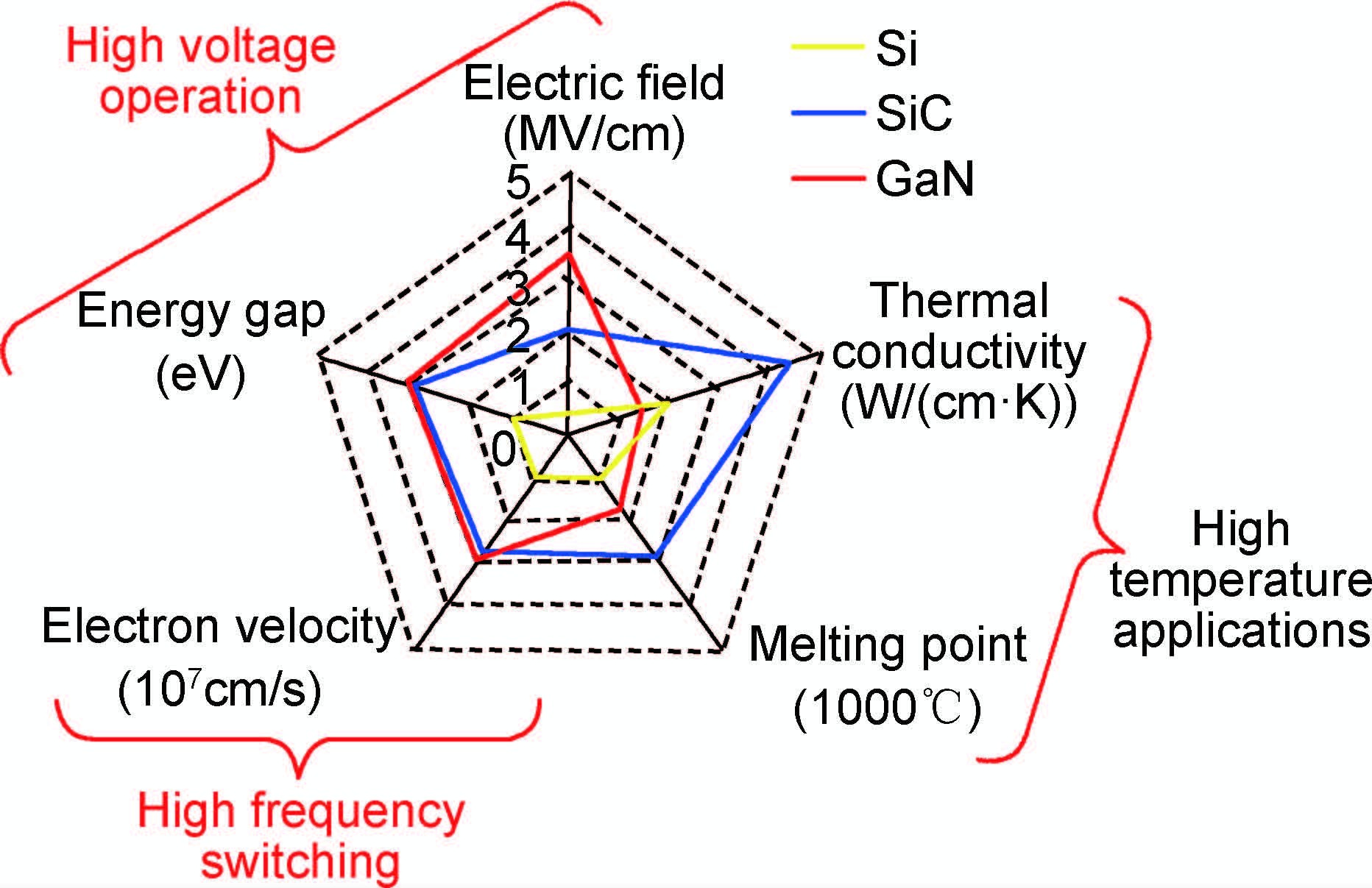
|
图 1 SiC,Si与GaN基本性能参数以及极端条件下的性能影响 Fig. 1 The performance parameters of SiC,Si and GaN and extreme conditions performance |
SiC材料的传统应用主要作为耐磨材料。随着SiC半导体晶体生长技术的发展,人们对SiC光电学性能的研究逐步展开。SiC杂质能级的分布较为复杂,主要的n型杂质为氮,氮原子取代碳晶格位,在SiC禁带中产生相对较浅的施主。掺杂过程中,晶格中不可避免的会产生空位和自间隙[5],C 空位(VC)作为施主提供电子。掺入氮的浓度由生长环境中的N2分压决定,且随生长温度的升高而减少。未掺杂SiC单晶是n型材料,这是由于生长过程中化学气相沉积(CVD)反应室残余的N原子掺杂。高掺杂氮的SiC无论是通过Lely生长方法[6]还是随后的离子注入方法[7],其中的氮原子电学特性均将在浓度1020cm-3数量级饱和。p型SiC通常采取Al掺杂来获得,Al原子取代Si晶格位,形成Si 空位(VSi),在SiC禁带的下半部分形成最浅的受主能级。因此,通过n型SiC外延层上注入Al离子从而可以获得p-n结。对于Al杂质,浓度接近1020cm-3时,近似为线性关系,随温度升高而增加。此外,B在SiC中有很高的溶解度(约1020cm-1),可以形成浅受主能级[8, 9],产生hv=2.14eV的荧光。
SiC的发光特性同样备受关注,由于其宽带隙特性,使其成为最早实现蓝光发光的电致发光材料之一,早在1969年Brander和Sutton[10]就利用液相外延技术制作了SiC的p-n结,以此为雏形的蓝光发光二极管(LED)在室温下具有100lm的亮度,并且在室温至400℃的温度范围内工作寿命超过15000h。另外,由于SiC带隙较宽,同时又有多种n型与p型的掺杂元素,为制造出整个可见光范围内的发光器件提供了基础。Dmitriev等[11]在同一块6H-SiC基板上利用外延技术制作了蓝(470nm)绿(510nm)红(650nm)三色的SiC发光二极管。最近有研究人员利用SiC的缺陷制作LED来尝试单光子放射[12],其中缺陷兼有半导体量子点的技术优势和金刚石色心的量子性质优势,其电子自旋量子比特可以利用光学进行重置和读出,这种成本较低的单光子发射器件很有可能在量子通信和生物医学等领域发挥巨大作用[13]。
SiC的光致发光性质同样受到诸多关注,以LED照明研究为例,实现白光照明的方法之一是利用近紫外光激发荧光体的蓝色、黄色发光,而SiC可以采用施主-受主共掺杂(Donor-Acceptor-Pairs,DAP)有效激发黄绿(N-B)以及蓝(N-Al)色荧光,产生近似于太阳光的白光。利用氮化镓基近紫外发光LED激发施主-受主对SiC荧光层,已经能实现较高效率的白光照明[14, 15]。另外,具有发光特性的半导体材料在生物分析领域中有巨大的应用潜力,SiC半导体量子点(Quantum Dots,QDs)[16, 17]由于其较宽激发谱及较窄的发射谱,同时具有优良的生物相容性与化学稳定性,不需要表面钝化处理且能在水中形成稳定的胶体,使得其在生物成像、生物标记研究中具有显著的性能优势。
2 SiC发光机理 2.1 辐射跃迁--激子半导体发光是一种受激电磁辐射现象,当半导体受到外部激发时,电子从基态跃迁至高能态。在理想晶体中,价带电子跃迁到导带,由于库仑相互作用,和价带中留下的空穴;而当导带中处于某一电子态的电子跃迁到价带中空的电子态,同时放出一个光子,称为电子与空穴的复合,即带间的光发射跃迁,这样的电子-空穴对称为激子。而像SiC这种间接带隙半导体,导带底和价带顶在k空间中位置不同,为满足动量守恒定律,处在激发态电子在向下跃迁时还需要释放一个声子,发射光子能量为:

|
(1) |
式中:Eph为发射声子的能量;EX为激子束缚能。激子复合中的这一附加过程严重影响了间接带隙半导体的发光效率。
当材料的尺寸小到与相应块体材料激子波尔半径相当时(如纳米颗粒),量子限域效应将导致其激子吸收蓝移,使得半导体材料带隙展宽。而且,在间接带隙半导体中,当限域在纳米结构中的载流子包络函数在发生间接带间跃迁的波矢处具有适当的傅里叶分量时,该分量可起到类似声子的作用,从而使得能带结构具有直接带隙的特征,大幅度提高辐射复合的效率[18, 19]。因此,由于量子尺寸效应和量子限域效应,SiC纳米晶可以在室温下实现禁带间的辐射发光,且发光效率远远高于块材SiC。而且,量子限域效应通过理论计算预测[20, 21],可用于研究分析SiC量子点的荧光发光机理,SiC纳米晶的禁带宽度可以通过纳米晶的尺寸进行调控[22]:

|
(2) |
式中:EG是块体材料禁带宽度;r是纳米晶的半径;μ是激子有效质量:1/μ=1/m*e+1/m*h;ε是高频介电常数;h是普朗克常量。SiC纳米颗粒的禁带宽度随量子点颗粒的减小而增大。
因为激子谱线十分尖锐,能方便地用来对材料性质进行分析,如利用自由激子的光致发光光谱,可以分析材料的禁带宽度及其温度依赖关系、周期性势场的缺陷和杂质信息等。通常利用低温光致发光光谱(LTPL)分析SiC晶体的杂质能级信息[23],从而达到表征晶体中特定缺陷[24, 25]以及评价结晶质量等目的。
2.2 杂质与杂质能级半导体材料中由于缺陷或杂质的存在,激子会通过与杂质中心的相互作用而被局限在杂质中心周围,可以看作某种缺陷中心俘获了一个电子(或空穴),再通过库仑作用束缚住一个空穴(或电子)所造成的一种状态。由于束缚激子受到局限,电子和空穴的波函数在k空间部分重叠。相对于自由激子的能量为禁带宽度,束缚激子的能量为施主或受主与价带或导带之间的能级差,这一作用表现为束缚激子的束缚能EX。
与半导体中杂质有关的光跃迁,除了局限在中心周围的束缚激子跃迁,还可能有杂质能级与连续带能级之间的跃迁,这类跃迁往往在光的吸收与放射中扮演了重要角色。对于SiC而言,以N掺杂的n型立方相(3C)为例,其浅施主能级与掺杂浓度的关系[26]为:

|
(3) |
式中:ND为施主掺杂浓度;α为常数;EC为导带。
半导体中杂质间也可能发射光跃迁,最典型的是半导体中施主杂质与受主杂质间的发光跃迁,这一过程称为施主-受主对发光。在DAP复合机制中,电子与中性施主束缚在一起,空穴与中性受主束缚在一起,当电子和空穴复合发光时,发射的光子能量为:

|
(4) |
其中E*D和E*A分别为施主和受主的离化能。跃迁概率由施主能级与受主能级中的载流子浓度决定,而施主载流子浓度nD约等于施主掺杂浓度ND,受主载流子浓度pA约等于施主掺杂浓度NA,如图 2所示。
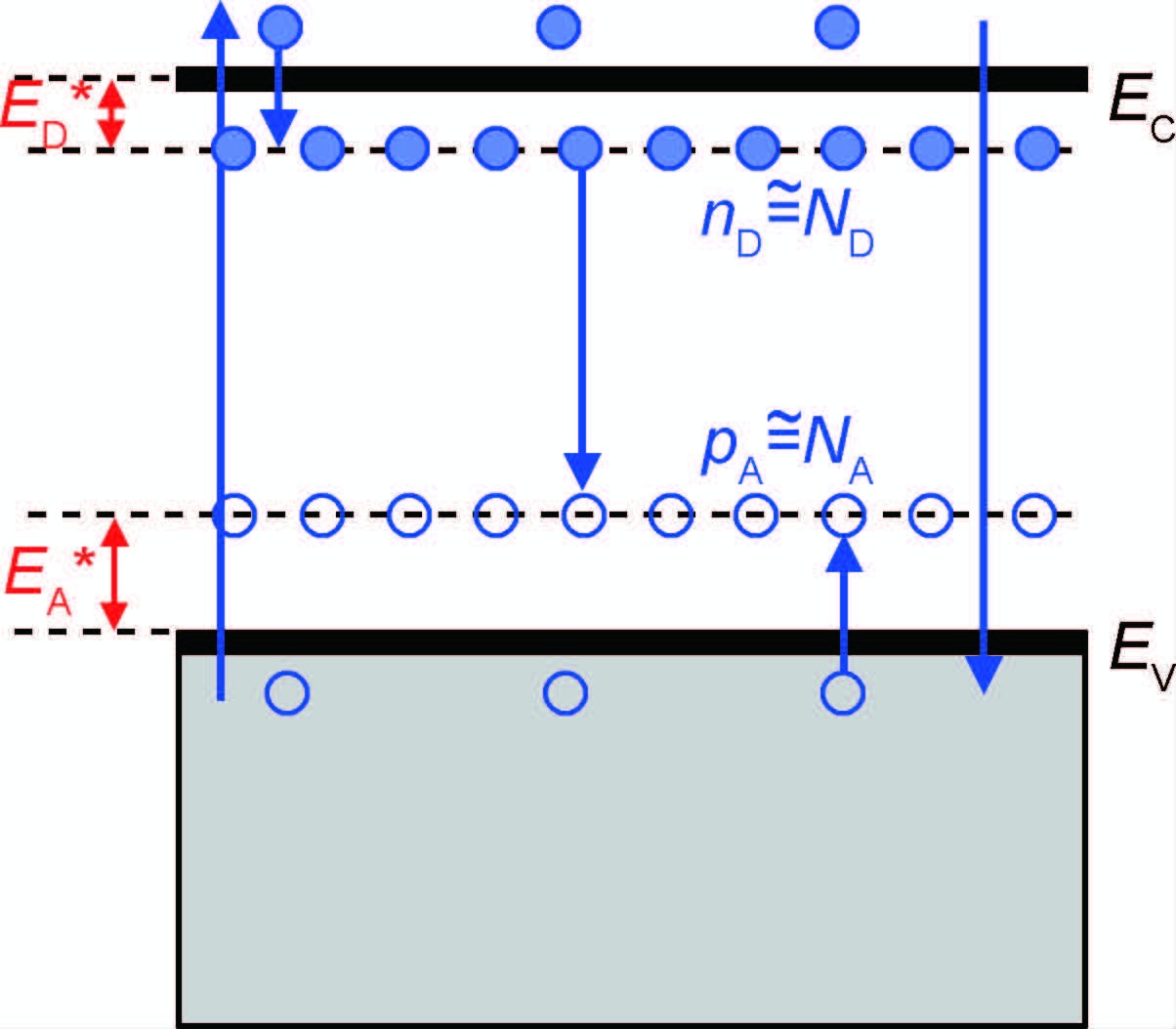
|
图 2 SiC中施主-受主对激发下电子跃迁示意图 Fig. 2 Electron transition of SiC donor-acceptor-pair under excitation |
对掺N的n型SiC掺入B和Al,可以同时形成两种施主-受主对(N-B和N-Al),并在室温下能有效光致发出两种波长的光[15, 27],如图 3所示。
3 SiC发光技术与调控方法 3.1 材料制备方法与发光性质在简要了解半导体材料发光的相关机理之后,我们发现,对于SiC半导体发光性质的调控,关键在于对其能带结构进行控制,而材料制备方法与技术的选择在控制材料能带结构等基础性质方面起着至关重要作用。
3.1.1 SiC单晶生长制备高质量的SiC单晶一直以来就是一项极具挑战性的工作,最早的尝试可以追溯到1892年[1](Acheson A G (1892) British Patent 17:911),而最早成功制备高纯度SiC单晶的是1955年Lely的升华生长方法,采用该方法在2500℃用无籽晶升华生长出针状3C-SiC孪晶。Lely法有两个明显的缺陷,一是由于无法控制成核与生长方向与速率,所以很难控制生长厚度、掺杂与SiC的多型性(polytypes);二是由于生长设备的限制,生长的SiC单晶直径无法超过10mm。此后,主要的突破来自于1978年,Tairov和Tsvetkov提出在生长中加籽晶用于控制成核的过程,这种方法称为改进Lely法,也称物理气相传输法(Physical Vapor Transport,PVT),是目前市场上高质量SiC单晶主要生产技术,生长的4H-及6H-SiC商用晶片的尺寸已突破6inch(15.24cm)[28]。其他改良的SiC单晶生长方法[29]有连续进料PVT(Continuous Feed PVT,CF-PVT)[30]、卤化物CVD(Halide CVD,H-CVD)和改良的PVT(Modified PVT,M-PVT)[31]等,基本仍处于研究当中,极少真正投入到实际生产。
单晶生长过程中有很多因素可以影响到SiC的发光性质。首先,SiC存在超过200种同质多型,SiC单晶生长的首要任务就是防止在生长过程中产生不同类型的SiC,多型生长不仅会在晶体里产生大量位错等缺陷,也会严重影响晶体的质量与性质[32]。减少多型生长的关键在于精确控制生长过程中的热力学与动力学条件,其中的影响因素包括温度、压力、籽晶方向、气相成分配比与过饱和度及杂质浓度等。
另一方面,生长过程中的掺杂控制能有效改变单晶中的杂质浓度,实现对浅施主或浅受主能级的调控。在掺杂元素的选择上,一般SiC的n型掺杂元素是N,P也能作为n型掺杂剂,且有报道称P在SiC中的溶解度高于N[33];p型掺杂元素一般为Al与B。不同元素的掺杂方式各异,N元素是在生长过程中向石墨坩埚中通入氮气,而Al元素需要直接混合在SiC升华原料中以实现掺杂。在掺杂浓度的控制上,目前市场上已经推出了高掺杂(1020cm-3)与半绝缘(1014cm-3)型的n型SiC晶片。
3.1.2 SiC外延薄膜生长对于SiC半导体器件的制造,外延薄膜生长是一项至关重要的技术,高质量的外延薄膜能提高光电器件的集成度与工作寿命。与单晶生长类似,外延薄膜生长的关键问题也在于减少多型生长、减少缺陷及控制掺杂浓度等。外延生长可分为同质外延与异质外延。异质外延一般都采用单晶Si作衬底[34-36],遇到的主要问题是SiC与Si之间巨大的晶格失配以及热膨胀系数的差异(晶格失配度约20%,热膨胀系数相差约8%),这在薄膜中引入大量失配位错和应力。Nishino[37]采用CVD方法生长SiC薄膜,在生长前先对Si衬底进行碳化处理,并生成一层很薄的SiC缓冲层以减小晶格失配。极端条件下应用的高功率器件会采用同质外延层[38],主要的制备技术包括气相外延[39](Vapor Phase Epitaxy,VPE)、液相外延(Liquid Phase Epitaxy,LPE)和气-液-固外延(Vapor-Liquid-Solid,VLS),以及多晶、非晶薄膜生长技术等。
SiC薄膜发光性质可调控性强,可通过薄膜在制备中对Si,C单质的相对含量比例及多相共存等进行调制,如控制制备过程中的氢气流量、C2H4气流速率及温度等[40-42]。 另外,通过控制生长条件与工艺参数,可以较为精确地将生长厚度控制在纳米量级,在一个维度上显示量子尺寸限域效应,从而获得高效率的光发射,特别是蓝光/紫外发光[43, 44](见图 4)。
SiC纳米晶须最开始通过控制气-液-固外延技术的制备参数制得[41, 45],随后诸如静电纺丝[46]、使用AAO模板的气相化学反应法[47]、还原-渗碳法[48]等技术也逐步出现。由于纳米限域效应,表面的纳米结构造成材料在室温下光致发光峰值的蓝移及发光强度的增强[47, 49]。
图 5所示为使用CVD方法制备的3C-SiC纳米线TEM高角度环形暗场图像,进行了高分辨率的元素能谱表征,研究发现在3C-SiC纳米线上存在同轴的SiC/SiOx核壳结构[50, 51]。这种结果使3C-SiC基体与非晶态的SiOx层在能带结构上形成I型量子阱,从而对3C-SiC的近带边光发射(2.38eV)产生增强效果,发光强度增强近50倍。
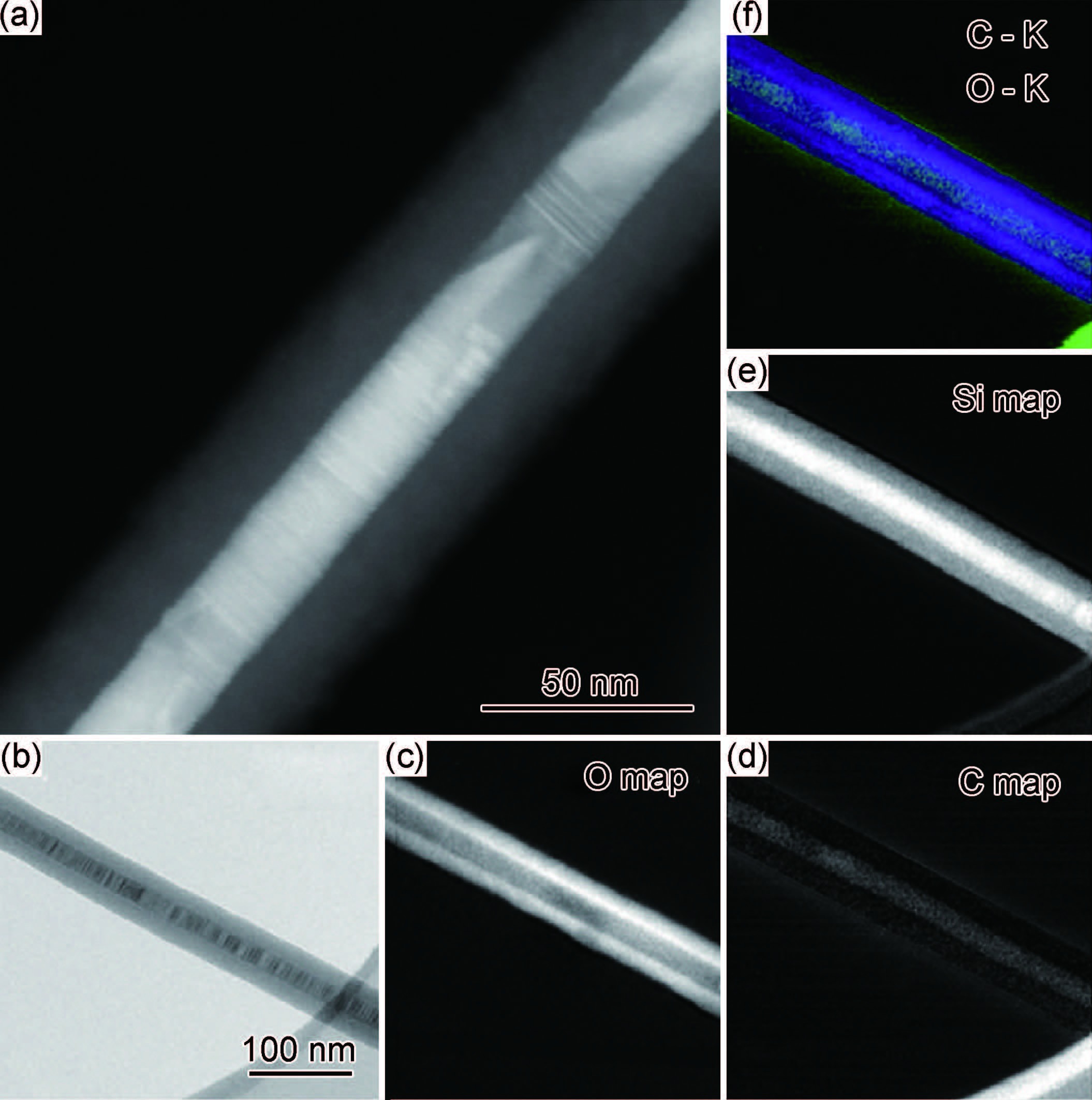
|
图 5 SiC/SiOx纳米线的TEM图像显示的核壳结构 (a)高角度环形暗场图像;(b)零损能量过滤TEM图像;(c),(d),(e)能量过滤TEM图像得到的O,C,Si元素mapping图像;(f)C元素与O元素的混合彩色图像[50, 51] Fig. 5 TEM images of SiC/SiOx nanowires highlighting the core/shell structure (a)STEM-HAADF image;(b)zero-loss EFTEM image;(c),(d),(e)elemental mapping EFTEM images of O,C and Si elements;(f)the map obtained by the colour-mix of the C and O mappings[50, 51] |
SiC量子点在生物荧光领域具有很大的应用潜力,由于有较好的生物相容性、化学稳定性,并且具有稳定、可控的可见光荧光发光性质,目前正被广泛应用于活体细胞成像等生物医学研究[16, 52, 53]。制备SiC量子点的方法包括化学腐蚀、电化学腐蚀、自蔓延燃烧法等[54]。
脉冲激光烧蚀方法是近年来逐渐受到关注的一种SiC量子点制备方法。杨士宽等[55]首次利用激光烧蚀方法制得直径约3.5nm的β-SiC量子点。实验采用Nd:YAG激光器,利用10ns脉冲宽度、10Hz重复频率的1064nm脉冲激光在乙醇中对n型SiC(111)面进行辐照。 Zakharko等[56] 采用钛/红宝石飞秒激光器,波长为800nm,最大半全宽为110fs,重复频率1kHz,最大单脉冲能量为1mJ;多晶3C-SiC靶材被置于水下10mm处,以0.1mm/s速度进行聚焦扫描。朱骏等[57]采用248nm波长准分子激光聚焦辐照多晶6H-SiC靶材,脉冲宽度为10ns,重复频率10Hz辐照2h,制得约2nm直径3C-SiC量子点。脉冲激光烧蚀法制备SiC量子点制备的量子点尺寸可小于5nm,量子点产率较高,制备出的量子点具有良好的光学性能以及良好的表面化学状态。目前需要解决的问题是如何制备出高度分散且尺寸均一的量子点胶体,以精确控制量子点荧光发光的波长范围。
3.2 缺陷态调控SIC发光 3.2.1 SiC一维纳米材料及量子点对于SiC本征缺陷的研究由来已久[24, 58],其中最常见的是具有伪施主性质的D1缺陷,通常产生在SiC受高能离子束轰击(离子、中子或电子)并高温退火后,在低温下有很强的光致辐射,如在4H-SiC的LTPL谱中的L1线2.901eV)[25, 59],如图 6所示。
在室温下,4H-SiC中的层错缺陷同样在2.9eV处导致较强的光致发光[60]。层错是外延生长中常见的缺陷,以(1120)面上(2,33)层错(即在4H-结构中插入1.5个6H-周期)的形式存在,其原子排列形式如图 7(c);通过显微PL mapping技术可以很容易观察到表面的棒状强2.9eV发光区域[61]。层错的发光性质与表面的热氧化相关,而区别于表面激光辐照引起的层错[62]。
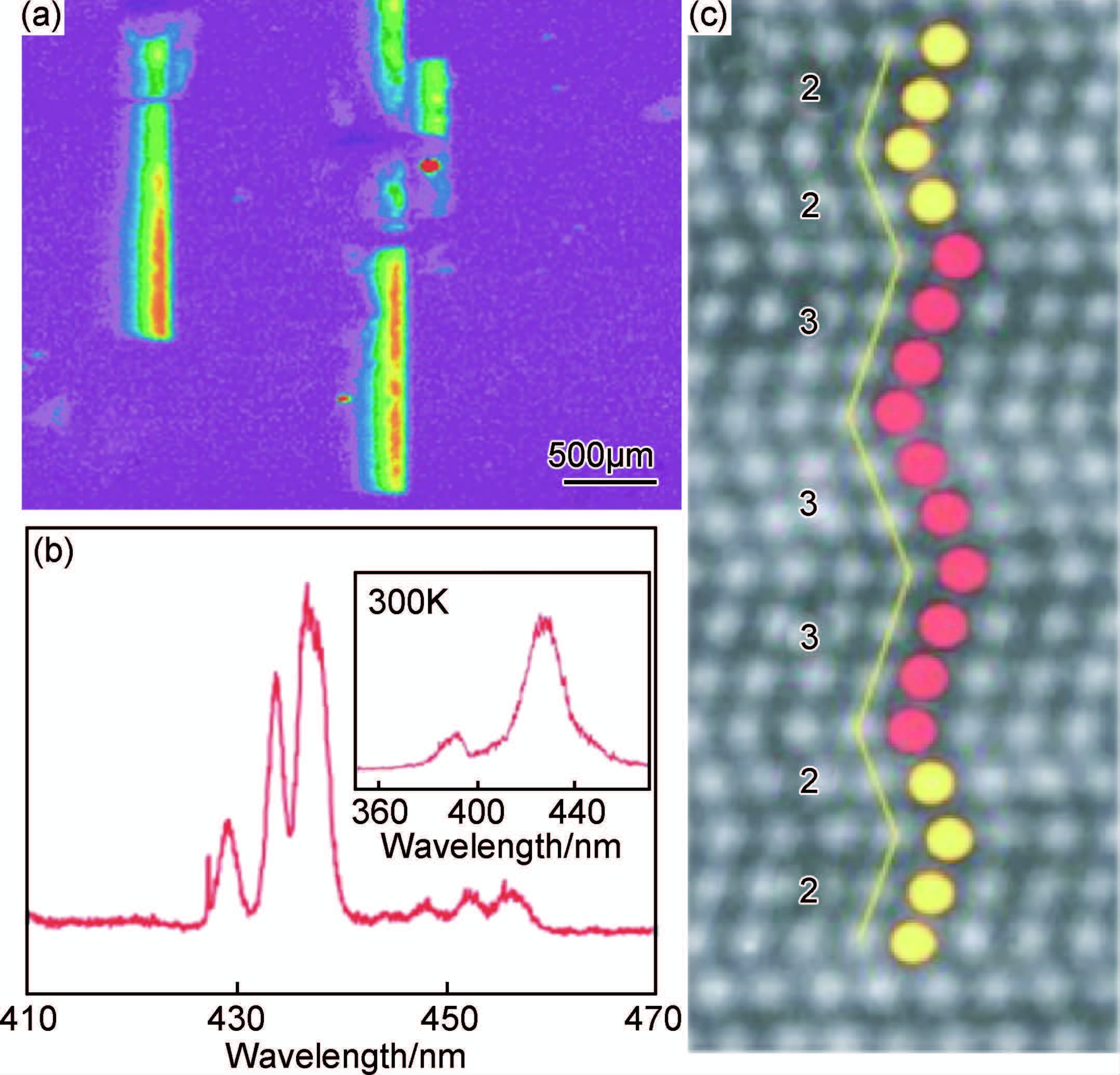
|
图 7 4H-SiC中层错缺陷的发光表征 (a)室温下光子能量为2.9eV的显微光致发光区域;(b)层错缺陷的低温与室温PL发光谱;(c)(2,33)层错的高分辨TEM图像 Fig. 7 Photoluminescence and characterization of stacking fault in 4H-SiC (a)extended micro-photoluminescence mapping at room temperature at 2.9eV;(b)low temperature PL and room temperature PL (inset) peaks of the defect;(c)high-resolution TEM image of the (2,33) stacking fault |
近年来,人们对SiC晶体中的Si空位缺陷(VSi)研究表现出了极大的兴趣,主要由于在室温下VSi可能实现光学操控的相干自旋,以此作为量子比特来进行量子计算[63, 64]。VSi缺陷兼有半导体量子点的技术优势和金刚石色心的量子性质优势,其缺陷的电子自旋量子比特可以利用光学进行重置和读出[65]。VSi通过电子辐照并退火诱导生成,缺陷可以通过低温光致发光光谱中的V1(1.434eV),V2(1.398eV),V3(1.368eV)峰来标定。[12, 66]
3.2.2 掺杂SiC材料的制备过程中会无意识地掺入空气中的N,其掺杂浓度可以人为控制在1014~1020cm-3之间。N元素在SiC材料中形成浅施主能级,造成发光峰位红移,并提高发光效率[67]。另外,通过掺入B或Al元素形成受主能级,SiC中形成发光高量子效率的DAP,即施主-受主掺杂对,是实现高效率光致发光的重要方法。如Kamiyama等[27] 在1900℃下,在商业SiC上生长N-和B-掺杂6H-SiC外延片,由图 8可见,B掺杂较低时,可以在低于100K的温度下同时观察到N-B施主受主对发光峰在630nm,N-Al施主受主对发光峰在480nm。其中,Al可能是生长过程中气氛引入的杂质。在高于100K时N-Al的发光峰迅速消失了。只能观察到N-B施主受主对发光峰,并且这个峰随着温度的上升移动到了576nm。而当B掺杂较高时,在10K到250K温度范围内只能观察到N-B施主受主对这一个发光峰,而且也随温度偏移到576nm,半高宽为110nm,量子效率达95%。
对快速升华法生长的SiC外延片,并进行N和B的掺杂[68],当SiC为低水平p型时,在587nm处有一个较低的半高宽为120nm覆盖整个可见光区域的宽波段发光峰;而当SiC为n型时,在587nm处有很强的施主受主对发光(图 9)。Wellmann等[69]掺杂不同浓度N和B获得荧光SiC材料也得到类似的结果,n型在氮浓度和硼浓度差异最大(4.6×1018)时,PL发光强度最高。并且发现,PL峰强的样品对应的电子寿命越长,n型掺杂要优于p型掺杂。
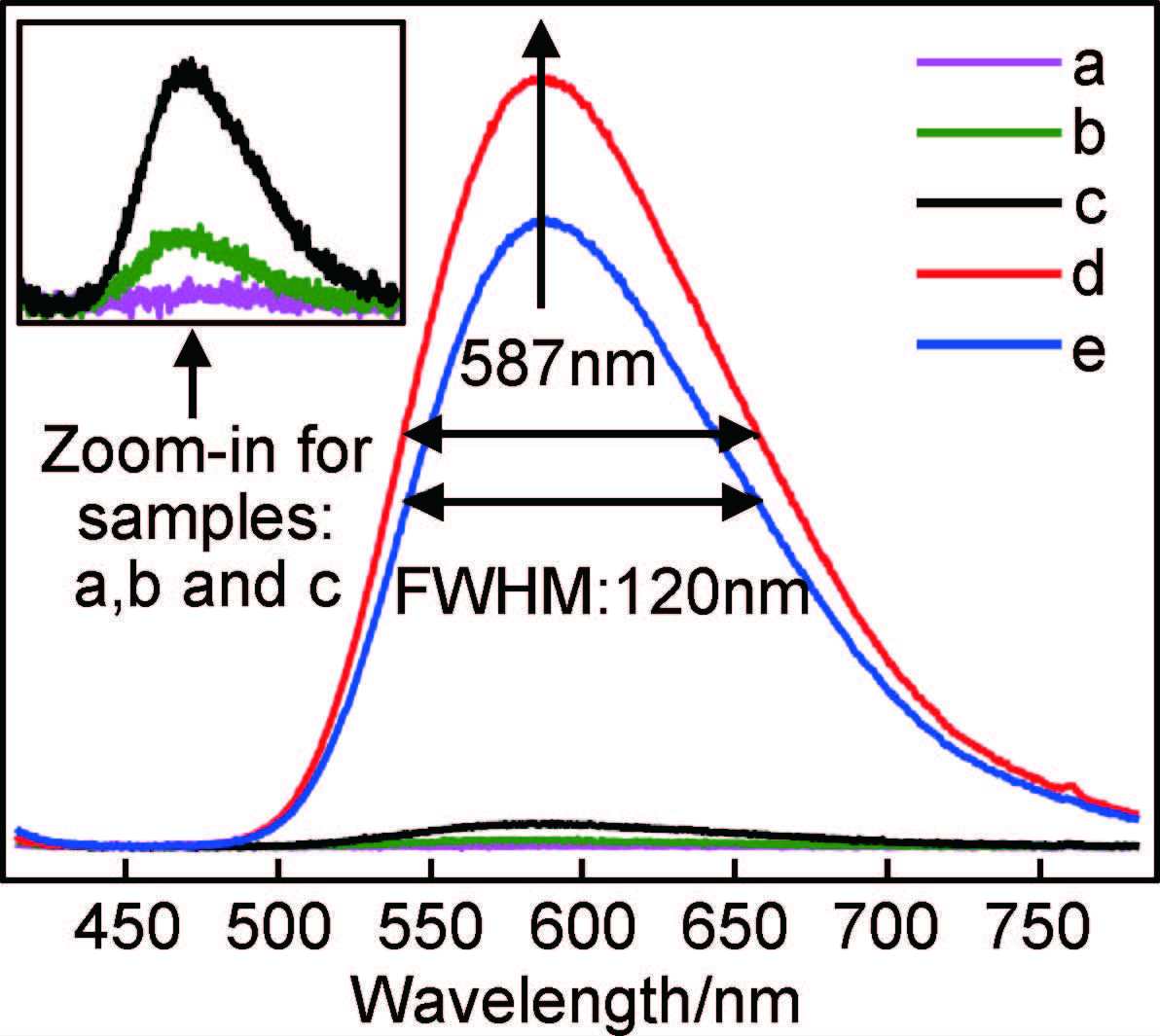
|
图 9 N-B掺杂SiC光致发光谱 Fig. 9 Photoluminescence spectra of N and B-doped SiC |
目前,白光发光二极管主要有3种方式,一种是通过红绿蓝三种芯片混合得到白光,但成本高,技术困难,故障率高。第二种是利用紫外LED激发红绿蓝三色荧光粉获得白光,紫外光波长短、能量高而衍生能量难以控制,对封装材料产生老化的问题。目前普遍使用的是用蓝光LED激发黄色荧光粉实现白光发光,但所使用的荧光粉转换剂在高电流下无法正常工作,而且包含稀土金属,有局限性。荧光SiC为实现单一晶粒无荧光粉白光LED提出了可能[15]。
3.3 表面处理电火花处理6H-SiC形成多孔SiC,其发光特性比未处理样品至少高两个数量级[70],如图 10(d)所示。两个发光峰分别在3.18eV和2.43eV,其中3.18eV被认为是SiC禁带宽度2.9eV的蓝移造成的,这两个发光峰随温度的降低而发生红移。Botsoa等[71]经电化学刻蚀在6H-SiC晶片表面制备出纳米结构(纳米多孔和纳米粉末),观察到了在禁带附近和高于禁带宽度的宽带光致发光峰。Lee等[72]发现p型6H多孔SiC的PL光谱在大约490nm有明显的蓝绿发光带,且随阳极氧化电流密度和腐蚀时间的增加而增强。6H-SiC单晶经过248nm波长准分子激光(功率密度1.08J/cm2)辐照后,其光致发光由黄色转变为蓝色[73]。通过光致发光谱分峰拟合以及XPS、拉曼散射等测试手段,发现材料表面N掺杂浓度提高,并在短脉冲短波长激光辐照下生产硅纳米晶,导致蓝光峰(440nm)发光增强。
(1) SiC半导体材料热导率高、临界击穿电场高,有利于提高器件集成度;而且热稳定性好,抗辐射能力强,所制作的器件可以应用在极端、恶劣条件下。
(2) 禁带宽度大,可以应用在短波长发光,并且有可能制造出整个可见光范围内的发光器件,SiC在紫外探测、光通信、光电子器件、生物医疗等领域有巨大的应用前景。
(3) SiC作为间接带隙半导体,在室温下发光效率很低,可以通过掺杂、纳米晶化实现对SiC能带的调控,调整发光峰峰位并提高SiC的发光效率,而进一步表面处理可以改变SiC宏观光学性质。
| [1] | IZHEVSKYI V A, GENOVA L A, BRESSIANI J C, et al. Review article:silicon carbide structure, properties and processing[J]. Ceramica, 2000, 46 (297): 4–13. |
| [2] | MABOUDIAN R, CARRARO C, SENESKY D G, et al. Advances in silicon carbide science and technology at the micro- and nanoscales[J]. Journal of Vacuum Science & Technology A:Vacuum, Surfaces & Films, 2013, 31 (5): 50805. |
| [3] | Jr^EDDY C R, GASKILL D K. Silicon carbide as a platform for power electronics[J]. Science, 2009, 324 (5933): 1398–1400. DOI: 10.1126/science.1168704 |
| [4] | SIERGIEJ R R, CLARKE R C, SRIRAM S, et al. Advances in SiC materials and devices:an industrial point of view[J]. Materials Science and Engineering:B, 1999, 61-62 : 9–17. DOI: 10.1016/S0921-5107(98)00438-3 |
| [5] | HOMOS T, SON N T, JANZEN E, et al. Theoretical study of small silicon clusters in 4H-SiC[J]. Physical Review B, 2007, 76 (16520916). |
| [6] | TUOMINEN M, PRIEUR E, YAKIMOVA R, et al. Defect analysis in Lely-grown 6H SiC[J]. Journal of Crystal Growth, 1996, 165 (3): 233–244. DOI: 10.1016/0022-0248(96)00188-1 |
| [7] | KIMOTO T, ITOH A, MATSUNAMI H, et al. The effects of N+ dose in implantation into 6H-SiC epilayers[J]. Journal of Electronic Materials, 1995, 24 (4): 235–240. DOI: 10.1007/BF02659681 |
| [8] | GHEZZO M, BROWN D M, DOWNEY E, et al. Boron-implanted 6H-SiC diodes[J]. Applied Physics Letters, 1993, 63 (9): 1206. DOI: 10.1063/1.109772 |
| [9] | TROFFER T, SCHADT M, FRANK T, et al. Doping of SiC by implantation of boron and aluminum[J]. Physica Status Solidi A:Applied Research, 1997, 162 (1): 277–298. DOI: 10.1002/(ISSN)1521-396X |
| [10] | BRANDER R W, SUTTON R P. Solution grown SiC p-n junctions[J]. Journal of Physics D Applied Physics, 1969, 2 (3): 309–318. DOI: 10.1088/0022-3727/2/3/301 |
| [11] | DMITRIEV V A, MOROZENKO Y V, POPOV I V, et al. Three-color blue-green-red display made from one single crystal[J]. Soviet Technical Physics Letters, 1986, 12 : 221. |
| [12] | FUCHS F, SOLTAMOV V A, VÄTH S, et al. Silicon carbide light-emitting diode as a prospective room temperature source for single photons[J]. Scientific Reports, 2013, 3 (4): 1637. |
| [13] | EISAMAN M D, FAN J, MIGDALL A, et al. Invited review article:Single-photon sources and detectors[J]. Review of Scientific Instruments, 2011, 82 (7): 71101. DOI: 10.1063/1.3610677 |
| [14] | SATOSHI K, MOTOAKI I, TETSUYA T, et al. Fluorescent SiC and its application to white light-emitting diodes[J]. Journal of Semiconductors, 2011, 32 (1): 13001–13004. DOI: 10.1088/1674-4926/32/1/013001 |
| [15] | KAMIYAMA S, IWAYA M, TAKEUCHI T, et al. White light-emitting diode based on fluorescent SiC[J]. Thin Solid Films, 2012, 522 : 23–25. DOI: 10.1016/j.tsf.2012.02.017 |
| [16] | FAN J, LI H, JIANG J, et al. 3C-SiC nanocrystals as fluorescent biological labels[J]. Small, 2008, 4 (8): 1058–1062. DOI: 10.1002/smll.v4:8 |
| [17] | SERDIUK T, LYSENKO V, SKRYSHEVSKY V A, et al. Vapor phase mediated cellular uptake of sub 5 nm nanoparticles[J]. Nanoscale Research Letters, 2012, 7 : 212. DOI: 10.1186/1556-276X-7-212 |
| [18] | BRUS L E. A simple model for the ionization potential, electron affinity, and aqueous redox potentials of small semiconductor crystallites[J]. The Journal of Chemical Physics, 1983, 79 (11): 5566. DOI: 10.1063/1.445676 |
| [19] | 何海平. 单晶碳化硅薄膜制备及二氧化硅基复合体系的光致发光研究[D]. 合肥:中国科学技术大学, 2004. HE H P. Preparation of simgle-crystal SiC/SiO2 compound thin film and photoluminescence research[D]. Hefei:University of Science and Technology of China, 2004. |
| [20] | FENG D H, XU Z Z, JIA T Q, et al. Quantum size effects on exciton states in indirect-gap quantum dots[J]. Physical Review B, 2003, 68 (0353343). |
| [21] | REBOREDO F A, GALLI G. Theory of alkyl-terminated silicon quantum dots[J]. The Journal of Physical Chemistry B, 2005, 109 (3): 1072–1078. DOI: 10.1021/jp0462254 |
| [22] | CUI L, LI J J, SUN J, et al. High-density SiC nanocrystals with strong photoluminescence via a nitrogen-loss route[J]. Semiconductor Science and Technology, 2008, 23 (3): 35015. DOI: 10.1088/0268-1242/23/3/035015 |
| [23] | CAMASSEL J, JUILLAGUET S, ZIELINSKI M, et al. Application of LTPL investigation methods to CVD-grown SiC[J]. Chemical Vapor Deposition, 2006, 12 (8-9): 549–556. DOI: 10.1002/(ISSN)1521-3862 |
| [24] | PATRICK L, CHOYKE W J. Photoluminescence of radiation defects in ion-implanted 6H SiC[J]. Physical Review B (Solid State), 1972, 5 (8): 3253–3259. DOI: 10.1103/PhysRevB.5.3253 |
| [25] | HABERSTROH C, HELBIG R, STEIN R A. Some new features of the photoluminescence of SiC(6H), SiC(4H), and SiC(15R)[J]. Journal of Applied Physics, 1994, 76 (1): 509. DOI: 10.1063/1.357103 |
| [26] | MOORE W J. Identification and activation energies of shallow donors in cubic SiC[J]. Journal of Applied Physics, 1993, 74 (3): 1805. DOI: 10.1063/1.354785 |
| [27] | KAMIYAMA S, MAEDA T, NAKAMURA Y, et al. Extremely high quantum efficiency of donor-acceptor-pair emission in N-and-B-doped 6H-SiC[J]. Journal of Applied Physics, 2006, 99 (9): 93108. DOI: 10.1063/1.2195883 |
| [28] | 物理所成功研制6英寸碳化硅单晶衬底[EB/OL], http://www.bjb.cas.cn |
| [29] | WIJESUNDARA M B J, AZEVEDO R. Silicon Carbide Microsystems for Harsh Environments[M]. 2011: 37-52. |
| [30] | CHAUSSENDE D, BAILLET F, CHARPENTIER L, et al. Continuous feed physical vapor transport-toward high purity and long boule growth of SiC[J]. Journal of The Electrochemical Society, 2003, 150 (10): G653–G657. DOI: 10.1149/1.1606689 |
| [31] | WELLMANN P, DESPERRIER P, MüLLER R, et al. SiC single crystal growth by a modified physical vapor transport technique[J]. Journal of Crystal Growth, 2005, 275 (1-2): e555–e560. DOI: 10.1016/j.jcrysgro.2004.11.070 |
| [32] | HOFMANN D, SCHMITT E, BICKERMANN M, et al. Analysis on defect generation during the SiC bulk growth process[J]. Materials Science & Engineering B, 1999, 61 : 48–53. |
| [33] | SCHMID F, PENSL G. Comparison of the electrical activation of P + and N + ions co-implanted along with Si + or C + ions into 4H-SiC[J]. Applied Physics Letters, 2004, 84 (16): 3064. DOI: 10.1063/1.1707220 |
| [34] | YAMADA H. Low-temperature 3C-SiC heteroepitaxial film growth on Si by reactive-ion-beam deposition[J]. Journal of Applied Physics, 1989, 65 (5): 2084. DOI: 10.1063/1.342854 |
| [35] | KITABATAKE M, DEGUCHI M, HIRAO T. Simulations and experiments of SiC heteroepitaxial growth on Si (001) surface[J]. Journal of Applied Physics, 1993, 74 (7): 4438. DOI: 10.1063/1.354385 |
| [36] | SUN G S, LIU X F, WANG L, et al. Multi-wafer 3C-SiC heteroepitaxial growth on Si (100) substrates[J]. Chinese Physics B, 2010 (08): 614–618. |
| [37] | NISHINO S. Production of large-area single-crystal wafers of cubic SiC for semiconductor devices[J]. Applied Physics Letters, 1983, 42 (5): 460. DOI: 10.1063/1.93970 |
| [38] | ITOH A, AKITA H, KIMOTO T, et al. High-quality 4H-SiC homoepitaxial layers grown by step-controlled epitaxy[J]. Applied Physics Letters, 1994, 65 (11): 1400. DOI: 10.1063/1.112064 |
| [39] | SPANIER J E, DUNNE G T, ROWLAND L B, et al. Vapor-phase epitaxial growth on porous 6H-SiC analyzed by Raman scattering[J]. Applied Physics Letters, 2000, 76 (26): 3879. DOI: 10.1063/1.126807 |
| [40] | LI Z, ZHANG J, HE H, et al. Blue-green luminescence and SERS study of carbon-rich hydrogenated amorphous silicon carbide films with multiphase structure[J]. Physica Status Solidi (a), 2010, 207 (11): 2543–2548. DOI: 10.1002/pssa.v207:11 |
| [41] | ZHANG Y, NISHITANI-GAMO M, XIAO C, et al. Synthesis of 3C-SiC nanowhiskers and emission of visible photoluminescence[J]. Journal of Applied Physics, 2002, 91 (9): 6066. DOI: 10.1063/1.1468278 |
| [42] | 于威, 崔双魁, 路万兵, 等. 纳米6H-SiC薄膜的等离子体化学气相沉积及其紫外发光[J]. 半导体学报, 2006 (): 1767–1770. YU W, CUI S K, LU W B, et al. Plasma enhanced chemical vapor deposition an ultraviolet luminescence of nanocrystalline 6H-SiC thin films[J]. Chinese Journal of Semicondutors, 2006 (10): 1767–1770. |
| [43] | CHOYKE W J, FENG Z C, POWELL J A. Low-temperature photoluminescence studies of chemical-vapor-deposition-grown 3C-SiC on Si[J]. Journal of Applied Physics, 1988, 64 (6): 3163. DOI: 10.1063/1.341532 |
| [44] | FAN J Y, LI H X, WANG Q J, et al. UV-blue photoluminescence from close-packed SiC nanocrystal film[J]. Applied Physics Letters, 2011, 98 (8): 81913. DOI: 10.1063/1.3556657 |
| [45] | MILEWSKI J V, GAC F D, PETROVIC J J, et al. Growth of beta-silicon carbide whiskers by the VLS process[J]. Journal of Materials Science, 1985, 20 (4): 1160–1166. DOI: 10.1007/BF01026309 |
| [46] | ZHOU J, CHEN Z, ZHOU M, et al. SiC nanorods grown on electrospun nanofibers using tb as catalyst:fabrication, characterization, and photoluminescence properties[J]. Nanoscale Research Letters, 2009, 4 (8): 814–819. DOI: 10.1007/s11671-009-9320-z |
| [47] | LI Z, ZHANG J, MENG A, et al. Large-area highly-oriented SiC nanowire arrays:Synthesis, Raman, and photoluminescence properties[J]. The Journal of Physical Chemistry B, 2006, 110 (45): 22382–22386. DOI: 10.1021/jp063565b |
| [48] | HU J Q, LU Q Y, TANG K B, et al. Synthesis and characterization of SiC Nanowires through a reduction-carburization route[J]. The Journal of Physical Chemistry B, 2000, 104 (22): 5251–5254. DOI: 10.1021/jp000124y |
| [49] | XI G, PENG Y, WAN S, et al. Lithium-assisted synthesis and characterization of crystalline 3C-SiC nanobelts[J]. The Journal of Physical Chemistry B, 2004, 108 (52): 20102–20104. DOI: 10.1021/jp0462153 |
| [50] | FABBRI F, ROSSI F, LAGONEGRO P, et al. 3C-SiC nanowires luminescence enhancement by coating with a conformal oxides layer[J]. Journal of Physics D:Applied Physics, 2014, 47 (39): 871–880. |
| [51] | FABBRI F, ROSSI F, ATTOLINI G, et al. Enhancement of the core near-band-edge emission induced by an amorphous shell in coaxial one-dimensional nanostructure:the case of SiC/SiO2 core/shell self-organized nanowires[J]. Nanotechnology, 2010, 21 (34): 345702. DOI: 10.1088/0957-4484/21/34/345702 |
| [52] | BOTSOA J, LYSENKO V, GELOEN A, et al. Application of 3C-SiC quantum dots for living cell imaging[J]. Applied Physics Letters, 2008, 92 (17): 173902. DOI: 10.1063/1.2919731 |
| [53] | TORRES-RAYA C, HERNANDEZ-MALDONADO D, RAMIREZ-RICO J, et al. Fabrication, chemical etching, and compressive strength of porous biomimetic SiC for medical implants[J]. Journal of Materials Research, 2008, 23 (12): 3247–3254. DOI: 10.1557/JMR.2008.0392 |
| [54] | FAN J, LI H, WANG J, et al. Fabrication and photoluminescence of SiC quantum dots stemming from 3C, 6H, and 4H polytypes of bulk SiC[J]. Applied Physics Letters, 2012, 101 (13): 131906. DOI: 10.1063/1.4755778 |
| [55] | YANG S, CAI W, ZENG H, et al. Ultra-fine β-SiC quantum dots fabricated by laser ablation in reactive liquid at room temperature and their violet emission[J]. Journal of Materials Chemistry, 2009, 19 (38): 7119. DOI: 10.1039/b909800c |
| [56] | ZAKHARKO Y, SERDIUK T, NYCHYPORUK T, et al. Plasmon-enhanced photoluminescence of SiC quantum dots for cell imaging applications[J]. Plasmonics, 2012, 7 (4): 725–732. DOI: 10.1007/s11468-012-9364-2 |
| [57] | ZHU J, HU S, XIA W, et al. Photoluminescence of~2nm 3C-SiC quantum dots fabricated from polycrystalline 6H-SiC target by pulsed laser ablation[J]. Materials Letters, 2014, 132 : 210–213. DOI: 10.1016/j.matlet.2014.06.073 |
| [58] | CHOYKE W J, PATRICK L. Photoluminescence of radiation defects in cubic SiC:localized modes and Jahn-Teller effect[J]. Physical Review B, 1971, 4 (6): 1843–1847. DOI: 10.1103/PhysRevB.4.1843 |
| [59] | JANZéN E, IVANOV I G, SON N T, et al. Defects in SiC[J]. Physica B:Condensed Matter, 2003, 340 (340-342): 15–24. |
| [60] | HOSHINO N, TAJIMA M, NISHIGUCHI T, et al. Nondestructive analysis of propagation of stacking faults in SiC bulk substrate and epitaxial layer by photoluminescence mapping[J]. Japanese Journal of Applied Physics Part 2-Letters & Express Letters, 2007, 46 (36-40): L973–L975. |
| [61] | HIRANO R, SATO Y, TAJIMA M, et al. Structural and electronic characterization of (2, 33) bar-shaped stacking fault in 4H-SiC epitaxial layers[J]. Applied Physics Letters, 2011, 98 (5): 51915. DOI: 10.1063/1.3551542 |
| [62] | YAMAGATA H, YAGI S, HIJIKATA Y, et al. Micro-photoluminescence study on the influence of oxidation on stacking faults in 4H-SiC epilayers[J]. Applied Physics Express, 2012, 5 (0513025). |
| [63] | RIEDEL D, FUCHS F, KRAUS H, et al. Resonant addressing and manipulation of silicon vacancy qubits in silicon carbide[J]. Physical Review Letters, 2012, 109 (22). |
| [64] | BAGRAEV N, DANILOVSKⅡ E, GETS D, et al. N-V Si-related center in non-irradiated 6H SiC nanostructure[J]. AIP Conference Proceedings, 2014, 1 (1586): 243–247. |
| [65] | BARANOV P G, BUNDAKOVA A P, SOLTAMOVA A A, et al. Silicon vacancy in SiC as a promising quantum system for single-defect and single-photon spectroscopy[J]. Physical Review B, 2011, 83 (12): 5121–5124. |
| [66] | WAGNER M, MAGNUSSON B, CHEN W M, et al. Electronic structure of the neutral silicon vacancy in 4H and 6H SiC[J]. Physical Review B, 2000, 62 (24): 16555–16560. DOI: 10.1103/PhysRevB.62.16555 |
| [67] | SHIRAMOMO T, GAO B, MERCIER F, et al. Study of the effect of doped impurities on polytype stability during PVT growth of SiC using 2D nucleation theory[J]. Journal of Crystal Growth, 2014, 385 : 95–99. DOI: 10.1016/j.jcrysgro.2013.03.036 |
| [68] | OU Y, JOKUBAVICIUS V, KAMIYAMA S, et al. Donor-acceptor-pair emission characterization in N-B doped fluorescent SiC[J]. Optical Materials Express, 2011, 1 (8): 1439. DOI: 10.1364/OME.1.001439 |
| [69] | WELLMANN P, KAISR M, SYV J RVI M, et al. Fluorescent SiC as a new material for white LEDs[J]. Physica Scripta, 2012, T148 : 14002. DOI: 10.1088/0031-8949/2012/T148/014002 |
| [70] | CHANG S, SAKAI A. Luminescence properties of spark-processed SiC[J]. Materials Letters, 2004, 58 (7-8): 1212–1217. DOI: 10.1016/j.matlet.2003.08.037 |
| [71] | BOTSOA J, BLUET J M, LYSENKO V, et al. Photoluminescence of 6H-SiC nanostructures fabricated by electrochemical etching[J]. Journal of Applied Physics, 2007, 102 (8): 83526. DOI: 10.1063/1.2798531 |
| [72] | LEE K, LEE S, JEON K. Photoluminescent properties of silicon carbide and porous silicon carbide after annealing[J]. Applied Surface Science, 2009, 255 (8): 4414–4420. DOI: 10.1016/j.apsusc.2008.11.047 |
| [73] | WU Y, JI L, LIN Z, et al. Blue photoluminescence enhancement in laser-irradiated 6H-SiC at room temperature[J]. Applied Physics Letters, 2014, 104 (4): 41906. DOI: 10.1063/1.4863437 |
 2017, Vol. 45
2017, Vol. 45