文章信息
- 王小京, 刘彬, 周慧玲, 王俭辛, 刘宁, 李天阳
- WANG Xiao-jing, LIU Bin, ZHOU Hui-ling, WANG Jian-xin, LIU Ning, LI Tian-yang
- P对Sn-Bi合金组织与性能的影响
- Effect of P on Microstructure and Mechanical Properties of Sn-Bi Solder
- 材料工程, 2016, 44(7): 113-118
- Journal of Materials Engineering, 2016, 44(7): 113-118.
- http://dx.doi.org/10.11868/j.issn.1001-4381.2016.07.019
-
文章历史
- 收稿日期: 2014-07-25
- 修订日期: 2015-11-05
2. 华为技术有限公司 坂田华为基地, 广东 深圳 518129
2. Bantian Huawei Base, Huawei Technologies Co., Ltd., Shenzhen 518129, Guangdong, China
锡铋二元合金的共晶成分为Sn-58Bi(质量分数/%,下同),共晶温度为138℃,属于低熔点焊料合金,可用于低温的服役条件。在室温下共晶Sn-Bi合金组织为Bi相和固溶约为4%Bi的Sn相组成。在电子行业无铅化产业升级中,锡铋合金以其低熔点(适合笔记本散热热管冷却技术)、较好的热蠕变性能成为笔记本散热模组用无铅热界面材料[1-3],伴随着封装技术的发展与表面贴装技术在不同领域的推广,锡铋合金产品已经进入汽车电子领域、太阳能光伏领域,成为LED灯管贴装用的主要无铅焊料。开发出的Sn-Bi-Ag系(以Sn-35Bi-1Ag为代表)、Sn-Bi-Cu系(以Sn-30Bi-0.5Cu,Sn-40Bi-0.1Cu,Sn-17Bi-0.5Cu为主)两大系列产品,市场份额不断加大,成长为焊料体系中一个重要分支。但同时也注意到,较低的导热系数、服役过程中的组织粗化、合金液态氧化以及Bi元素在界面处的偏聚均限制了Sn-Bi合金的进一步应用[4, 5]。事实上,降低铋含量是提高导热系数、调节熔点范围的一个有效方法[6, 7]。服役中的组织界面不稳定问题则往往可以通过弥散粒子的引入得到缓解[4, 8],微合金化元素P,Ge则分别被用来改善低温(Sn-Bi系)和中温(Sn-Ag-Cu系)合金的液态氧化性[9, 10],但P元素的加入对合金组织、性能的影响有待进一步的实验研究。因此,本工作将在降低Bi含量和提高合金化的基础上考察P元素对合金组织与性能的综合影响。
1 实验材料与方法 1.1 合金制备按比例称取纯Sn、纯Bi以及所需的Cu(或Zn粒、Sn-2.5P合金)等,放置于试样盒中备用;将称好的合金按比例叠放在石墨舟中真空熔炼。熔炼过程中所用的参数为:真空压强0.133Pa,加热温度600℃,熔化后保温30min;待试样冷却后取出条块状合金进行翻面,随后在同样参数下进行二次熔炼,使合金元素混合得更为均匀。通过以上的制备方法,冷却后分别获得以下各成分的实验用合金:Sn-1P(SP),Sn-40Bi(SB),Sn-40Bi-0.1P(SBP),Sn-40Bi-2Zn-0.3Cu-0.005P (SBZCP1)以及Sn-40Bi-2Zn-0.3Cu-0.5P(SBZCP2)。
1.2 组织形貌、断口观察样品组织和形貌观察采用光学显微镜(OM)进行,并将样品观察分为原始组织形貌观察和断口表面观察。化合物观察采用10%硝酸酒精腐蚀液进行浸蚀;组织与晶界观察则需采用FeCl3腐蚀液,并用吸管滴浇的方法腐蚀。注意避免使用棉球擦蚀,以防由于擦拭摩擦而对样品表面造成损伤。
断口观察采用景深更大的扫描电子显微镜(SEM,JSM-6480)进行;结构物像分析在X射线衍射仪上进行(XRD-6000)。
1.3 拉伸实验将炼成的合金板块切割成标准拉伸试样,在MST试验机上进行拉伸实验,测试过程中采用的夹头位移速率为0.5mm/min。
2 结果与分析 2.1 组织形貌分析图 1(a),(b)分别为纯Sn与Sn-1P的微观组织形貌。可以看出,在合金化前,纯Sn呈现出较为粗大的等轴晶粒组织,其平均晶粒大小为40μm。添加1%的P之后,纯锡的组织形貌发生了变化,在β-Sn基体上出现了白色网状物。根据Sn-P合金相图可知,在高温冶金状态下P会首先在Sn基体中形成P3Sn4相。该化合物在Sn-2.5P母合金的熔炼中已存在,在后续的合金化过程中成为Sn-P化合物的形核核心,进一步促使化合物长大。这一过程导致周围区域因缺P而长大为β-Sn树枝晶,排出多余的P原子;多余的P原子则随着β-Sn树枝晶的长大,浓度提高而距离原始P-Sn化合物相越近(SnP或P3Sn4相),进而连接、长大,形成网状结构分布在β-Sn基体上。结合图 1(a)中的纯锡晶粒尺度,有理由认为光学显微镜下Sn-1P的组织为白色Sn-P化合物(主要为P3Sn4)相呈网状分布在β-Sn基体上。对比X射线衍射结果(见图 2(a)),可以看出该Sn-P化合物为P3Sn4和少量的SnP相。

|
图 1 含磷Sn-Bi系列合金的光学显微组织形貌 Fig. 1 Microstructures of Sn-Bi base alloys with P contained |
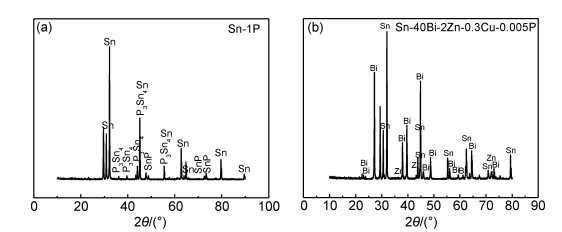
|
图 2 XRD衍射图谱 (a)Sn-1P;(b)Sn-40Bi-2Zn-0.3Cu-0.005P Fig. 2 XRD patterns of Sn-1P(a) and Sn-40Bi-2Zn-0.3Cu-0.005P(b) |
图 1(c),(d)分别为Sn-40Bi和Sn-40Bi-0.1P在光学显微镜下的组织形貌。图中白色鱼骨状的为富Bi相、其余灰色为富Sn相,两相共生的区域为共晶组织。和典型的Sn-58Bi共晶组织相比,Sn-40Bi合金的Bi含量降低到40%,其组织中共晶组织减少,非共晶部分区域的Bi以颗粒状或短杆状分布在Sn基体上。在冷却凝固过程中,Sn-40Bi合金由液态转变为β-Sn与Sn-Bi共晶相。当添加0.1%P时,合金组织变得更细,表现为共晶网格尺寸变小,β-Sn枝晶变得更为均匀。其凝固过程也发生了β-Sn,Sn-Bi共晶相的转变,但同时应该还有部分Sn-P化合物,因为P在Sn中的溶解度几乎可以忽略,通常以化合物的形式存在。虽然没有直接观察到该化合物的存在,但从SBP的组织与相图可以推测出0.1%P的确有很重要的作用。这一结论和Zhou等[11]的研究一致,他们认为当0.5%P加入Sn-8Zn-3Bi合金时,能够促进针状组织的生长,细化富Bi相,并在晶界附近观察到了SnP3的峰。Xian等[10]在考察Sn-0.005P合金的液态氧化性时,采用XPS衍射图谱在氧化薄膜内发现P2p3/2的峰,但由于SnP3或P3Sn4的XPS衍射谱目前很难检测到,但可以证明P的存在形式。
比较图 1(e),(f)与图 1(c),(d),会发现Zn的加入会形成黑色杆状或针状物的富Zn相。Cu的添加会在焊料中形成白色多角状的Cu6Sn5相。而Zn/Cu/P的共同作用使SBZCP1与SBZCP2的组织变得更为细小。其中,SBZCP1合金的XRD衍射图谱如图 2(b)所示。图中可以看到Sn,Bi和Zn相的衍射峰,而Cu和P形成的化合物相则由于含量较低而没有体现。比较图 1(c),(e)共晶区域的富Bi相形貌会发现,富Bi相已由合金化之前的鱼骨状变为类短杆状或者颗粒状,以近均匀的形式分布在Sn基体上。
因此,可以看出P元素单独加入或者P,Cu,Zn三种元素同时加入Sn-40Bi合金,均可起到细化组织的作用。值得关注的是,在图 1(e),(f)中,看到白色中空的多角状物质,根据相图与文献[8]报道,知道该物质为Cu6Sn5化合物。
2.2 拉伸性能图 3所示为锡基合金焊料及其对应含P合金焊料的拉伸工程应力-应变曲线。可以看出,Sn-Bi系列焊料的拉伸曲线在弹塑性形变阶段,应力随应变呈增大趋势;材料屈服后,可以看到加工硬化的现象,但硬化范围较小;对于含铋合金而言,在UTS点过后的曲线迅速下降。其中, SBZCP合金变化非常明显,含P量为0.5%的SBZCP2合金直接在UST点断裂,没有出现任何颈缩现象。含P量0.005%的SBZCP1合金出现很窄的流变区,在UTS点后仅经过0.75%的应变即发生断裂(3.307%~4.06%)。对比观察纯锡和SP合金的拉伸曲线发现,这两种合金焊料均能达到稳态流变过程。纯锡曲线在流变区的硬化较软化过程稍突出,SP合金则相反,在稳态流变过程中,软化过程表现得更为明显,两者均表现出很宽的稳态塑性流变区,合金的塑性变形很大一部分来源于出现微观颈缩后的变形。
焊料拉伸形变过程中,第一个阶段为弹性变形阶段,这个阶段中的弹性模量是一个重要的参数,它可以决定一个连接体在加载过程中所能承担的弹性变形的量[12]。弹性模量是一个相对比较稳定的参数,它的值对材料微观组织结构改变不太敏感,因为弹性模量是直接与晶格中原子键合力相关的量。
Kilinski等[13]指出,在应变速率较低的情况下,焊料拉伸应力-应变曲线的初始阶段的斜率应该由弹性变形和蠕变变形所决定,因此采用应力-应变曲线所得到的弹性模量值是不精确的,但其相对数据却可作为类比的参考数据。总的来说,在室温条件下本实验所用Sn-Bi系列合金的弹性模量为:57.11~89.20GPa。而纯锡的弹性模量为20.15GPa,加入1%P之则达到56.57GPa。近年来,随着Sn-Ag-Cu合金的广泛使用,发现由这种合金组成的BGA封装体的跌落失效率是Sn-Pb合金的几倍[14-16],文献[15]认为Sn-Ag-Cu的弹性模量太大致使合金太“硬”,从而使焊料在冲击过程中吸收塑性功能力变差。
无铅焊料的最大抗拉强度(UTS)为在拉伸过程中材料所表现的最大应力。与弹性模量不同,焊料的最大拉伸强度受成分、组织、加载历史、加载速率、温度等因素的影响[17, 18]。本工作则表现为成分和组织的影响,具体数据见表 1。
| Alloy | Elastic modulus/GPa | UTS/MPa | Fracture strain/% |
| SBZCP1 | 89.20 | 79.16 | 4.06 |
| SBZCP2 | 85.60 | 68.54 | 2.02 |
| Sn-40Bi | 61.93 | 65.23 | 22.64 |
| SBP | 74.20 | 21.25 | 5.45 |
| Sn | 20.15 | 26.99 | 76.74 |
| SP | 56.57 | 28.79 | 43.31 |
| Sn-58Bi | 57.11 | 66.60 | 21.83 |
一般而言,为了提高无铅焊料合金的强度值,通常采取在合金组织中添加其他元素或者调整合金成分的比例来达到强化的目的[19]。如图 3所示,比较Sn-58Bi与Sn-40Bi的拉伸曲线,发现当Bi含量由58%降低到40%时,合金强度降低,断裂应变增大[20],降低和增大幅度均较小;其次,在Sn-40Bi合金基础上,添加0.1%的P, 得到Sn-40Bi-0.1P合金。与Sn-40Bi合金曲线比较,发现Sn-40Bi-0.1P合金强度约降低了2/3,断裂应变则降低了3/4左右;而在以纯锡为基础的SP合金中,P元素的加入,使得合金强度增大,断裂应变降低,这和纯锡基体特性有关;进而以Sn-40Bi-2Zn-0.3Cu为基础合金,分别添加不同含量的P时,得到当P含量从0.005%升高到0.5%时,合金强度与断裂应变均有降低。
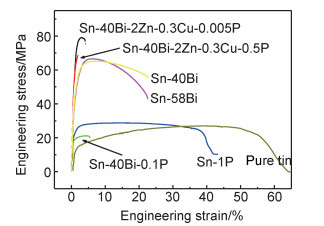
|
图 3 工程应力-应变曲线 Fig. 3 Engineering stress-strain curves |
因此,结合合金组织认为Zn,Cu等起固溶强化的作用,使Bi的分布更均匀细小;同时合金化元素Cu,Zn能与Sn或焊点下金属形成Sn-Cu, Zn-Cu金属间化合物(IMCS)促进液态合金异质形核[8],提高形核率,细化晶粒,使合金的显微组织更加均匀、细致,改善了合金塑性,从而提高焊点强度。微合金化元素P单独或与Cu,Zn共同加入Sn-Bi基合金焊料,能够细化组织,但会降低强度与塑性。这可能和P在Sn-Bi合金中的存在形式以及P元素本身的性能有关。微量P元素的加入,促进Sn-Cu共晶焊点中的孔洞形成速率[21],而这些孔洞的存在又为合金焊料(或相应焊点结构)在外加载荷作用下的裂纹的萌生或扩展提供了可能。本实验表明P在焊料中以Sn-P化合物的形式存在,并优先分布在相界或晶界上。这一点从含P合金的组织与断裂表面的层状结构可以得到证实。
2.3 断裂图 4(a)示出了纯锡拉伸试样断口特征,表现为延性断裂,断口颈缩严重,甚至没有断面而呈断裂线,与拉伸载荷方向接近垂直方向,为平面应力状态下的延性断裂形貌。添加1%P后,断口表面出现韧窝形貌(见图 4(b)),由中心的Sn-P化合物粒子和韧窝脊组成,韧窝尺寸较大,约为20~40μm,示出了合金在断裂之前经过了较长时间的失稳塑性形变过程。其断裂过程应该是由Sn-P粒子处萌生,然后经过微观颈缩的转移、扩散,最终微裂纹在外加拉伸载荷作用下连接起来,最终导致合金失效。这和应力-应变曲线中的断裂应变分别为76.74%与43.31%吻合。

|
图 4 合金拉伸断口形貌 Fig. 4 Fracture surfaces of solder alloys |
Sn-40Bi合金具有延性断裂的特征(见图 4(c)),断口总体表现为颗粒状,具体表现为不同衬度的颗粒状凸起。其中,颜色稍浅发白的粒子外形轮廓不清晰,表面黏滞不光滑,带有黏塑性特征;颜色稍暗发灰的粒子则呈光滑解理特征。与Sn-1P合金比较,断口宏观平整,颗粒尺寸较小,合金在断裂之前经历的塑性变形小;其裂纹萌生位置应该在Sn,Bi两相界面处;由于Sn和Bi两种材质本身硬度、弹性模量等力学参数差别很大,在形变过程中,Sn,Bi两相的形变失配,导致Sn/Bi界面处应力集中,进而产生裂纹,最终沿着相界或穿过较软的Sn相连接起来,导致合金断裂失效。与图 4(c)比较可以看出,添加0.1%P后的SBP合金的断口发生了很大改变(图 4(d)),由具有延性特征的断口变为层状脆性断口。根据前面的描述,P的添加会在合金的界面处形成Sn-P化合物,这些脆性粒子在界面处的分布,进一步弱化合金界面处的结合力,降低了合金强度以及断裂韧性。
由组织形貌可知,Zn,Cu,P三种合金元素的加入,可以细化Sn-40Bi合金组织,提高强度(屈服强度和UTS)。但当P含量从0.005增加到0.5时,合金元素添加后形成的SBZCP合金强度提高不多,断裂应变却损失一半左右。这些变化趋势从断口也有一定程度的反应。分别比较图 4(c),(e)与图 4(d),(f)会发现,除了SBZCP合金的断口上的粒状、层状结构的尺度变大外,其他基本特征较一致,即SBZCP合金的断裂需要的时间更短。这与应力-应变曲线表现出来的趋势一致。
3 结论(1) 在锡基或Sn-Bi基合金中,P以Sn-P化合物(P3Sn4为主)的形式分布在相界或晶界上,限制载荷作用下合金的形变扩散与转移。在Sn-1P合金中,分布在β-Sn基体上的Sn-P化合物,起强化作用;而在Sn-40Bi为基础成分的合金中,Sn-P化合物则加剧加载过程中的形变不匹配,成为裂纹萌生与扩展的薄弱环节,使合金倾向于脆性断裂。
(2) 加入一定量的合金化元素Cu,Zn可以改善Sn-Bi合金系列的微观组织,提高强度,增加合金最大流变应力,但P的加入会增大合金脆性,使合金断口呈现层状结构。
| [1] | TONG X C. Thermal Interface Materials in Electronic Packaging, in Advanced Materials for Thermal Management of Electronic Packaging[M]. London: Springer, 2011 : 305 -371. |
| [2] | ZHANG L, XUE S B, GAO L L, et al. Development of Sn-Zn lead-free solders bearing alloying elements[J]. Journal of Materials Science:Materials in Electronics,2010, 21 (1) : 1 –15. DOI: 10.1007/s10854-009-0014-1 |
| [3] | LIU C Z, KANG T Y, WEI W, et al. Effect of high intensity magnetic field on intermetallic compounds growth in SnBi/Cu microelectronic interconnect[J]. Journal of Alloys and Compounds,2011, 509 (33) : 8475 –8477. DOI: 10.1016/j.jallcom.2011.06.014 |
| [4] | CHEN S, ZHANG L, LIU J, et al. A reliability study of nanoparticles reinforced composite lead-free solder[J]. Mater Trans,2010, 51 (10) : 1720 –1726. DOI: 10.2320/matertrans.MJ201002 |
| [5] | ZHU Q S, SONG H Y, LIU H Y, et al. Effect of Zn addition on microstructure of Sn-Bi joint[C]//Beijing:Proceedings of the 9th ICEPT-HDP, 2009:1043-1046. |
| [6] | DUTCHAK Y I, QSIPENKO V P, PANASYUK P V. Thermal conductivity of Sn-Bi alloys in the solid and liquid states[J]. Soviet Physics Journal,1968, 11 (10) : 145 –147. DOI: 10.1007/BF00822489 |
| [7] | ZANG L, YUAN Z, ZHU Y, et al. Spreading process and interfacial characteristic of Sn-17Bi-0.5Cu/Ni at temperatures ranging from 523 K to 673 K[J]. Colloids and Surfaces A:Physicochemical and Engineering Aspects,2012, 414 (11) : 57 –65. |
| [8] | 何鹏, 吕晓春, 张斌斌, 等. 合金元素对Sn-57Bi无铅钎料组织及韧性的影响[J]. 材料工程,2010 (10) : 13 –17. HE P, LU X C, ZHANG B B, et al. Effect of alloy element on microstructure and impact toughness of Sn-57Bi lead-free solders[J]. Journal of Materials Engineering,2010 (10) : 13 –17. |
| [9] | WANG X J, ZHU Q S, LIU B, et al. Effect of doping Al on the liquid oxidation of Sn-Bi-Zn solder[J]. J Mater Sci:Mater Electron,2014, 25 (5) : 2297 –2304. DOI: 10.1007/s10854-014-1875-5 |
| [10] | XIAN A P, GONG G L. Surface oxidation of molten Sn-0.07 wt.% P in air at 280℃[J]. Journal of Materials Research,2008, 23 (6) : 1532 –1536. DOI: 10.1557/JMR.2008.0202 |
| [11] | FU X, ZHOU J, SUN Y, et al. Effect of phosphorus on microstructure and properties of Sn-8Zn-3Bi lead-free solder[J]. Journal of Southeast University(Natural Science Edition),2006, 36 (5) : 832 –835. |
| [12] | GLAZER J. Metallurgy of low temperature of Pb-free solders for electronic assemble[J]. International Materials Reviews,1995, 40 (2) : 65 –93. DOI: 10.1179/imr.1995.40.2.65 |
| [13] | KILINSKI T J, LESNIAK J R, SANDOR B I. Solder Joint Reliability:Theory and Application[M]. New York: Springer, 1991 : 384 -405. |
| [14] | LAI Y S, YANG P F, YAH C L. Experimental studies of board-level reliability of chip-scale packages subjected to JEDEC drop test condition[J]. Microelectronics Reliability,2006, 46 (2-4) : 645 –650. DOI: 10.1016/j.microrel.2005.07.005 |
| [15] | SUH D, KIM D W, LIU P, et al. Effects of Ag content on fracture resistance of Sn-Ag-Cu lead-free solders under high-strain rate conditions[J]. Materials Science and Engineering:A,2007, 460-461 (15) : 595 –603. |
| [16] | KIM H, ZHANG M, KUMAR C M, et al. Improved drop reliability performance with lead free solders of low Ag content and their failure modes[C]//Reno NV:57th Electronic Components and Technology Conference, 2007:962-967. |
| [17] | ABTEW M, SELVADURAY G. Lead-free solders in microelectronics[J]. Materials Science & Engineering:Reports,2000, 27 (5-6) : 95 –141. |
| [18] | GLAZER J. Metallurgy of low temperature of Pb-free solders for electronic assemble[J]. International Materials Reviews,1995, 40 (2) : 65 –93. DOI: 10.1179/imr.1995.40.2.65 |
| [19] | WANG F, GAO F, QIAN Y. Depressing effect of 0.2 wt.% Zn addition into Sn-3.0Ag-0.5Cu solder alloy on the intermetallic growth with Cu substrate during isothermal aging[J]. J Electron Mater,2006, 35 (10) : 1818 –1824. DOI: 10.1007/s11664-006-0163-4 |
| [20] | WANG X J, WANG Y L, WANG F J, et al. Effects of Zn, Zn-Al and Zn-P additions on the tensile properties of Sn-Bi solder[J]. Acta Metallurgica Sinica (English Letters),2014, 27 (6) : 1159 –1164. DOI: 10.1007/s40195-014-0165-9 |
| [21] | LI G, SHI Y, HAO H, et al. Effect of phosphorus element on the comprehensive properties of Sn-Cu lead-free solder[J]. J Alloys Compd,2010, 491 (1-2) : 382 –385. DOI: 10.1016/j.jallcom.2009.10.190 |
 2016, Vol. 44
2016, Vol. 44


